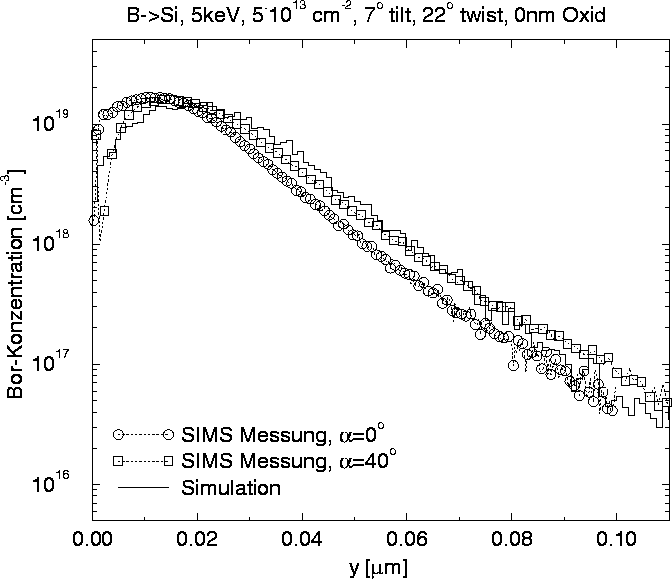
Abbildung 6.17: Vergleich des Simulationsergebnisses mit der SIMS\ Messung. Die durchgezogene Linie repräsentiert das Histogramm der Monte Carlo Simulation, die punktierten Linien und die Symbole kennzeichnen die experimentellen Daten. Mit
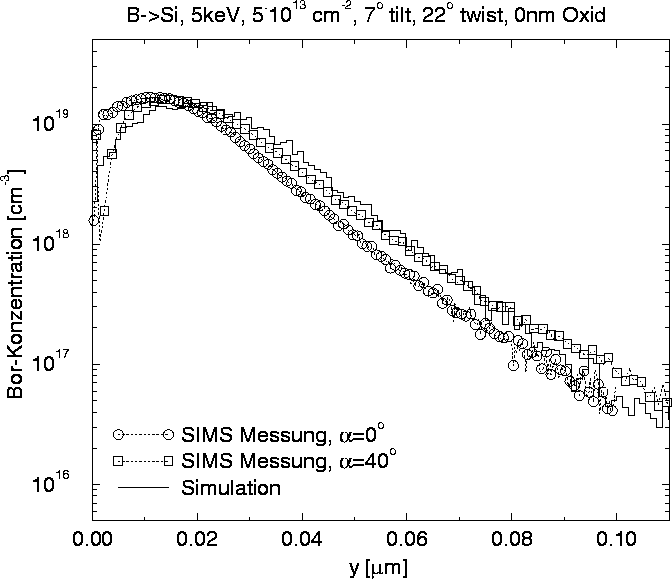
Abbildung 6.17: Vergleich des Simulationsergebnisses mit der SIMS\
Messung. Die durchgezogene Linie repräsentiert das Histogramm der
Monte Carlo Simulation, die punktierten Linien und die Symbole kennzeichnen
die experimentellen Daten. Mit ![]() wird der Einfallswinkel des
primären Sputtering-Ionenstrahles bezeichnet. Die SIMS\
Messungen (Symbole) wurden mit 2keV-
wird der Einfallswinkel des
primären Sputtering-Ionenstrahles bezeichnet. Die SIMS\
Messungen (Symbole) wurden mit 2keV-![]() -Ionen
durchgeführt.
-Ionen
durchgeführt.

Abbildung 6.18: Simulation einer Punktantwort mit 5keV-Bor-Ionen
und die daraus resultierende Bor-Konzentration in [cm-3].

Abbildung 6.19: Simulation einer Punktantwort mit 5keV-Bor-Ionen und die
daraus resultierende Silizium-Interstitial-Konzentration in cm[-3].