 . Einige Zeit später stellten Alväger und Hansen im
Jahre 1962 die ersten Halbleiterdioden für Teilchendetektoren her, indem
sie Phosphor in c-Si implantierten und anschließend die Probe bei 600
. Einige Zeit später stellten Alväger und Hansen im
Jahre 1962 die ersten Halbleiterdioden für Teilchendetektoren her, indem
sie Phosphor in c-Si implantierten und anschließend die Probe bei 600
Bereits Ende der 50er Jahre wurden in den USA die ersten
Patente für Ionenimplantation s-Techniken vergeben . Einige Zeit später stellten Alväger und Hansen im
Jahre 1962 die ersten Halbleiterdioden für Teilchendetektoren her, indem
sie Phosphor in c-Si implantierten und anschließend die Probe bei 600
. Einige Zeit später stellten Alväger und Hansen im
Jahre 1962 die ersten Halbleiterdioden für Teilchendetektoren her, indem
sie Phosphor in c-Si implantierten und anschließend die Probe bei 600![]() C\
ausheilten [Gil88]. Diese Ergebnisse konnten nur erzielt werden, weil
sich bereits Jahrzehnte davor Physiker intensiv mit der Wechselwirkung von
geladenen Teilchen mit Materie beschäftigten [Mol47, Boh48, Kin55].
C\
ausheilten [Gil88]. Diese Ergebnisse konnten nur erzielt werden, weil
sich bereits Jahrzehnte davor Physiker intensiv mit der Wechselwirkung von
geladenen Teilchen mit Materie beschäftigten [Mol47, Boh48, Kin55].
In [Dea73, Rys78, Gil88, Zie92] erhält man einen ausgezeichneten Überblick über die Ionenimplantation. Ziegler, Biersack und Littmark schufen mit ihrem Buch ,,The Stopping and Range of Ions in Solids`` [Zie85] ein Standardwerk auf dem Gebiet der Computersimulation der Ionenimplantation.
Der folgende Abriß soll zum besseren Verständnis der realen Vorgänge bei
der Ionenimplantation dienen. Bei den heute industriell eingesetzten
Ionenimplantationsanlagen unterscheidet man zwei Typen, nämlich die Nieder-
bzw. Mittelstromanlagen (bis 1mA Stromstärke , siehe Abbildung 2.1) und die
Hochstromanlagen mit etwa der zehnfachen Strahlstärke.
, siehe Abbildung 2.1) und die
Hochstromanlagen mit etwa der zehnfachen Strahlstärke.

Abbildung 2.1: Schema
eine Mittelstrom-Ionenimplantationsanlage. Um neutrale Teilchen
nicht als Verunreinigung auf den ,,Wafer`` zu bekommen, wird der
Ionenstrahl vor dem Auftreffen auf die Scheibe um einen kleinen
Winkel abgelenkt, vgl. [Wid96].
Als Ausgangsmaterial verwendet man häufig eine gasförmige Verbindung
(![]() ,
, ![]() und
und ![]() ) der gewünschten
Ionenquelle. Im Plasma dieser Gase werden nicht nur einfach geladenen Ionen
) der gewünschten
Ionenquelle. Im Plasma dieser Gase werden nicht nur einfach geladenen Ionen
![]() ,
, ![]() und
und ![]() erzeugt, sondern auch mehrfach geladene
Teilchen, allerdings in einer um ein bis zwei Größenordnungen geringeren
Konzentration.
erzeugt, sondern auch mehrfach geladene
Teilchen, allerdings in einer um ein bis zwei Größenordnungen geringeren
Konzentration.
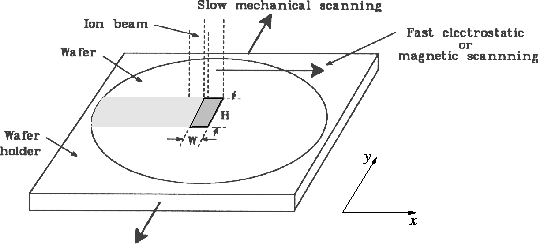
Abbildung 2.2: Hybrides
Scanning-System, bei dem der Strahl elektrostatisch mit einer
Frequenz von 1-2kHz oder magnetisch (1-10Hz) in der x-Richtung
gefuehrt wird, waehrenddessen sich der Wafer langsam (0,5Hz)
entlang der y-Richtung bewegt, vgl. [EK95].
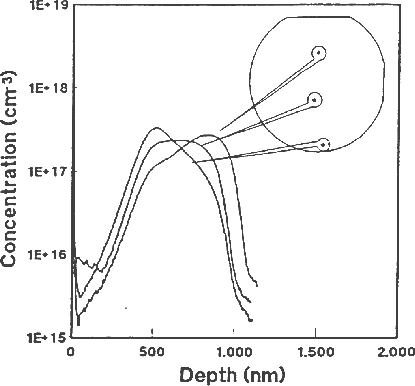
Abbildung 2.3: Konzentrationsprofile an verschiedenen Stellen eines
4'' (100) Silizium-Wafers nach einer Bor-Implantation bei
150keV und einer Dosis von 10![]() . Der verwendete
Implanter hatte eine elektrostatische Strahlablenkung und die Probe
war nominell normal zum Strahl ausgerichtet [Tia92].
. Der verwendete
Implanter hatte eine elektrostatische Strahlablenkung und die Probe
war nominell normal zum Strahl ausgerichtet [Tia92].
Der Massenseparator dient zusammen mit der variablen Blende zur räumlichen
Trennung der unterschiedlichen Ionenarten. Die Beschleunigungsspannung kann
bei mittelgroßen Anlagen typisch zwischen 20 und 180kV variiert werden. Die
implantierte Dosis (siehe Kapitel 2.1) wird durch Ladungsmessung in
der Implantationsanlage auf wenige Promille genau eingestellt und mittels
elektrostatischen und/oder mechanischen
,,Scanning``-Systemen (siehe Abbildung 2.2) sehr exakt und gleichmäßig über die
Scheibenoberfläche verteilt. Es gilt jedoch zu beachten, daß
elektrostatische Ablenkungseinrichtungen i.a. den Nachteil besitzen, daß
sich der Kippwinkel (,,Tilt``, siehe Kapitel 2.1) mit dem
Eintrittsort des Ions in den ,,Wafer`` ändert. Zusammen mit dem
,,Channeling``-Phänomen (siehe Kapitel 2.7.3) können sich daraus
erhebliche Unterschiede in den Eindringtiefen der Ionen und damit in den
Profilformen ergeben (siehe Abbildung 2.3).
(siehe Abbildung 2.2) sehr exakt und gleichmäßig über die
Scheibenoberfläche verteilt. Es gilt jedoch zu beachten, daß
elektrostatische Ablenkungseinrichtungen i.a. den Nachteil besitzen, daß
sich der Kippwinkel (,,Tilt``, siehe Kapitel 2.1) mit dem
Eintrittsort des Ions in den ,,Wafer`` ändert. Zusammen mit dem
,,Channeling``-Phänomen (siehe Kapitel 2.7.3) können sich daraus
erhebliche Unterschiede in den Eindringtiefen der Ionen und damit in den
Profilformen ergeben (siehe Abbildung 2.3).