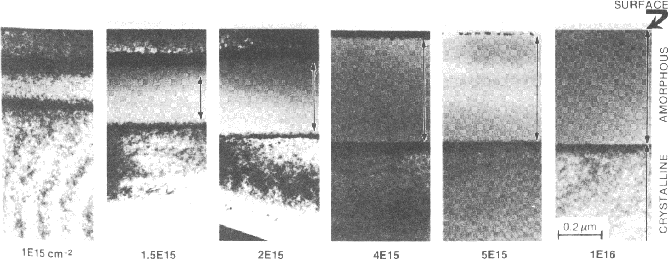
Abbildung 5.1: Diese Serie von X-TEM Bildern zeigt die Entwicklung einer amorphen Schicht in Silizium, wenn die Implantationsdosis der 300keV-Si-Ionen kontinuierlich erhoeht wird.
Der größte Nachteil der Ionenimplantation ist die sukzessive Zerstörung des Kristallgitters. Dadurch wird eine thermische Nachbehandlung nötig, die zwar die Dotieratome elektrisch aktiviert, und die Kristalldefekte beseitigt, aber auch zu einer meist ungewollten Diffusion und somit zu einer Verbreiterung des Dotierprofiles führt. Man spricht dabei von Ausheilung (Annealing``). Werden sehr viele ,,Target-Atome durch die energetischen Ionen herausgeschlagen, können sich Gebiete mit typischen Durchmessern von 10nm bilden (Cluster), in denen keine Fernordnung der Atome mehr festzustellen ist -- in diesen Bereichen wurde das Material amorphisiert [Dea73, Cul81, Nar81, Mad84].
Steigt die Dosis weiter, beginnen diese Cluster zu überlappen und es bilden sich unter bestimmten Randbedingungen komplette Schichten aus amorphisierten Material. Die Entstehungsgeschichte dieser Schichten hängt jedoch auch von der Ionenmasse ab, denn bei der Implantation von schweren Ionen (Arsen, Indium und Antimon) kann bereits eine einzige Stoßkaskade ausreichen, um das Material entlang der Ionenbahn bleibend zu amorphisieren.
Im nachfolgenden Ausheilschritt wird dem geschädigten Kristall thermische Energie zugeführt und dadurch können sich primäre Punktdefekte -- also jene Schäden, die während der Implantation entstanden sind -- zu größeren Komplexen zusammenfügen und sekundäre Defekte bilden [Jon88, Sch91, Zie92, Rim95].
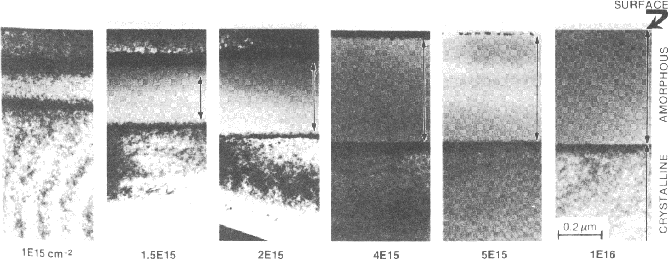
Abbildung 5.1: Diese Serie
von X-TEM Bildern zeigt die Entwicklung einer amorphen Schicht in
Silizium, wenn die Implantationsdosis der 300keV-Si-Ionen
kontinuierlich erhoeht wird.
Wie bereits dargelegt wurde, unterscheiden sich die verschiedenen Defektkategorien teilweise beträchtlich in ihrem Annealing-Verhalten und in ihrer Entstehungsgeschichte. Die Lage und Ausdehnung von möglichen amorphen Schichten spielt dabei eine wesentliche Rolle. In Abbildung 5.1 ist die Entwicklung einer amorphen Schicht dargestellt, wenn 300keV-Si-Ionen bei steigender Dosis implantiert werden.
Eine auf physikalischen Prinzipien beruhende Methode für die Simulation der Amorphisierung ist daher für Technologen und Prozeßingenieure von großer Bedeutung und wird im Folgenden detailliert dargestellt.