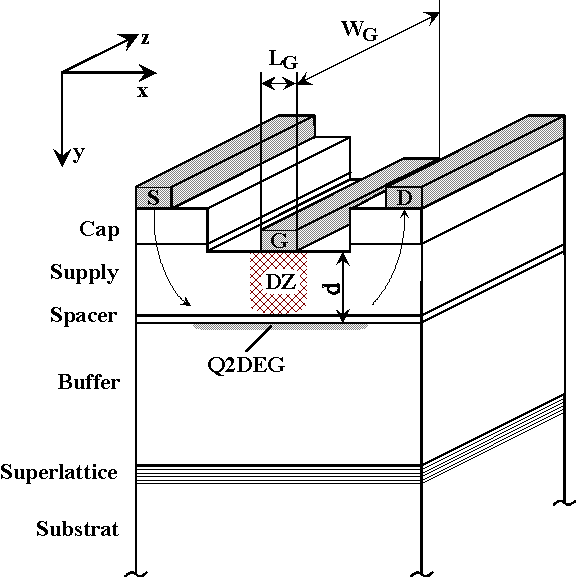
Den von seinem Aufbau her einfachsten HFET auf der Basis einer AlxGa1-xAs/GaAs-Heterostruktur [37] zeigt Abbildung 2.1. Dieser konventionelle (single heterojunction) HFET wird heute kaum noch hergestellt. Die Beschreibung seines Aufbaus dient als Grundlage zur Verdeutlichung der Funktionsweise eines HFET und seiner Weiterentwicklung.
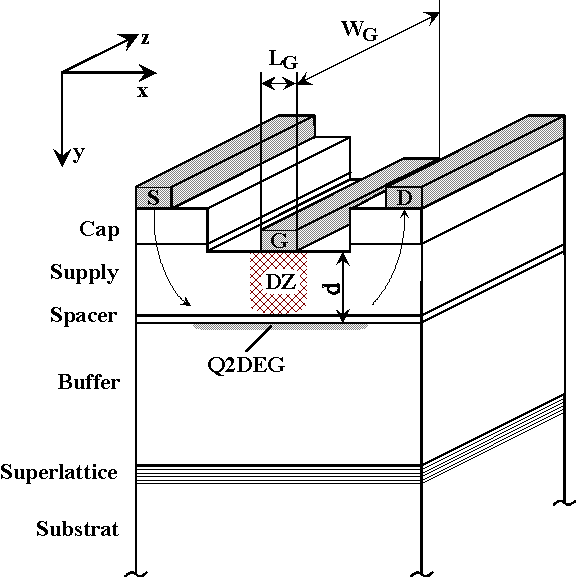
Abbildung 2.1: Prinzipieller Aufbau eines konventionellen HFETs.
Den Träger jedes mikroelektronischen Halbleiterbauelements
bildet das sogenannte Substrat. Im vorliegenden Fall handelt es
sich um eine Scheibe von 3 oder 4 Zoll Durchmesser (Wafer)
aus semiisolierendem GaAs. Auf dieses Substrat wird als Basis
des eigentlichen Bauelements eine relativ dicke Schicht aus meist
leicht p-dotiertem GaAs - der Buffer - epitaktisch aufgewachsen
(dB 1 mm). Dabei wird zur Homogenisierung der Grenzflächen
zwischen Buffer und Substrat meist noch ein Übergitter aus
AlxGa1-xAs und GaAs-Schichten zwischengeschaltet. Auf dem Buffer
wird eine Schicht AlxGa1-xAs aufgebracht, wobei die ersten Monolagen
undotiert bleiben, der Rest jedoch mit Si dotiert wird. Si-Atome
bilden in einer AlxGa1-xAs-Umgebung einen Donator mit einer sehr
geringen Aktivierungsenergie
(DED 5 meV), der die Ladungsträger liefert, die zum Stromfluß
beitragen. An der Grenzfläche zwischen GaAs und AlxGa1-xAs
kommt es zum Bandkantensprung, in dessen Bereich sich das Q2DEG
bildet (s.a. Abb. 1.1). Die dotierte AlxGa1-xAs-Schicht wird daher
auch als Supply (dS 40 nm) bezeichnet. Die undotierte Schicht
- der Spacer (dSp 2 nm) - hat die Aufgabe, die Dotierstoffatome
(Dopanden) von dem Bereich, der den Hauptanteil des Stromflusses
aufnehmen soll (Q2DEG), räumlich zu trennen, um die Streuung
der freien Ladungsträger an den Dopanden zu minimieren.
Die Gateelektrode (G) ist direkt mit dem Supply verbunden. Das Gatemetall bildet in Verbindung mit dem dotierten Halbleiter einen SCHOTTKY-Kontakt. Der SCHOTTKY-Kontakt besitzt Diodeneigenschaften und das Gate erfüllt seine Aufgabe als Steuerelektrode allein über die Variation des elektrischen Feldes unter dem Kontakt [31]. In diesem Bereich entsteht bei kleinen (negativen) Gatespannungen eine Verarmungszone (Depletions-Zone). Die effektive Dicke der Supplyschicht unter dem Gate, bzw. der Gate-Kanal Abstand (d), ist ein wichtiger Parameter, der die Eigenschaften des HFET wesentlich beeinflußt, ebenso wie die Gatelänge (LG), d.h. die Abmessung des Gatekontakts parallel zur Richtung des Stromflußes (x-Richtung). Die Entwicklung von HFETs für Anwendungsbereiche mit immer höheren Frequenzen ist nur bei einer parallelen Verringerung der Gatelänge möglich. Erst vor wenigen Jahren ist der Vorstoß in den sub-m-Bereich (LG < 1 m) gelungen [32, 51, 68, 103, 143] und heute sind Gatelängen unter 100 nm zumindest im Forschungslabor bereits realisiert worden [29, 59, 90, 91, 131]. Hier stößt man jedoch immer wieder auf technologische Grenzen, die eine Weiter- oder Neuentwicklung der Herstellungsprozesse erfordern. Das Verhältnis von Gatelänge und Gate-Kanal Abstand, die sogenannte aspect ratio a = LG / d, wird häufig als ein Parameter zur Charakterisierung eines HFET verwendet [131]. Die Eigenschaften eines HFET werden positiv beeinflußt, wenn die aspect ratio - trotz Verminderung der Gatelänge - möglichst groß ist. Das bedeutet, daß eine geringe Supplyschichtdicke anzustreben ist. Dies führt im wesentlichen zu einer effizienteren Ladungsträgermodulation. Die Gateweite (WG), d.h. die Abmessung des Gates in z-Richtung, ist ein Multiplikationsfaktor, der die meisten elektrischen Größen des Bauelements bestimmt. Um HFETs unterschiedlicher Gateweite aber sonst gleicher Bauart direkt miteinander vergleichen zu können, werden daher viele Größen auf die Gateweite normiert. So wird im folgenden häufig nur die Rede vom Drainstrom sein, auch wenn es sich bei genauerer Betrachtung um einen auf die Gateweite normierten Strom in Einheiten von A/m handelt.
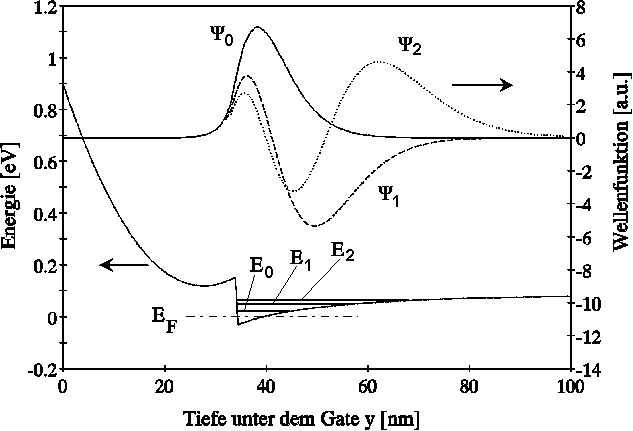
Abbildung 2.2: Verlauf der Leitungsbandkante und Wellenfunktionen eines konventionellen HFET. Gatespannung: VG = 0 V [48].
Zur Kontaktierung der Source- (S) und Drainelektroden (D) wird zu beiden Seiten des Gates eine hochdotierte Schicht GaAs - das Cap - aufgebracht (dCap 50 - 100 nm). Einlegieren des Kontaktmetalls bewirkt eine Verringerung der Source- und Drainwiderstände, was sich positiv auf die Eigenschaften, besonders auf die Drainstromcharakteristik und die erreichbaren Grenzfrequenzen auswirkt. Die hohe Dotierung des Cap führt in Verbindung mit dem Kontaktmetall zu einer weiteren Verringerung der Kontaktwiderstände [61].
Abbildung 2.2 zeigt den Verlauf der Leitungsbandkante unter dem Gate. Aufgrund des SCHOTTKY-Effektes steigt die Leitungsbandkante stark an. Die SCHOTTKY-Barrierenspannung beträgt hier VB = 0.9 V. Im Bereich des Heteroübergangs bei y = 34 nm kommt es zur Ausbildung quantisierter Energieniveaus. Die zu den ersten drei Energieniveaus (E0, E1, E2) gehörenden Wellenfunktionen (0, 1, 2) reichen alle etwas in die dotierte AlxGa1-xAs-Schicht hinein - ein Resultat der endlichen Potentialbarriere des Heteroübergangs. Damit kann es durchaus zu einer Streuung der Elektronen des Q2DEG an den Dotierstoffatomen kommen. Außerdem wird eine Erhöhung der Ladungsträgerkonzentration im Bereich des dotierten Materials im Minimum der Leitungsbandkante begünstigt (Abb. 2.3).

Abbildung 2.3: Veränderung der Ladungsträgerdichte unter dem Gate bei Variation der Gatespannung [48].
Dies führt zu einer Verschlechterung des sogenannten Ladungskontrollverhaltens [57] und damit zu einer Sättigung in der Drainstromcharakteristik. Gegebenenfalls kann sich auch ein zusätzlicher Ladungsträgerkanal in der dotierten AlxGa1-xAs-Schicht ausbilden. Dieser Effekt wird paralleler oder parasitärer FET-Effekt genannt [49, 82].
Weiterhin reichen die Wellenfunktionen auch beachtlich weit in den GaAs-Buffer hinein (Abb. 2.2). Dies führt zu einer Stromkomponente, die sich auch bei sehr niedrigen (negativen) Gatespannungen bei diesen Bauelementen nicht vollständig eliminieren läßt. Das vorrangige Ziel der Bauelemententwicklung ist es nun, eben jene negativen Aspekte des konventionellen HFET weitestgehend auszuschalten, d.h. man versucht - neben der fortschreitenden Miniaturisierung des Bauelements - die Ladungsträger effizienter in den Kanal des Q2DEG einzuschließen.
In dieser Hinsicht stellt der double heterojunction
HFET (DH-HFET) eine echte Weiterentwicklung dar, der als Kanal
für das Q2DEG eine InyGa1-yAs-Schicht besitzt
(Abb. 2.4) [67, 68, 79, 81, 90, 91, 93, 109].
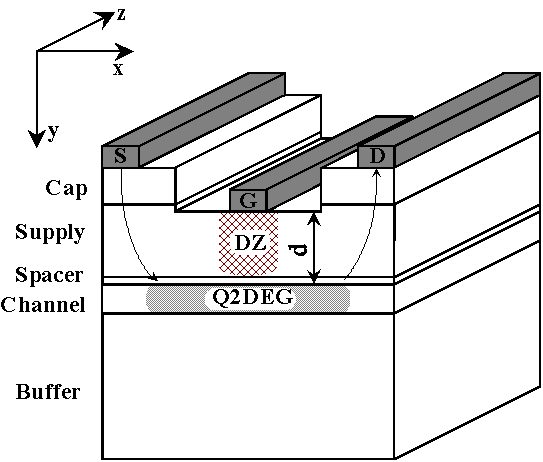
Abbildung 2.4: Prinzipieller Aufbau eines DH-HFET.
Da InyGa1-yAs einen geringeren Bandabstand besitzt als GaAs und AlxGa1-xAs, kommt es zur Ausbildung eines rechteckförmigen Potentialtopfs mit zwei Potentialbarrieren, die das Q2DEG wesentlich effizienter einschließen. Dies wird durch die Wellenfunktionen verdeutlicht, die hier sehr stark im Bereich des Potentialtopfes lokalisiert sind (Abb. 2.5). Die Tatsache, daß die zum dritten Energieniveau gehörende Wellenfunktion auch hier sehr weit in den Buffer hineinreicht, ist aufgrund der zu vernachlässigenden Besetzung eher nebensächlich.
Bei sonst gleichen Parametern (Gate-Kanal Abstand d = 34 nm, Spacerdicke dSp = 2 nm, Dotierung des Supply ND = 1.5×1018 cm-3) trägt im Gegensatz zum konventionellen HFET das unterste Energieniveau beim DH-HFET 90% der Ladungsträgerkonzentration des Q2DEG, das zweite Energieniveau 9%, das dritte Energieniveau nur noch 0.2% und steuert damit kaum noch zum Stromtransport bei. Die Gesamtdichte des Q2DEG beträgt bei diesem DH-HFET ns = 8.5×1011 cm-2 (VG = 0 V) und ist damit wesentlich höher als beim konventionellen HFET bei gleicher Gatespannung.
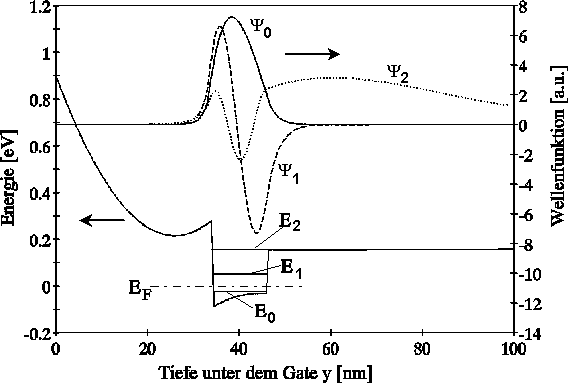
Abbildung 2.5: Verlauf der Leitungsbandkante und der Wellenfunktionen eines DH-HFET. Gatespannung: VG = 0 V [48].
Zusammengefaßt besitzt der DH-HFET gegenüber dem konventionellen HFET aufgrund seiner Bandstruktur eine Reihe von Vorteilen:
Die genannten Vorteile bedeuten, daß der DH-HFET nicht mehr nur als rauscharmer Verstärker [101], sondern auch als Leistungsverstärker konzipiert werden kann.
Inzwischen haben sich weitere Neuentwicklungen durchgesetzt, die den einfachen DH-HFET als kommerzielles Bauelement bereits wieder ablösen können:
Diese Liste entspricht den wichtigsten Neuentwicklungen für HFETS aus dem großen Repertoire der Variationsmöglichkeiten. Auch neue Materialien werden in zunehmendem Maße eingesetzt:
Weitere Materialien, vielfach auf InP-Basis sind derzeit Gegenstand intensiver Untersuchungen [6, 7, 80, 83, 94, 95, 127, 132, 138] und auch der Weiterentwicklung des AlGaAs/InGaAs/GaAs DH-HFET bzw. seiner Nachfolger, sind noch keine Grenzen gesetzt.