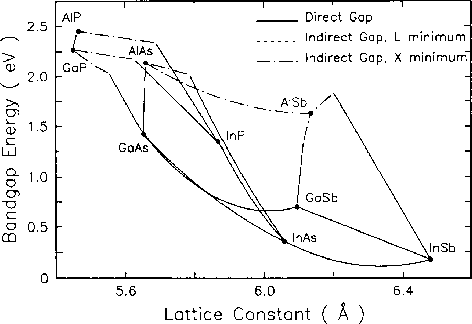 |
Im speziellen hat die Kombination aus AlAs und GaAs , AlGaAs , auf GaAs Substrat große Bedeutung erlangt, vor allem im Bereich des HEMT. Dieser ist in gewisser Weise eine Weiterentwicklung des n-Kanal MESFET, des damals schnellsten Transistors.
Ein Schottky Gate steuert den Elektronentransport in einem meist undotierten Kanal, der sich entweder an der Grenzfläche AlGaAs/GaAs in GaAs (Einfachbarrierenstruktur , ``single heterojunction'' , SH) oder in beidseitig von AlGaAs begrenztem GaAs ausbildet (Doppelbarrierenstruktur , ``double heterojunction'' , DH) [204].
Die Reduktion der Gatelänge, die parallel durch die Fortschritte der HL Technologie (vor allem in Lithographie und Ätztechnik) ermöglicht wurde, war natürlich ebenfalls ausschlaggebend für die Verbesserung der Bauteilkenndaten.
Die erzielten Transitfrequenzen reichen von ![]() GHz der ersten Strukturen mit
GHz der ersten Strukturen mit ![]() m Gate bis zu 110 GHz bei
m Gate bis zu 110 GHz bei ![]() m [149].
Aufgrund der im Vergleich zum MESFET höheren
m [149].
Aufgrund der im Vergleich zum MESFET höheren ![]() resultieren eine größere intrinsische Steilheit
resultieren eine größere intrinsische Steilheit ![]() und eine kleinere Rauschzahl
und eine kleinere Rauschzahl ![]() .
.
Ein Nachteil in AlGaAs ist die Degradation aufgrund des Auftretens von sogenannten DX Zentren ![[*]](foot_motif.gif) für Al-Gehalte
für Al-Gehalte ![]() .
Das sind tiefe Störstellen (``traps'') , die bei allen Donatoren unabhängig von der Herstellungstechnologie auftreten und bis zu vier verschiedene Emissions-/Einfangraten haben können.
Ihre Eigenschaften und Struktur sind noch immer nicht befriedigend geklärt [48]. Sie bewirken unter anderem eine Verschiebung der Einsatzspannung (``threshold voltage'') und Abhängigkeit der Kennlinien von Lichteinstrahlung (``persistent photoconductivity'' , PPC) [70].
Man suchte also nach geeigneten Verbindungshalbleitern für GaAs Substrat, die die DX Problematik entschärfen konnten. Naheliegenderweise verwendete man daher Legierungen aus GaAs und InAs , GaInAs , als Kanalmaterial, da dieses eine kleinere Bandlücke als GaAs hat; der erste GaInAs/GaAs HEMT entstand [176].
Da AlGaAs/GaInAs eine höhere Heterobarriere als AlGaAs/GaAs hat, wird damit die Emission vom Kanal in die Barriere reduziert, worauf der erste AlGaAs/GaInAs/GaAs Transistor basierte [107]. Ebenso wurden mit GaInAs aluminiumfreie Laser gebaut.
Andererseits versuchte man gitterangepaßte Strukturen auf InP Substrat, unter Verwendung von Al0.48In0.52As als Barriere und Ga0.47In0.53As als Kanal [33,168] , was angesichts der damals unreifen InP Technologie keine Vorteile für Transistoren erbrachte.
.
Das sind tiefe Störstellen (``traps'') , die bei allen Donatoren unabhängig von der Herstellungstechnologie auftreten und bis zu vier verschiedene Emissions-/Einfangraten haben können.
Ihre Eigenschaften und Struktur sind noch immer nicht befriedigend geklärt [48]. Sie bewirken unter anderem eine Verschiebung der Einsatzspannung (``threshold voltage'') und Abhängigkeit der Kennlinien von Lichteinstrahlung (``persistent photoconductivity'' , PPC) [70].
Man suchte also nach geeigneten Verbindungshalbleitern für GaAs Substrat, die die DX Problematik entschärfen konnten. Naheliegenderweise verwendete man daher Legierungen aus GaAs und InAs , GaInAs , als Kanalmaterial, da dieses eine kleinere Bandlücke als GaAs hat; der erste GaInAs/GaAs HEMT entstand [176].
Da AlGaAs/GaInAs eine höhere Heterobarriere als AlGaAs/GaAs hat, wird damit die Emission vom Kanal in die Barriere reduziert, worauf der erste AlGaAs/GaInAs/GaAs Transistor basierte [107]. Ebenso wurden mit GaInAs aluminiumfreie Laser gebaut.
Andererseits versuchte man gitterangepaßte Strukturen auf InP Substrat, unter Verwendung von Al0.48In0.52As als Barriere und Ga0.47In0.53As als Kanal [33,168] , was angesichts der damals unreifen InP Technologie keine Vorteile für Transistoren erbrachte.