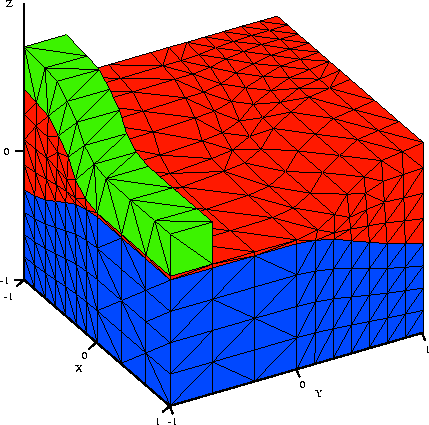 |
Die Bildung der Source- und Drain-Gebiete ist bei der Fertigung kleinster Transistoren ein intrinsisch dreidimensionales Problem, wodurch dreidimensionale Simulation erforderlich ist.
Im folgenden Beispiel wurde die Ionenimplantation und der darauffolgende Ausheilungsschritt einer LDD-Implantation (Lightly Doped Drain) für eine konventionelle LOCOS-Struktur (Local Oxidation of Silicon) für einen PMOS-Transistor berechnet. Abb. 8.6 zeigt einen Viertelausschnitt der betrachteten Struktur.
Die Bor-Implantation wurde mit dem Programm mcimpl3d nach der Monte-Carlo Methode
berechnet. Die Dosis beträgt
Zuerst wird die Simulation des technologisch relevanten Ausheilprozesses bei 875
Bei diesem Ausheilungsschritt ist die Diffusionslänge klein, sodaß es zu keiner substantiellen
Veränderung des Profiles kommt. Es ist daher auch nur wenig Gitteradaptierung notwendig. Um die
Leistungsfähigkeit der Adaptierungsmethode zu demonstrieren, wurde ein Ausheilungsschritt bei
1050
Dieses Beispiel offenbart einen großen Vorteil der vollautomatischen Gitteradaptierung: Der
Anwender muß lediglich die gewünschte Genauigkeit vorgeben und braucht sich nicht um die
Gitterdichte kümmern.
![]() cm-2, die Energie ist 20keV, der
Neigungswinkel ist
cm-2, die Energie ist 20keV, der
Neigungswinkel ist ![]() zur Einfallsrichtung und das Substratmaterial ist in
{100}-Richtung orientiert. Die Dicke des Streuoxyds über dem aktiven Bereich beträgt
30nm. Die implantierte Borverteilung ist in
Abb. 8.7 dargestellt. Dabei wurde das Initialgitter aus Abb. 8.6
entsprechend einem Dosisfehler von 1%
zur Einfallsrichtung und das Substratmaterial ist in
{100}-Richtung orientiert. Die Dicke des Streuoxyds über dem aktiven Bereich beträgt
30nm. Die implantierte Borverteilung ist in
Abb. 8.7 dargestellt. Dabei wurde das Initialgitter aus Abb. 8.6
entsprechend einem Dosisfehler von 1%
![]() cm-2 und einer Energie von 20keV.
cm-2 und einer Energie von 20keV.
![]() C und
einer Dauer von 20 Minuten in inerter Umgebung gezeigt. Als physikalisches Modell wurde das
feldgekoppelte Modell für Bor gewählt. Um den Rechenaufwand zu reduzieren, wird nur das
Siliziumgebiet simuliert, wobei dosiskonservierende Randbedingungen verwendet werden. Zu Beginn
der Simulation besteht das Gitter des Siliziumgebietes aus 22549 Elementen und 11898 Knoten
(Abb. 8.8). Mit fortschreitender Diffusion verbreitert sich das Profil
wodurch an der Diffusionsfront zusätzliche Verfeinerung notwendig wird. Dies resultiert in
Gittern mit maximal 23721 Elementen und 12743 Knoten. Die Simulation benötigte sechs Zeitschritte
mit insgesamt 18 Newton-Iterationen. Das Gitter am Ende der Simulation besteht aus 23553
Elementen und 12672 Knoten ( Abb. 8.9). Die für die Simulation benötigte Rechenzeit
betrug 9 Minuten bei einem Speicherbedarf von 23 Megabyte auf einem HP-9000/735-100
Arbeitsplatzrechner.
C und
einer Dauer von 20 Minuten in inerter Umgebung gezeigt. Als physikalisches Modell wurde das
feldgekoppelte Modell für Bor gewählt. Um den Rechenaufwand zu reduzieren, wird nur das
Siliziumgebiet simuliert, wobei dosiskonservierende Randbedingungen verwendet werden. Zu Beginn
der Simulation besteht das Gitter des Siliziumgebietes aus 22549 Elementen und 11898 Knoten
(Abb. 8.8). Mit fortschreitender Diffusion verbreitert sich das Profil
wodurch an der Diffusionsfront zusätzliche Verfeinerung notwendig wird. Dies resultiert in
Gittern mit maximal 23721 Elementen und 12743 Knoten. Die Simulation benötigte sechs Zeitschritte
mit insgesamt 18 Newton-Iterationen. Das Gitter am Ende der Simulation besteht aus 23553
Elementen und 12672 Knoten ( Abb. 8.9). Die für die Simulation benötigte Rechenzeit
betrug 9 Minuten bei einem Speicherbedarf von 23 Megabyte auf einem HP-9000/735-100
Arbeitsplatzrechner.
![\begin{figure}
\centerline{\resizebox
{1.03\textwidth}{!}{\hspace{1ex}\includegraphics*[0mm,25mm][210mm,160mm]{before.eps}}
}\end{figure}](img334.gif)
![]() C mit einer Dauer von 30 Minuten mit den selben Anfangsbedingungen berechnet. In
diesem Fall kommt es zu substantieller Diffusion, sodaß Gitteradaptierung in größerem Ausmaß
notwendig wird. Mit der Wanderung der Diffusionsfront wird an dieser zusätzliche Verfeinerung
notwendig, während durch die Verflachung des Profiles im Bereich hoher Konzentration das Gitter
gröber werden kann. In der ersten Phase der Simulation überwiegt die Verfeinerung an der
Diffusionsfront, sodaß die Größe des Gitters auf 24030 Elemente und 12892 Knoten ansteigt. Im
weiteren Verlauf kommt es zur Verflachung der Gradienten der Verteilung, womit die
Diskretisierungsfehler sinken und das Gitter auf 18485 Elemente und 10437 Knoten reduziert werden
kann. Zur Berechnung dieses Prozesses benötigte AMIGOS 33 Zeitschritte bei insgesamt 71
nichtlinearen Iterationen, bei einer Rechenzeit von 31 Minuten und einem Speicherbedarf von
25 MB. Das Ergebnis ist in Abb. 8.10 dargestellt.
C mit einer Dauer von 30 Minuten mit den selben Anfangsbedingungen berechnet. In
diesem Fall kommt es zu substantieller Diffusion, sodaß Gitteradaptierung in größerem Ausmaß
notwendig wird. Mit der Wanderung der Diffusionsfront wird an dieser zusätzliche Verfeinerung
notwendig, während durch die Verflachung des Profiles im Bereich hoher Konzentration das Gitter
gröber werden kann. In der ersten Phase der Simulation überwiegt die Verfeinerung an der
Diffusionsfront, sodaß die Größe des Gitters auf 24030 Elemente und 12892 Knoten ansteigt. Im
weiteren Verlauf kommt es zur Verflachung der Gradienten der Verteilung, womit die
Diskretisierungsfehler sinken und das Gitter auf 18485 Elemente und 10437 Knoten reduziert werden
kann. Zur Berechnung dieses Prozesses benötigte AMIGOS 33 Zeitschritte bei insgesamt 71
nichtlinearen Iterationen, bei einer Rechenzeit von 31 Minuten und einem Speicherbedarf von
25 MB. Das Ergebnis ist in Abb. 8.10 dargestellt.
![]()
![]()
![]()
![]()
Next: 8.3 Formierung eines NMOS-Transistors
Up: 8 Anwendungen
Previous: 8.1.5 Ausheilung des Implantationsschadens
Ernst Leitner
1997-12-30