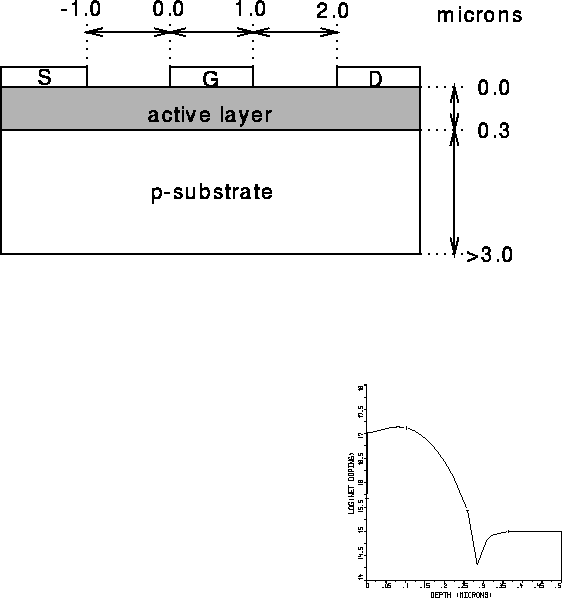
Abbildung 4.7: Struktur und Dotierungsprofil des simulierten MESFET




Die genaue Kenntnis des Durchbruchverhaltens von Transistoren ist für die Anwendung in Leistungsverstärkern besonders wichtig. Beim Einsatz von GaAs MESFETs in Verstärkerschaltungen sind es vor allem auch die Durchbruchseffekte, die für die Begrenzung der Ausgangsleistung verantwortlich sind. Mithilfe von MINIMOS wurde versucht, das experimentell beobachtete Durchbruchverhalten von GaAs MESFETs zu simulieren. An dieser Stelle soll ein kurzer Überblick über die erhaltenen Ergebnisse gegeben werden. Eine detailliertere Beschreibung der Simulationen und des Einflusses von Oberflächenzuständen auf das Durchbruchverhalten findet man in [4] und [5].
Erreicht das elektrische Feld in einem bestimmten Bereich des MESFET genügend hohe Werte, so können die dort lokalisierten Ladungsträger eine so hohe kinetische Energie aus dem Feld gewinnen, daß sie imstande sind, durch Kollisionen mit dem Kristallgitter Elektronen aus dem Valenzband ins Leitungsband anzuheben. Dabei entstehen weitere Ladungsträgerpaare, die zum Stromtransport beitragen können und so lokal die elektrischen Eigenschaften des Halbleiters verändern. Dieser Stoßionisation genannte Vorgang kann in MINIMOS durch die in Kap. 4.1.3 angegebene Formulierung des Generationsterms (4.1)-(4.2) der Kontinuitätsgleichungen berücksichtigt werden. Dadurch können die lokalen Verhältnisse im Bauelement bei den für Durchbruch typischen Arbeitspunkten untersucht werden.
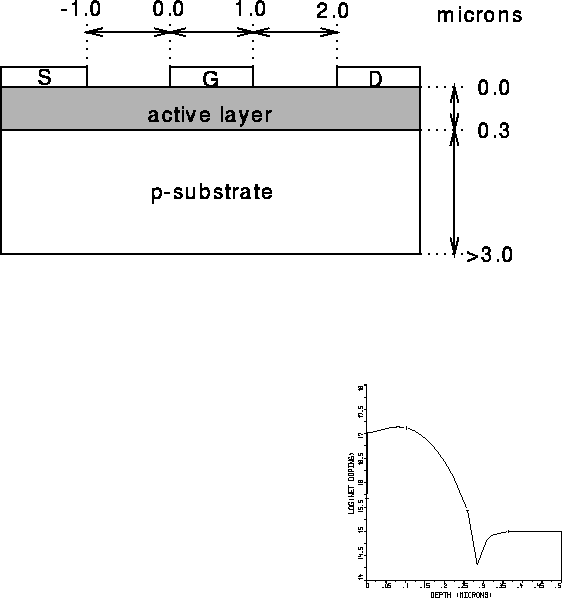
Abbildung 4.7: Struktur und Dotierungsprofil des simulierten MESFET
Messungen an GaAs MESFETs zeigen für das Einsetzen des Durchbruchs
eine ausgeprägte Abhängigkeit von der Gatespannung [4].
Um den dafür verantwortlichen
Mechanismus genauer zu verstehen, wurde eine typische MESFET Struktur simuliert.
Abb. 4.7 zeigt die Geometrie und das Dotierungsprofil des
simulierten MESFET . Die Gatelänge beträgt so wie der Source-Gate- und der
Gate-Drain-Abstand  . Für die Dotierung wurde die Implantation von
Silizium mit einer Dosis von
. Für die Dotierung wurde die Implantation von
Silizium mit einer Dosis von  und einer Energie von
und einer Energie von
 in ein mit
in ein mit  homogen p-dotiertes Substrat angenommen.
homogen p-dotiertes Substrat angenommen.
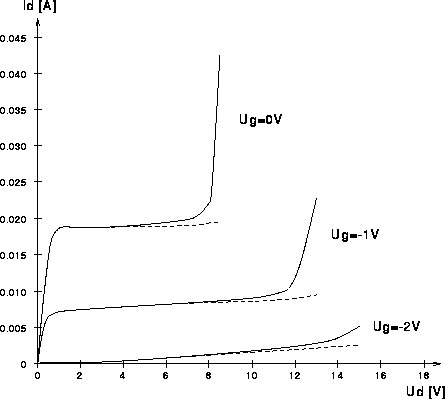
Abbildung 4.8: Ausgangskennlinie des MESFET mit (durchgezogene Linie) und ohne
(gestrichelte Linie) Berücksichtigung der Stoßionisation
Abb. 4.8 zeigt die Ausgangskennlinie des simulierten MESFET. Die Kennlinie zeigt qualitativ sehr gute Übereinstimmung mit gemessenen Durchbruchkennlinien (vgl. [4]). Dabei läßt sich der Durchbruch in zwei verschiedenen Arbeitsbereichen des Transistors unterscheiden, der Durchbruch bei leitendem Zustand des Transistors (`before pinch-off breakdown') und der Durchbruch des gesperrten Transistors (`after pinch-off breakdown'). Nähere Betrachtungen der Feldverteilung, der Stromdichteverteilungen und der Generationsrate zeigen, daß der Durchbruch in diesen beiden Fällen von verschiedenen Stellen im Bauelement seinen Ausgang nimmt.
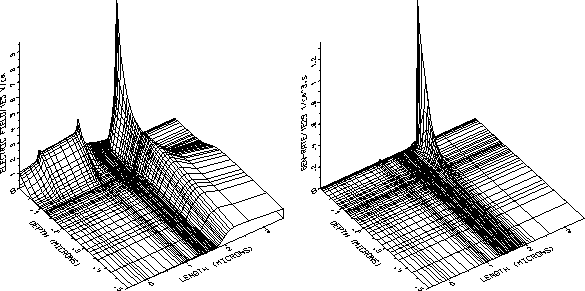
Abbildung 4.9: Feldverteilung (links) und Generationsrate (rechts)  und
und 
Um den Mechanismus des Durchbruchs im leitenden Zustand zu untersuchen, wurde
der Arbeitspunkt  und
und  gewählt, also ein Arbeitspunkt bei
beginnendem Durchbruch. Abb. 4.9 zeigt die Feldverteilung
und die Generationsrate im Bauteil. Man kann hier deutlich erkennen, daß
sich sowohl das Maximum des elektrischen Feldes als auch das Maximum
der Generationsrate
direkt unter der Kante des Drainkontakts befindet (der Drainkontakt beginnt bei
gewählt, also ein Arbeitspunkt bei
beginnendem Durchbruch. Abb. 4.9 zeigt die Feldverteilung
und die Generationsrate im Bauteil. Man kann hier deutlich erkennen, daß
sich sowohl das Maximum des elektrischen Feldes als auch das Maximum
der Generationsrate
direkt unter der Kante des Drainkontakts befindet (der Drainkontakt beginnt bei
 , als Orientierungshilfe
sollen die Koordinaten in Abb. 4.7 dienen).
, als Orientierungshilfe
sollen die Koordinaten in Abb. 4.7 dienen).

Abbildung: Stromdichte der Elektronen (links) und der Löcher (rechts)
 und
und 
Betrachtet man die Stromdichteverteilungen für Elektronen und Löcher (Abb. 4.10), so erkennt man, daß der Durchbruch hier hauptsächlich durch Kollisionen von Elektronen mit dem Kristallgitter initiiert wird. Die Elektronenstromdichteverteilung hat im Bereich des Maximums der Generationsrate ebenfalls ein ausgeprägtes Maximum, während in diesem Bereich die Löcherstromdichte vergleichsweise klein ist. Zusätzlich erkennt man an der drainseitigen Gatekante beginnende Stoßionisation (kleine Spitze in Abb. 4.9), die durch Löcher verursacht wird. Diese Tatsache ist anhand der Löcherstromdichteverteilung deutlich zu erkennen.
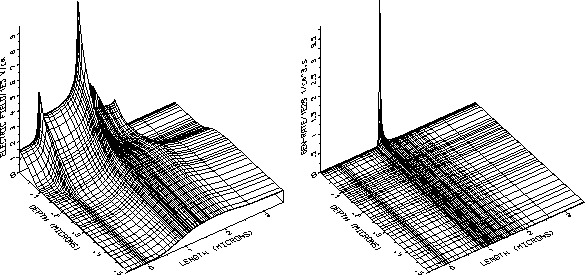
Abbildung 4.11: Feldverteilung (links) und Generationsrate (rechts)  und
und

Eine deutlich unterschiedliche Feldverteilung zeigt sich bei  und
und
 (Abb. 4.11). Bei diesem Arbeitpunkt ist der Kanal
vollkommen abgeschnürt, der Transistor ist im gesperrten Zustand.
An der Ausgangscharakteristik (Abb. 4.8)
kann man den beginnenden Durchbruch erkennen.
Die Maxima des elektrischen Feldes und der Generationsrate befinden sich
am drainseitigen Gateende. Anhand der Verteilungen der Stromdichte von
Elektronen und Löchern (Abb. 4.12) kann man wieder erkennen, wodurch
die Stoßionisation hauptsächlich ausgelöst wird. Im Bereich der maximalen
Generationsrate dominiert die Löcherstromdichte, d.h. die Generation kann den
Löchern zugeschrieben werden. An der Drainkante ist hier auch wieder ein
Maximum im Elektronenstrom zu erkennen. Die Generationsrate zeigt dort auch
wieder ein kleines Maximum (sehr kleiner Buckel in Abb. 4.12 bei
(Abb. 4.11). Bei diesem Arbeitpunkt ist der Kanal
vollkommen abgeschnürt, der Transistor ist im gesperrten Zustand.
An der Ausgangscharakteristik (Abb. 4.8)
kann man den beginnenden Durchbruch erkennen.
Die Maxima des elektrischen Feldes und der Generationsrate befinden sich
am drainseitigen Gateende. Anhand der Verteilungen der Stromdichte von
Elektronen und Löchern (Abb. 4.12) kann man wieder erkennen, wodurch
die Stoßionisation hauptsächlich ausgelöst wird. Im Bereich der maximalen
Generationsrate dominiert die Löcherstromdichte, d.h. die Generation kann den
Löchern zugeschrieben werden. An der Drainkante ist hier auch wieder ein
Maximum im Elektronenstrom zu erkennen. Die Generationsrate zeigt dort auch
wieder ein kleines Maximum (sehr kleiner Buckel in Abb. 4.12 bei
 ), dessen Spitzenwert allerdings um ein bis zwei Größenordnungen
niedriger liegt als an der Gatekante. Die Simulation zeigt also, daß der
Durchbruch im GaAs MESFET in den beiden betrachteten Grenzfällen an
unterschiedlichen Stellen im Bauelement beginnt, und im einen Fall durch
Elektronen, im anderen Fall aber durch Löcher initiiert wird. Für die
Optimierung des Durchbruchverhaltens in den verschiedenen Arbeitsbereichen des
Transistors können die Informationen aus der Simulation als Anhaltspunkt dienen.
), dessen Spitzenwert allerdings um ein bis zwei Größenordnungen
niedriger liegt als an der Gatekante. Die Simulation zeigt also, daß der
Durchbruch im GaAs MESFET in den beiden betrachteten Grenzfällen an
unterschiedlichen Stellen im Bauelement beginnt, und im einen Fall durch
Elektronen, im anderen Fall aber durch Löcher initiiert wird. Für die
Optimierung des Durchbruchverhaltens in den verschiedenen Arbeitsbereichen des
Transistors können die Informationen aus der Simulation als Anhaltspunkt dienen.

Abbildung: Stromdichte der Elektronen (links) und der Löcher (rechts)
 und
und 



