4.5 Ionenimplantierte MESFETs




Next: 5 Ausblick
Up: 4 Ergebnisse
Previous: 4.4 Kennlinie eines `ungated'
Die Ionenimplantation stellt die zur Zeit am weitesten verbreitete Methode
zur Herstellung von GaAs MESFETs dar. Bei modernen MESFETs wird dabei ein
selbstjustierender Prozeß verwendet (SAG - `self aligned gate'- FET Prozeß
[22][89]), wobei hintereinander vier bis fünf
Implantationen in semi-isolierendes GaAs durchgeführt werden (vgl. auch
Kap. 2.2.1). Dieser Prozeß wird unten noch genauer erläutert.
Freundlicherweise wurden von den SIEMENS Forschungslaboratorien in München
Messungen von MESFETs, die mit
einem SAGFET Prozeß hergestellt wurden, zur Verfügung gestellt. Die Messungen
stammen alle von einem Wafer, auf dem MESFETs mit Gatelängen von  bis
bis
 hergestellt worden waren. Neben den Ausgangs-, Transfer- und
Diodenkennlinien wurden noch die Barrierenhöhen der Gatedioden, die
Implantationsdaten und Messungen des Schichtwiderstandes für die verschiedenen
Implantationen zur Verfügung gestellt. Messungen der Dotierungsprofile standen
leider nicht zur Verfügung.
hergestellt worden waren. Neben den Ausgangs-, Transfer- und
Diodenkennlinien wurden noch die Barrierenhöhen der Gatedioden, die
Implantationsdaten und Messungen des Schichtwiderstandes für die verschiedenen
Implantationen zur Verfügung gestellt. Messungen der Dotierungsprofile standen
leider nicht zur Verfügung.
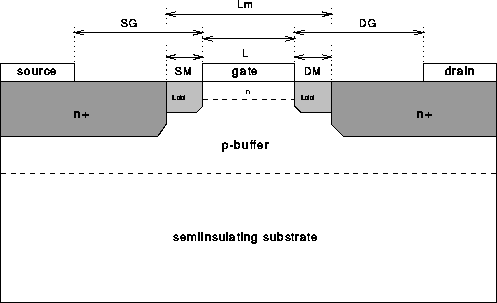
Abbildung 4.21: Struktur des planaren MESFET
Abb. 4.21 zeigt schematisch den Aufbau eines SAGFETs.
In semi-isolierendes GaAs Substrat werden zuerst eine tiefe p-Zone
(`p-buffer' p+)
und die aktive Schicht (n) implantiert. Danach wird das Gatemetall
aufgebracht. Darauf wird eine Ätzmaske aus Ti/Ni für das Gate aufgebracht.
Nach dem Ätzen entsteht wegen der Unterätzung ein sogenanntes T-gate, das
als Implantationsmaske für die Kontaktimplantation (n+) dient. Nach dem
Entfernen der Ti/Ni Maske, wird noch eine LDD Implantation zur
Verringerung von Oberflächeneffekten durchgeführt.
Die Unterätzung beträgt bei den betrachteten Bauelementen auf beiden Seiten
 - in Abb. 4.21 mit SM und DM bezeichnet.
Die Bezeichnung Gatelänge Lm bezieht sich hier immer auf die Länge der
Ätzmaske, d.h. der
- in Abb. 4.21 mit SM und DM bezeichnet.
Die Bezeichnung Gatelänge Lm bezieht sich hier immer auf die Länge der
Ätzmaske, d.h. der  MESFET hat eine effektive Gatelänge L von
nur
MESFET hat eine effektive Gatelänge L von
nur  . Das Gate sitzt symmetrisch zwischen Source und Drain, die
Abstände SG und DG betragen
. Das Gate sitzt symmetrisch zwischen Source und Drain, die
Abstände SG und DG betragen  .
.

Tabelle 4.3: Implantationsdaten
Die Implantationsdaten für die insgesamt vier Implantationen sind in
Tab. 4.3 zusammengestellt, Tab. 4.4 zeigt die Werte
der Schichtwiderstände nach den einzelnen Herstellungsschritten.

Tabelle 4.4: Gemessene Schichtwiderstände
Der erste Schritt für eine erfolgreiche Simulation ist die genaue Bestimmung
der Dotierungsprofile. Neben den Implantationsdaten ist vorallem die Bestimmung
der Aktivierung wichtig, die sehr stark von den Prozeßbedingungen abhängt
(vgl. Kap. 2.2.2). Angaben über die Annealingzeit und die
Annealingtemperatur können dabei Anhaltspunkte liefern. Die Kenntnis der
Schichtwiderstände nach den einzelnen Implantationsschritten ist für die
Bestimmung der Dotierungsprofile eine große Hilfe, da die Schichtwiderstände
aus der Simulation ermittelt werden können. Der Schichtwiderstand ist definiert
als der Widerstand eines Quadrates einer Materialschicht, unabhängig von der
Seitenlänge des Quadrates. Um den Schichtwiderstand zu bestimmen, wurde
ein `ungated' FET mit einem Source-Drain Abstand von  und einer Breite
von
und einer Breite
von  im linearen Bereich der Kennlinie simuliert.
Es ist dabei wichtig, immer die Depletionszone, die
durch die Oberflächenzustände erzeugt wird, zu berücksichtigen.
Abb. 4.22 zeigt die simulierte Struktur und die Kennlinien zur
Bestimmung der Schichtwiderstände.
im linearen Bereich der Kennlinie simuliert.
Es ist dabei wichtig, immer die Depletionszone, die
durch die Oberflächenzustände erzeugt wird, zu berücksichtigen.
Abb. 4.22 zeigt die simulierte Struktur und die Kennlinien zur
Bestimmung der Schichtwiderstände.
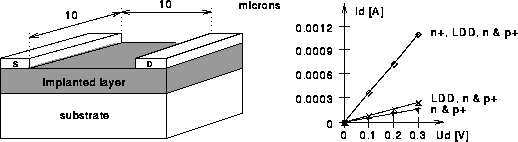
Abbildung 4.22: Struktur zur Simulation des Schichtwiderstandes und
Kennlinien der verschiedenen Schichten
Zuerst wurde die Kanalimplantation
(n) zusammen mit der tiefen p+ Implantation simuliert. Dabei wurden
zuerst die Reichweitendaten für Si und Mg nach [34] (vgl.
Abb.2.11) verwendet. Dabei ergibt sich allerdings ein zu geringer
Schichtwiderstand, der auf eine Überschätzung der Eindringtiefe von Si
schließen läßt. Die Verwendung der Reichweitendaten nach der LSS-Theorie
(vgl. Abb. 2.13) für Silizium ergibt gute Übereinstimmung mit
dem gemessenen Wert des Schichtwiderstandes.
Für die Diffusionslänge des Si
Profils wurde  angenommen, für das Mg Profil
angenommen, für das Mg Profil  . Eine
Feinabstimmung wurde durch Verwendung der Aktivierungsfunktion (2.6)
mit
. Eine
Feinabstimmung wurde durch Verwendung der Aktivierungsfunktion (2.6)
mit  erreicht. Mit diesem Profil ergibt sich ein Schichtwiderstand von
erreicht. Mit diesem Profil ergibt sich ein Schichtwiderstand von
 . Dieselbe Vorgangsweise wurde für die Bestimmung des LDD
und des n+ Profils durchgeführt. Dabei zeigt sich, daß besonders
die Aktivierung des LDD Profils sehr gering sein muß, da sich erst bei
Verwendung der Aktivierungsfunktion mit
. Dieselbe Vorgangsweise wurde für die Bestimmung des LDD
und des n+ Profils durchgeführt. Dabei zeigt sich, daß besonders
die Aktivierung des LDD Profils sehr gering sein muß, da sich erst bei
Verwendung der Aktivierungsfunktion mit  zufriedenstellende
Übereinstimmung ergibt. Dies ist aber aufgrund der Ausheilbedingungen
laut Aussage des Herstellers nicht ganz unrealistisch. Für die n+
Implantation ergibt eine Aktivierung von
zufriedenstellende
Übereinstimmung ergibt. Dies ist aber aufgrund der Ausheilbedingungen
laut Aussage des Herstellers nicht ganz unrealistisch. Für die n+
Implantation ergibt eine Aktivierung von  gute Übereinstimmung.
Der simulierte Schichtwiderstand für die Kombination p+, n und LDD
liegt damit bei
gute Übereinstimmung.
Der simulierte Schichtwiderstand für die Kombination p+, n und LDD
liegt damit bei  , der Schichtwiderstand für die Kombination aller
vier Implantationen liegt bei
, der Schichtwiderstand für die Kombination aller
vier Implantationen liegt bei  .
Tab. 4.5 zeigt eine Zusammenstellung der im Programm verwendeten
Parameter zur Berechnung des Dotierungsprofils.
.
Tab. 4.5 zeigt eine Zusammenstellung der im Programm verwendeten
Parameter zur Berechnung des Dotierungsprofils.
Abb. 4.23 zeigt das resultierende elektrisch aktive Dotierungsprofil
im Detail. Die Dicke der aktiven Schicht im Kanalbereich beträgt  .
.

Abbildung 4.23: Dotierungsprofil im Detail: das obere Bild zeigt Schnitte durch das
Dotierungsprofil im Kanalbereich (1), im Bereich der LDD Implantation
(2) und im Bereich der Kontaktimplantation (3); unten ist das gesamte
Dotierungsprofil des MESFET mit  zu sehen.
zu sehen.

Tabelle 4.5: In der Simulation verwendete Parameter zur Berechnung des
Dotierungsprofils
Der nächste Schritt war die Anpassung der simulierten Diodenkennlinien
an die gemessenen. Die im Programm verwendeten
Randbedingungen gelten streng genommen nur für eine ideale Diode, sieht man von
einer Korrektur der Oberflächenrekombinationsgeschwindigkeit ab, die erst für
starke Ströme in Flußrichtung zum Tragen kommt.
Erste Simulationen mit den angegebenen Werten für die Barrierenhöhen und
einem Idealitätsfaktor  ergaben deshalb auch starke Abweichungen von den
gemessenen Kennlinien. Durch Verwendung des Idealitätsfaktors
ergaben deshalb auch starke Abweichungen von den
gemessenen Kennlinien. Durch Verwendung des Idealitätsfaktors  , der direkt
angegeben werden kann, und durch Korrektur der Barrierenhöhen
konnte bei allen Gatelängen sehr gute Übereinstimmung erzielt werden.
Die Idealitätsfaktoren wurden aus den gemessenen Kennlinien ermittelt.
Tab. 4.6 zeigt eine Zusammenstellung der Idealitätsfaktoren und
Barrierenhöhen für die einzelnen Gatelängen.
, der direkt
angegeben werden kann, und durch Korrektur der Barrierenhöhen
konnte bei allen Gatelängen sehr gute Übereinstimmung erzielt werden.
Die Idealitätsfaktoren wurden aus den gemessenen Kennlinien ermittelt.
Tab. 4.6 zeigt eine Zusammenstellung der Idealitätsfaktoren und
Barrierenhöhen für die einzelnen Gatelängen.

Tabelle 4.6: Idealitätsfaktoren und Barrierenhöhen

Abbildung 4.24: Gatediode Lm=

Abbildung 4.25: Gatediode Lm=

Abbildung 4.26: Gatediode Lm=

Abbildung 4.27: Gatediode Lm=

Abbildung 4.28: Gatediode Lm=

Abbildung 4.29: Gatediode Lm=
Messungen und Simulationen für die verschiedenen Gatelängen zeigen die
Abbildungen 4.24 bis 4.29. Die zum Teil großen Abweichungen im
oberen Bereich der Kennlinien kommen einerseits durch den Einfluß eines
in der Simulation nicht berücksichtigten Gate-Serienwiderstandes, andererseits
durch eine Strombegrenzung in der Meßapparatur zustande. Die Gatedioden der
MESFETs mit den Gatelängen  bis
bis  zeigen bis
zeigen bis  nur sehr
geringe Abweichungen, während bei den beiden längsten Bauelementen, deren
Dioden auch einen besseren Idealitätsfaktor aufweisen, die simulierten
Kennlinien ab
nur sehr
geringe Abweichungen, während bei den beiden längsten Bauelementen, deren
Dioden auch einen besseren Idealitätsfaktor aufweisen, die simulierten
Kennlinien ab  einen beträchtlich höheren Gatestrom zeigen
(logarithmische Darstellung!).
einen beträchtlich höheren Gatestrom zeigen
(logarithmische Darstellung!).
Nach der Anpassung der Gatedioden wurden die Ausgangskennlinien simuliert.
Da sich die Drainströme der Bauelemente im Bereich von wenigen
Milliampere bewegen, wurde auf eine Miteinbeziehung von Kontakt- und
Meßwiderständen, die mit 5 Ohm angegeben waren, verzichtet.
Die Abbildungen 4.30, 4.31, 4.32 und 4.33
zeigen den Vergleich der gemessenen und simulierten
Ausgangskennfelder für die beiden kleinsten MESFETs ohne und mit
Berücksichtigung von EL2 Störstellen.
Für diese beiden Bauelemente mit  und
und
 , deren effektive Gatelänge nur
, deren effektive Gatelänge nur  bzw.
bzw.  beträgt, ist keine Übereinstimmung mit der Simulation gegeben.
Bei diesen Gatelängen reicht die Beschreibung des Elektronentransports
mithilfe des Drift-Diffusionsmodells nicht mehr aus. Besonders die Einbeziehung
nichtlokaler Effekte, wie des `velocity overshoot'
(vgl. Kap. 3.1.3), wird hier notwendig. Monte-Carlo-Rechnungen
[92] und Untersuchungen mit einem erweiterten Drift-Diffusionsmodell
[46] im Vergleich zum klassischen Drift-Diffusionsmodell zeigen
qualitativ das gleiche Verhalten, wie die Unterschiede zwischen Simulation und
Messung in den Abbildungen 4.30 bis 4.33. Die
Berücksichtigung der tiefen Störstellen (Abb. 4.31 und
4.33) bringt hier keine qualitative
Änderung der Ergebnisse. Auch quantitative Unterschiede sind kaum
zu erkennen.
beträgt, ist keine Übereinstimmung mit der Simulation gegeben.
Bei diesen Gatelängen reicht die Beschreibung des Elektronentransports
mithilfe des Drift-Diffusionsmodells nicht mehr aus. Besonders die Einbeziehung
nichtlokaler Effekte, wie des `velocity overshoot'
(vgl. Kap. 3.1.3), wird hier notwendig. Monte-Carlo-Rechnungen
[92] und Untersuchungen mit einem erweiterten Drift-Diffusionsmodell
[46] im Vergleich zum klassischen Drift-Diffusionsmodell zeigen
qualitativ das gleiche Verhalten, wie die Unterschiede zwischen Simulation und
Messung in den Abbildungen 4.30 bis 4.33. Die
Berücksichtigung der tiefen Störstellen (Abb. 4.31 und
4.33) bringt hier keine qualitative
Änderung der Ergebnisse. Auch quantitative Unterschiede sind kaum
zu erkennen.
Bei den Gatelängen  ,
,  und
und  (Abbildungen 4.34, 4.36 und 4.38)
zeigen die simulierten Werte gute
Übereinstimmung mit der Messung, zieht man die Unsicherheit in der Kenntnis des
Dotierungsprofils in Betracht. Dieses mußte ja nur mithilfe der
Implantationsdaten und Schichtwiderstandswerte ermittelt werden.
Bei den MESFETs mit
(Abbildungen 4.34, 4.36 und 4.38)
zeigen die simulierten Werte gute
Übereinstimmung mit der Messung, zieht man die Unsicherheit in der Kenntnis des
Dotierungsprofils in Betracht. Dieses mußte ja nur mithilfe der
Implantationsdaten und Schichtwiderstandswerte ermittelt werden.
Bei den MESFETs mit  und
und  Gatelänge (Abbildungen
4.36 und 4.38) läßt sich
besonders im Sättigungsbereich eine sehr gute Übereinstimmung erkennen.
Der Anstieg des Drainstromes im linearen Bereich ist bei allen Gatelängen
etwas zu hoch. Dies deutet darauf hin, daß der gemeinsame Bahnwiderstand der
LDD und n+ Gebiete im Bauelement etwas höher ist als angenommen.
Ein weiterer Trend in den Kennfeldern bei immer größer werdenden Gatelängen
ist deutlich zu erkennen. Die Transfercharakteristik der simulierten Bauelemente
wird im Vergleich zu den gemessenen Werten immer steiler.
Der MESFET mit
Gatelänge (Abbildungen
4.36 und 4.38) läßt sich
besonders im Sättigungsbereich eine sehr gute Übereinstimmung erkennen.
Der Anstieg des Drainstromes im linearen Bereich ist bei allen Gatelängen
etwas zu hoch. Dies deutet darauf hin, daß der gemeinsame Bahnwiderstand der
LDD und n+ Gebiete im Bauelement etwas höher ist als angenommen.
Ein weiterer Trend in den Kennfeldern bei immer größer werdenden Gatelängen
ist deutlich zu erkennen. Die Transfercharakteristik der simulierten Bauelemente
wird im Vergleich zu den gemessenen Werten immer steiler.
Der MESFET mit  Gatelänge (Abb. 4.40)
zeigt deshalb besonders bei den Gatespannungen
Gatelänge (Abb. 4.40)
zeigt deshalb besonders bei den Gatespannungen  und
und
 bereits beträchtliche Abweichungen.
Diese Tatsache deutet auf Ungenauigkeiten im Dotierungsprofil, speziell
in der Form des p-n Übergangs vom Kanalbereich zum `p-buffer' hin.
Für eine Klärung des Problems
würde eine Messung des Profils sehr hilfreich sein.
bereits beträchtliche Abweichungen.
Diese Tatsache deutet auf Ungenauigkeiten im Dotierungsprofil, speziell
in der Form des p-n Übergangs vom Kanalbereich zum `p-buffer' hin.
Für eine Klärung des Problems
würde eine Messung des Profils sehr hilfreich sein.
Die Ausgangskennfelder wurden noch einmal mit
Berücksichtigung einer EL2 Konzentration von  simuliert.
Qualitativ ergibt sich durch die Berücksichtigung der tiefen Störstellen
keine Änderung. Ein leichtes Ansteigen der Drainströme ist bei allen
Gatelängen zu beobachten.
Für die MESFETs mit den Gatelängen
simuliert.
Qualitativ ergibt sich durch die Berücksichtigung der tiefen Störstellen
keine Änderung. Ein leichtes Ansteigen der Drainströme ist bei allen
Gatelängen zu beobachten.
Für die MESFETs mit den Gatelängen  ,
,  und
und  (Abbildungen 4.35, 4.37 und 4.39)
ergibt sich dadurch in der Nähe des `pinch-off' Bereichs eine bessere
Übereinstimmung mit der Messung. Beim längsten MESFET (Abb. 4.41)
zeigt sich allerdings bei Berücksichtigung der EL2 Traps eine deutliche
Verschiebung des gesamten Kennlinienfeldes und damit eine schlechtere
Übereinstimmung mit den gemessenen Kurven.
Die Verschiebung ist in diesem Fall vor allem auf die Änderung des p-n
Überganges zum Substrat hin aufgrund des Einflusses der EL2 Traps
zurückzuführen.
Diese Simulationen zeigen, daß selbst bei Verwendung eines `p-buffers',
der Einfluß der tiefen Störstellen auf die Ausgangskennfelder nicht
vernachlässigbar ist.
(Abbildungen 4.35, 4.37 und 4.39)
ergibt sich dadurch in der Nähe des `pinch-off' Bereichs eine bessere
Übereinstimmung mit der Messung. Beim längsten MESFET (Abb. 4.41)
zeigt sich allerdings bei Berücksichtigung der EL2 Traps eine deutliche
Verschiebung des gesamten Kennlinienfeldes und damit eine schlechtere
Übereinstimmung mit den gemessenen Kurven.
Die Verschiebung ist in diesem Fall vor allem auf die Änderung des p-n
Überganges zum Substrat hin aufgrund des Einflusses der EL2 Traps
zurückzuführen.
Diese Simulationen zeigen, daß selbst bei Verwendung eines `p-buffers',
der Einfluß der tiefen Störstellen auf die Ausgangskennfelder nicht
vernachlässigbar ist.
Zusammenfassend ist zu bemerken, daß sich mit MINIMOS auch für
ionenimplantierte MESFETs mit unterschiedlichen Gatelängen zufriedenstellende
Übereinstimmung mit realen Bauelementen erzielen läßt, solange die
Gültigkeit des klassischen Drift-Diffusionsmodells angenommen werden kann.
Auf jeden Fall stellt die genaue Kenntnis des Dotierungsprofils bei
ionenimplantierten MESFETs die wichtigste Voraussetzung für eine gute
quantitative Übereinstimmung der Simulation mit realen Bauelementen dar.
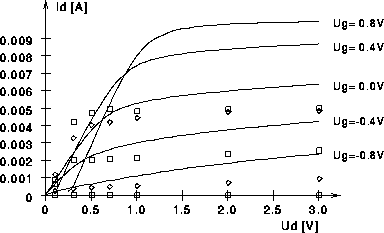
Abbildung 4.30: Ausgangskennlinien Lm=
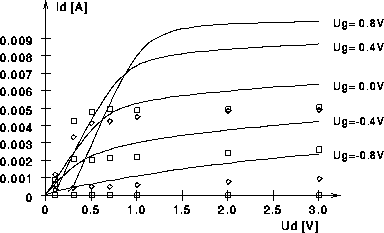
Abbildung: Ausgangskennlinien Lm= mit Berücksichtigung
einer EL2 Konzentration von
mit Berücksichtigung
einer EL2 Konzentration von 
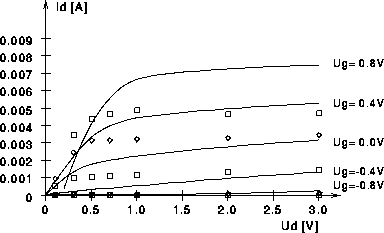
Abbildung 4.32: Ausgangskennlinien Lm=
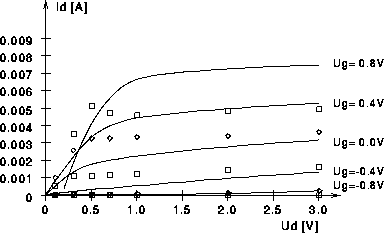
Abbildung: Ausgangskennlinien Lm= mit Berücksichtigung
einer EL2 Konzentration von
mit Berücksichtigung
einer EL2 Konzentration von 
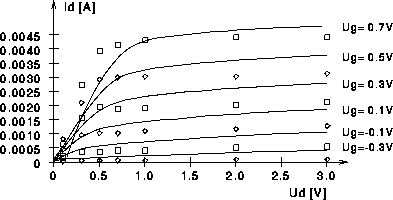
Abbildung 4.34: Ausgangskennlinien Lm=
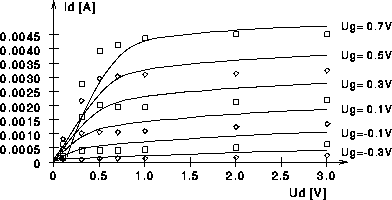
Abbildung: Ausgangskennlinien Lm= mit Berücksichtigung
einer EL2 Konzentration von
mit Berücksichtigung
einer EL2 Konzentration von 

Abbildung 4.36: Ausgangskennlinien Lm=

Abbildung: Ausgangskennlinien Lm= mit Berücksichtigung
einer EL2 Konzentration von
mit Berücksichtigung
einer EL2 Konzentration von 
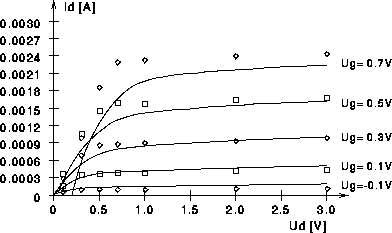
Abbildung 4.38: Ausgangskennlinien Lm=
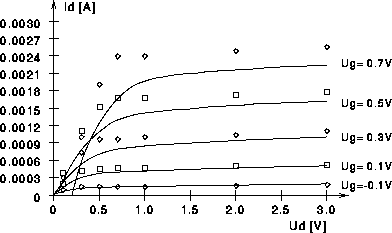
Abbildung: Ausgangskennlinien Lm= mit Berücksichtigung
einer EL2 Konzentration von
mit Berücksichtigung
einer EL2 Konzentration von 
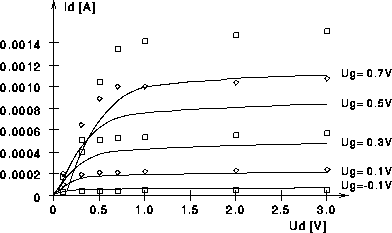
Abbildung 4.40: Ausgangskennlinien Lm=
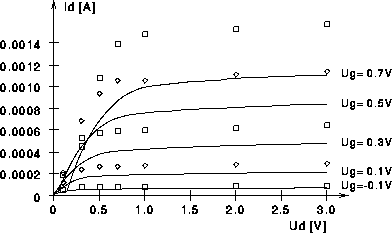
Abbildung: Ausgangskennlinien Lm= mit Berücksichtigung
einer EL2 Konzentration von
mit Berücksichtigung
einer EL2 Konzentration von 




Next: 5 Ausblick
Up: 4 Ergebnisse
Previous: 4.4 Kennlinie eines `ungated'
Martin Stiftinger
Fri Oct 14 19:00:51 MET 1994
 bis
bis
 hergestellt worden waren. Neben den Ausgangs-, Transfer- und
Diodenkennlinien wurden noch die Barrierenhöhen der Gatedioden, die
Implantationsdaten und Messungen des Schichtwiderstandes für die verschiedenen
Implantationen zur Verfügung gestellt. Messungen der Dotierungsprofile standen
leider nicht zur Verfügung.
hergestellt worden waren. Neben den Ausgangs-, Transfer- und
Diodenkennlinien wurden noch die Barrierenhöhen der Gatedioden, die
Implantationsdaten und Messungen des Schichtwiderstandes für die verschiedenen
Implantationen zur Verfügung gestellt. Messungen der Dotierungsprofile standen
leider nicht zur Verfügung.




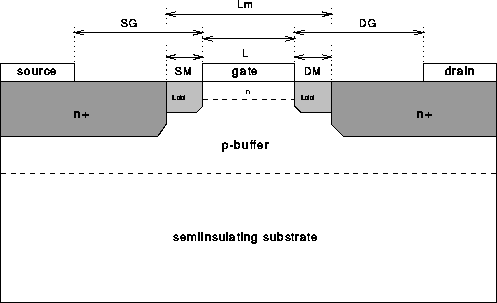
 - in Abb.
- in Abb.  MESFET hat eine effektive Gatelänge L von
nur
MESFET hat eine effektive Gatelänge L von
nur  . Das Gate sitzt symmetrisch zwischen Source und Drain, die
Abstände SG und DG betragen
. Das Gate sitzt symmetrisch zwischen Source und Drain, die
Abstände SG und DG betragen  .
.


 und einer Breite
von
und einer Breite
von 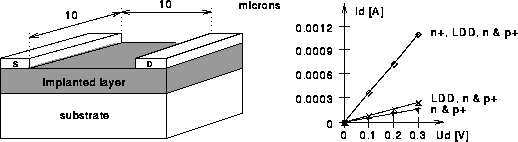
 angenommen, für das Mg Profil
angenommen, für das Mg Profil  . Eine
Feinabstimmung wurde durch Verwendung der Aktivierungsfunktion (
. Eine
Feinabstimmung wurde durch Verwendung der Aktivierungsfunktion ( erreicht. Mit diesem Profil ergibt sich ein Schichtwiderstand von
erreicht. Mit diesem Profil ergibt sich ein Schichtwiderstand von
 . Dieselbe Vorgangsweise wurde für die Bestimmung des LDD
und des n+ Profils durchgeführt. Dabei zeigt sich, daß besonders
die Aktivierung des LDD Profils sehr gering sein muß, da sich erst bei
Verwendung der Aktivierungsfunktion mit
. Dieselbe Vorgangsweise wurde für die Bestimmung des LDD
und des n+ Profils durchgeführt. Dabei zeigt sich, daß besonders
die Aktivierung des LDD Profils sehr gering sein muß, da sich erst bei
Verwendung der Aktivierungsfunktion mit  zufriedenstellende
Übereinstimmung ergibt. Dies ist aber aufgrund der Ausheilbedingungen
laut Aussage des Herstellers nicht ganz unrealistisch. Für die n+
Implantation ergibt eine Aktivierung von
zufriedenstellende
Übereinstimmung ergibt. Dies ist aber aufgrund der Ausheilbedingungen
laut Aussage des Herstellers nicht ganz unrealistisch. Für die n+
Implantation ergibt eine Aktivierung von  gute Übereinstimmung.
Der simulierte Schichtwiderstand für die Kombination p+, n und LDD
liegt damit bei
gute Übereinstimmung.
Der simulierte Schichtwiderstand für die Kombination p+, n und LDD
liegt damit bei  , der Schichtwiderstand für die Kombination aller
vier Implantationen liegt bei
, der Schichtwiderstand für die Kombination aller
vier Implantationen liegt bei  .
Tab.
.
Tab.  .
.

 zu sehen.
zu sehen.
 ergaben deshalb auch starke Abweichungen von den
gemessenen Kennlinien. Durch Verwendung des Idealitätsfaktors
ergaben deshalb auch starke Abweichungen von den
gemessenen Kennlinien. Durch Verwendung des Idealitätsfaktors  , der direkt
angegeben werden kann, und durch Korrektur der Barrierenhöhen
konnte bei allen Gatelängen sehr gute Übereinstimmung erzielt werden.
Die Idealitätsfaktoren wurden aus den gemessenen Kennlinien ermittelt.
Tab.
, der direkt
angegeben werden kann, und durch Korrektur der Barrierenhöhen
konnte bei allen Gatelängen sehr gute Übereinstimmung erzielt werden.
Die Idealitätsfaktoren wurden aus den gemessenen Kennlinien ermittelt.
Tab. 










 zeigen bis
zeigen bis  nur sehr
geringe Abweichungen, während bei den beiden längsten Bauelementen, deren
Dioden auch einen besseren Idealitätsfaktor aufweisen, die simulierten
Kennlinien ab
nur sehr
geringe Abweichungen, während bei den beiden längsten Bauelementen, deren
Dioden auch einen besseren Idealitätsfaktor aufweisen, die simulierten
Kennlinien ab  einen beträchtlich höheren Gatestrom zeigen
(logarithmische Darstellung!).
einen beträchtlich höheren Gatestrom zeigen
(logarithmische Darstellung!).
 und
und
 , deren effektive Gatelänge nur
, deren effektive Gatelänge nur  bzw.
bzw.  (Abbildungen
(Abbildungen  Gatelänge (Abb.
Gatelänge (Abb.  simuliert.
Qualitativ ergibt sich durch die Berücksichtigung der tiefen Störstellen
keine Änderung. Ein leichtes Ansteigen der Drainströme ist bei allen
Gatelängen zu beobachten.
Für die MESFETs mit den Gatelängen
simuliert.
Qualitativ ergibt sich durch die Berücksichtigung der tiefen Störstellen
keine Änderung. Ein leichtes Ansteigen der Drainströme ist bei allen
Gatelängen zu beobachten.
Für die MESFETs mit den Gatelängen