5.4 Prozeßsensitivität




Next: 6 Unterdrückung heißer Ladungsträger
Up: 5 Prozeßvereinfachung bei der
Previous: 5.3 Drain-Profil
Da die Chip-Fertigung unvermeidbaren, statistisch verteilten Abweichungen der Prozeßparameter
von ihren Nennwerten unterliegt, soll unter dem Titel Prozeßsensitivität
die Auswirkung von Prozeßschwankungen auf die elektrischen
Eigenschaften der Einzeltransistoren untersucht werden.
Als wichtigste Prozeßparameter werden dabei die Oxiddicke  ,
die Gate-Länge
,
die Gate-Länge  , die Spacer-Länge sowie die Kanalimplantationsdosen
herausgegriffen. An Transistorkenngrößen interessieren vor allem
die Threshold-Spannung
, die Spacer-Länge sowie die Kanalimplantationsdosen
herausgegriffen. An Transistorkenngrößen interessieren vor allem
die Threshold-Spannung  , der maximale Drainstrom
, der maximale Drainstrom  ,
die Steilheit
,
die Steilheit  und für die Abschätzung der zu erwartenden
Bauelementlebensdauer der maximale Substratstrom
und für die Abschätzung der zu erwartenden
Bauelementlebensdauer der maximale Substratstrom  .
.
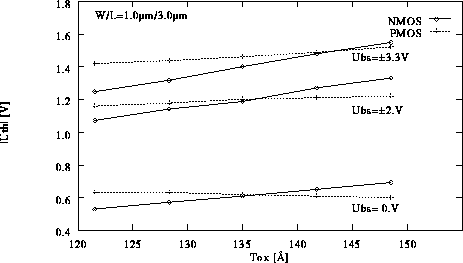
Abbildung: Variation der Gate-Oxiddicke:
Betrag der Threshold-Spannung  von
von  - und
- und  -Kanal-Transistor
über der Oxiddicke
-Kanal-Transistor
über der Oxiddicke  für verschiedene
Substrat-Source-Spannungen
für verschiedene
Substrat-Source-Spannungen  .
.
Die Auswirkung einer Oxiddickenvariation in einer Bandbreite von
 auf die Langkanal-Threshold-Spannung ist in Abb. 5.13
sowohl für den
auf die Langkanal-Threshold-Spannung ist in Abb. 5.13
sowohl für den  - als auch den
- als auch den  -Kanal-Transistor dargestellt.
Bemerkenswert ist die negative Steigung der
-Kanal-Transistor dargestellt.
Bemerkenswert ist die negative Steigung der  -MOSFET-Charakteristik
für
-MOSFET-Charakteristik
für  : Der Betrag der Threshold-Spannung wird bei kleinerer
Oxiddicke größer!
Die Erklärung liegt im vergrabenen Kanal mit
Gegendotierung an der Oberfläche, die das Integral von
Donatoren- minus Akzeptorenkonzentration über die gesamte
Kanalraumladungszone
leicht negativ werden läßt. Erst der Substrateffekt mit
steigender Substrat-Source-Spannung bewirkt eine Trendumkehr und
für
: Der Betrag der Threshold-Spannung wird bei kleinerer
Oxiddicke größer!
Die Erklärung liegt im vergrabenen Kanal mit
Gegendotierung an der Oberfläche, die das Integral von
Donatoren- minus Akzeptorenkonzentration über die gesamte
Kanalraumladungszone
leicht negativ werden läßt. Erst der Substrateffekt mit
steigender Substrat-Source-Spannung bewirkt eine Trendumkehr und
für  eine positive Steigung der
eine positive Steigung der
 -
- -Kennlinie. Die offensichtliche
Insensitivität der Threshold-Spannung auf Oxiddickenvariation
bei diesem Transistor ist eine Auswirkung der verminderten
Gate-Steuerbarkeit des
-Kennlinie. Die offensichtliche
Insensitivität der Threshold-Spannung auf Oxiddickenvariation
bei diesem Transistor ist eine Auswirkung der verminderten
Gate-Steuerbarkeit des  -MOSFET mit vergrabenem Kanal.
-MOSFET mit vergrabenem Kanal.
Der Spacer wird wie üblich durch Abscheidung von  oder
auch
oder
auch  aus der gasförmigen Phase (,,Low-Pressure Chemical
Vapor Deposition`` (LPCVD)) hergestellt [Rho88]. Die Spacer-Länge mit
einem Sollwert von
aus der gasförmigen Phase (,,Low-Pressure Chemical
Vapor Deposition`` (LPCVD)) hergestellt [Rho88]. Die Spacer-Länge mit
einem Sollwert von  wird durch anisotropes Plasmaätzen definiert.
Hohe Präzision bei diesem Prozeßschritt ist erforderlich, weil
bei der einfach-implantierten Drain-Struktur
die nach dem Ätzen verbleibende Spacer-Länge direkt in die effektive
Kanallänge eingeht.
In Abb. 5.14 ist der Kurzkanaleffekt beim
wird durch anisotropes Plasmaätzen definiert.
Hohe Präzision bei diesem Prozeßschritt ist erforderlich, weil
bei der einfach-implantierten Drain-Struktur
die nach dem Ätzen verbleibende Spacer-Länge direkt in die effektive
Kanallänge eingeht.
In Abb. 5.14 ist der Kurzkanaleffekt beim  -MOSFET
für
-MOSFET
für  ,
,  und
und  Spacer-Länge dargestellt.
Eine kleinere Spacer-Länge erhöht den Kurzkanaleffekt drastisch.
Spacer-Länge dargestellt.
Eine kleinere Spacer-Länge erhöht den Kurzkanaleffekt drastisch.
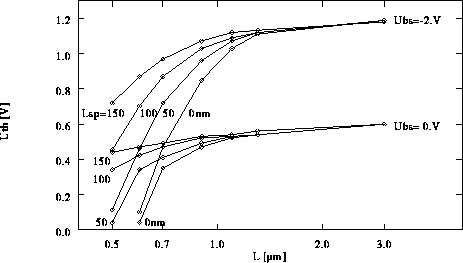
Abbildung: Variation der Spacer-Länge:
 -MOSFET-Threshold-Spannung
-MOSFET-Threshold-Spannung  über der Gate-Länge
über der Gate-Länge  für
für  ,
,  ,
,  und
und  Spacer-Länge.
Spacer-Länge.
Der maximale Drainstrom  steigt, wie aus Abb. 5.15
ersichtlich, mit kleinerer Spacer-Länge an. Negativ wirkt sich ein
kleiner Spacer auf die parasitären Gate-Source- und
Gate-Drain-Überlappungskapazitäten aus. Die Untergrenze
für die Spacer-Länge wird durch das Ansteigen der lateralen
elektrischen Feldstärke
steigt, wie aus Abb. 5.15
ersichtlich, mit kleinerer Spacer-Länge an. Negativ wirkt sich ein
kleiner Spacer auf die parasitären Gate-Source- und
Gate-Drain-Überlappungskapazitäten aus. Die Untergrenze
für die Spacer-Länge wird durch das Ansteigen der lateralen
elektrischen Feldstärke  und damit das Ansteigen der
Degradation aufgrund heißer Ladungsträger gesetzt
(vgl. Kapitel 6). Indiz dafür ist die starke Zunahme des
Substratstromes
und damit das Ansteigen der
Degradation aufgrund heißer Ladungsträger gesetzt
(vgl. Kapitel 6). Indiz dafür ist die starke Zunahme des
Substratstromes  bei geringerer Spacer-Länge in Abb. 5.16.
bei geringerer Spacer-Länge in Abb. 5.16.
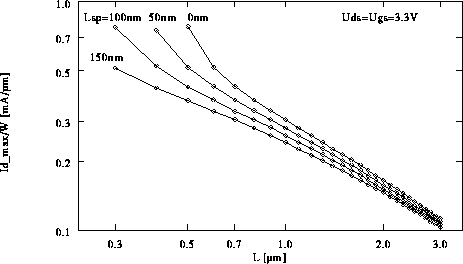
Abbildung: Variation der Gate- und Spacer-Länge:
Maximaler Drainstrom  des
des  -Kanal-Transistors
über der Gate-Länge
-Kanal-Transistors
über der Gate-Länge  für
für  ,
,  ,
,  und
und  Spacer-Länge.
Spacer-Länge.
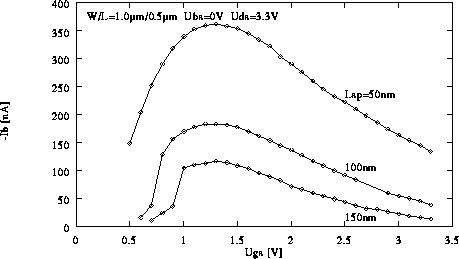
Abbildung: Variation der Spacer-Länge:
Substratstrom-Kennlinie  des
des  -Kanal-Transistors
für
-Kanal-Transistors
für  ,
,  und
und  Spacer-Länge.
Spacer-Länge.




Next: 6 Unterdrückung heißer Ladungsträger
Up: 5 Prozeßvereinfachung bei der
Previous: 5.3 Drain-Profil
Martin Stiftinger
Mon Oct 17 21:16:53 MET 1994
 ,
die Gate-Länge
,
die Gate-Länge  , die Spacer-Länge sowie die Kanalimplantationsdosen
herausgegriffen. An Transistorkenngrößen interessieren vor allem
die Threshold-Spannung
, die Spacer-Länge sowie die Kanalimplantationsdosen
herausgegriffen. An Transistorkenngrößen interessieren vor allem
die Threshold-Spannung  , der maximale Drainstrom
, der maximale Drainstrom  ,
die Steilheit
,
die Steilheit  und für die Abschätzung der zu erwartenden
Bauelementlebensdauer der maximale Substratstrom
und für die Abschätzung der zu erwartenden
Bauelementlebensdauer der maximale Substratstrom  .
.




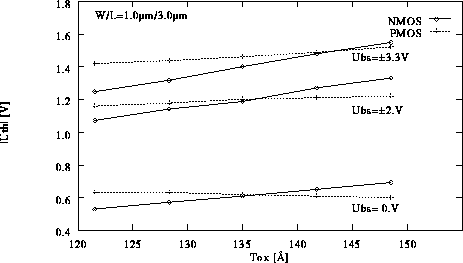
 - und
- und  -Kanal-Transistor
über der Oxiddicke
-Kanal-Transistor
über der Oxiddicke  .
. auf die Langkanal-Threshold-Spannung ist in Abb.
auf die Langkanal-Threshold-Spannung ist in Abb.  : Der Betrag der Threshold-Spannung wird bei kleinerer
Oxiddicke größer!
Die Erklärung liegt im vergrabenen Kanal mit
Gegendotierung an der Oberfläche, die das Integral von
Donatoren- minus Akzeptorenkonzentration über die gesamte
Kanalraumladungszone
leicht negativ werden läßt. Erst der Substrateffekt mit
steigender Substrat-Source-Spannung bewirkt eine Trendumkehr und
für
: Der Betrag der Threshold-Spannung wird bei kleinerer
Oxiddicke größer!
Die Erklärung liegt im vergrabenen Kanal mit
Gegendotierung an der Oberfläche, die das Integral von
Donatoren- minus Akzeptorenkonzentration über die gesamte
Kanalraumladungszone
leicht negativ werden läßt. Erst der Substrateffekt mit
steigender Substrat-Source-Spannung bewirkt eine Trendumkehr und
für  eine positive Steigung der
eine positive Steigung der
 oder
auch
oder
auch  aus der gasförmigen Phase (,,Low-Pressure Chemical
Vapor Deposition`` (LPCVD)) hergestellt
aus der gasförmigen Phase (,,Low-Pressure Chemical
Vapor Deposition`` (LPCVD)) hergestellt  wird durch anisotropes Plasmaätzen definiert.
Hohe Präzision bei diesem Prozeßschritt ist erforderlich, weil
bei der einfach-implantierten Drain-Struktur
die nach dem Ätzen verbleibende Spacer-Länge direkt in die effektive
Kanallänge eingeht.
In Abb.
wird durch anisotropes Plasmaätzen definiert.
Hohe Präzision bei diesem Prozeßschritt ist erforderlich, weil
bei der einfach-implantierten Drain-Struktur
die nach dem Ätzen verbleibende Spacer-Länge direkt in die effektive
Kanallänge eingeht.
In Abb.  ,
,  und
und 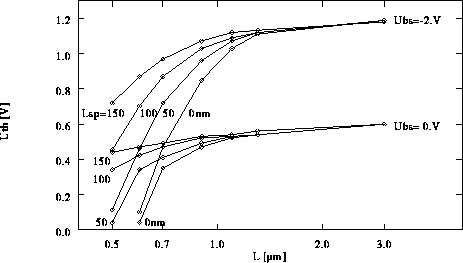
 ,
,  und damit das Ansteigen der
Degradation aufgrund heißer Ladungsträger gesetzt
(vgl. Kapitel
und damit das Ansteigen der
Degradation aufgrund heißer Ladungsträger gesetzt
(vgl. Kapitel  bei geringerer Spacer-Länge in Abb.
bei geringerer Spacer-Länge in Abb. 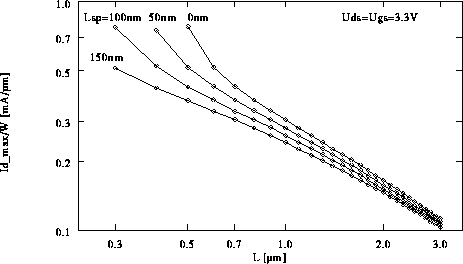
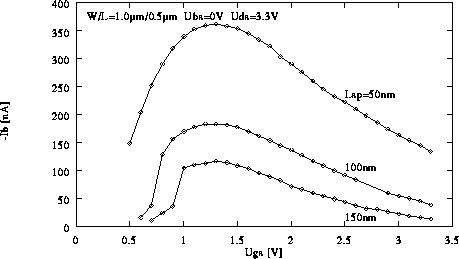
 des
des