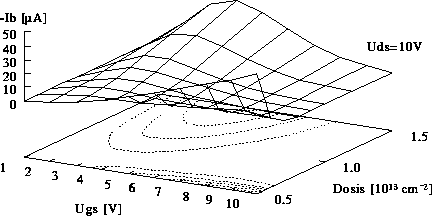
Abbildung: Variation der LDD-Dosis zur Substratstromminimierung: Substratstrom-Kennlinie
 bei
bei  über der LDD-Implantationsdosis
(LDD-Implantationsenergie
über der LDD-Implantationsdosis
(LDD-Implantationsenergie  ,
,  ,
,
 ,
,  ).
).




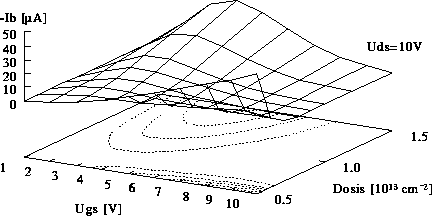
Abbildung: Variation der LDD-Dosis zur Substratstromminimierung:
Substratstrom-Kennlinie  bei
bei  über der LDD-Implantationsdosis
(LDD-Implantationsenergie
über der LDD-Implantationsdosis
(LDD-Implantationsenergie  ,
,  ,
,
 ,
,  ).
).
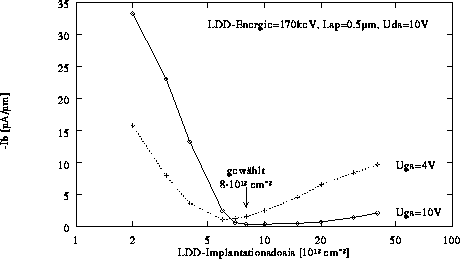
Abbildung: Variation der LDD-Implantationsdosis:
Substratstrom  bei
bei  und
und  über der
LDD-Implantationsdosis.
über der
LDD-Implantationsdosis.
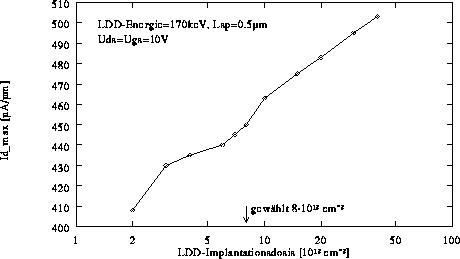
Abbildung: Variation der LDD-Implantationsdosis: Maximaler
Drainstrom  bei
bei  über der
LDD-Implantationsdosis.
über der
LDD-Implantationsdosis.
In Abb. 6.6 ist die Substratstromkennlinie  bei
bei  bei Variation der LDD-Implantationsdosis zwischen
bei Variation der LDD-Implantationsdosis zwischen
 und
und  quasi-dreidimensional dargestellt. Der generelle Trend ergibt bei mittleren
Gate-Source-Spannungen niedrigeren Substratstrom für
niedrigere LDD-Implantationsdosis. Interessanterweise biegt
sich die Substratstromkennlinie bei den
niederen LDD-Dosen zu einer innerhalb der
Versorgungsspannungsgrenze streng monoton steigenden
Funktion der Gate-Source-Spannung auf.
quasi-dreidimensional dargestellt. Der generelle Trend ergibt bei mittleren
Gate-Source-Spannungen niedrigeren Substratstrom für
niedrigere LDD-Implantationsdosis. Interessanterweise biegt
sich die Substratstromkennlinie bei den
niederen LDD-Dosen zu einer innerhalb der
Versorgungsspannungsgrenze streng monoton steigenden
Funktion der Gate-Source-Spannung auf.
Die aus der Variation der Spacer-Länge und der LDD-Implantationsenergie
bekannte Darstellung des Substratstroms für einen erweiterten
Dosisbereich von  bis
bis  in Abb. 6.7 erfolgt daher für die Gate-Source-Spannung
in Abb. 6.7 erfolgt daher für die Gate-Source-Spannung  (Maximum des Substratstroms bei der einfacher Höckerform der
Substratstromkennlinie)
und
(Maximum des Substratstroms bei der einfacher Höckerform der
Substratstromkennlinie)
und  (maximaler Substratstrom bei ,,aufgebogener``
Substratstromkennlinie). Die beiden Kennlinien in Abb. 6.7
schneiden einander bei einer Dosis von ca.
(maximaler Substratstrom bei ,,aufgebogener``
Substratstromkennlinie). Die beiden Kennlinien in Abb. 6.7
schneiden einander bei einer Dosis von ca.  . Dies
stellt laut Simulation das Optimum bezüglich Substratstromminimierung
dar. Der maximale Drainstrom in Abb. 6.8 nimmt allerdings mit
steigender LDD-Implantationsdosis monoton zu. Die Berücksichtigung der
Stromtreiberfähigkeit bestimmt die Wahl der LDD-Implantationsdosis
zu
. Dies
stellt laut Simulation das Optimum bezüglich Substratstromminimierung
dar. Der maximale Drainstrom in Abb. 6.8 nimmt allerdings mit
steigender LDD-Implantationsdosis monoton zu. Die Berücksichtigung der
Stromtreiberfähigkeit bestimmt die Wahl der LDD-Implantationsdosis
zu  .
.
Das von einer einfachen Höckerform abweichende Substratstromverhalten
wurde schon in [Mat83] und [Hui85] berichtet. Um eine
detailierte Diskussion des Drain-seitigen Feld- und Stromverlaufs
wie etwa in [Orl89a] anstellen zu können, seien vier Punkte aus
Abb. 6.6 herausgegriffen: Jene mit einer
LDD-Dosis von  und
und  sowie einer Gate-Source-Spannung von
sowie einer Gate-Source-Spannung von  und
und  .
Für diese vier Punkte sind in den Abbildungen 6.9 bis
6.12 jeweils die laterale elektrische Feldstärke, die
Elektronenstromdichte und die Lawinengenerationsrate
in der Drain-Seite als Konturlinienzeichnungen dargestellt.
.
Für diese vier Punkte sind in den Abbildungen 6.9 bis
6.12 jeweils die laterale elektrische Feldstärke, die
Elektronenstromdichte und die Lawinengenerationsrate
in der Drain-Seite als Konturlinienzeichnungen dargestellt.

Abbildung: LDD-Dosis  ,
,  ,
,  :
Isolinien für
die laterale elektrische Feldstärke [
:
Isolinien für
die laterale elektrische Feldstärke [ ],
die Elektronenstromdichte [
],
die Elektronenstromdichte [ ] und
Lawinengenerationsrate [
] und
Lawinengenerationsrate [ ].
].

Abbildung: LDD-Dosis  ,
,  ,
,  :
Isolinien für
die laterale elektrische Feldstärke [
:
Isolinien für
die laterale elektrische Feldstärke [ ],
die Elektronenstromdichte [
],
die Elektronenstromdichte [ ] und
die Lawinengenerationsrate [
] und
die Lawinengenerationsrate [ ].
].

Abbildung: LDD-Dosis  ,
,  ,
,  :
Isolinien für
die laterale elektrische Feldstärke [
:
Isolinien für
die laterale elektrische Feldstärke [ ],
die Elektronenstromdichte [
],
die Elektronenstromdichte [ ] und
die Lawinengenerationsrate [
] und
die Lawinengenerationsrate [ ].
].

Abbildung: LDD-Dosis  ,
,  ,
,  :
Isolinien für
die laterale elektrische Feldstärke [
:
Isolinien für
die laterale elektrische Feldstärke [ ],
die Elektronenstromdichte [
],
die Elektronenstromdichte [ ] und
die Lawinengenerationsrate [
] und
die Lawinengenerationsrate [ ].
].
In [Ko86] und ausführlicher in [Orl89b] wird als Erklärung für die von der konventionellen Form abweichende Substratstromkennlinie eine Feldstärkenspitze an der Source-Seite des Kanals angeführt. In der vorliegenden Arbeit konnte innerhalb des untersuchten Bereichs von LDD-Implantationsdosis und Kontaktspannungen allerdings keinerlei Hinweis auf eine Source-seitige Feldstärkenspitze gefunden werden.
Der Vergleich der beiden Dosiswerte bei  zeigt für die höhere Dosis (Abb. 6.9) einen sanften
Feldverlauf mit einer Spitze um
zeigt für die höhere Dosis (Abb. 6.9) einen sanften
Feldverlauf mit einer Spitze um  tief im
Silizium und gerade noch innerhalb der Gate-Kante bei
tief im
Silizium und gerade noch innerhalb der Gate-Kante bei  .
Bei der niedrigeren LDD-Dosis von
.
Bei der niedrigeren LDD-Dosis von  (Abb. 6.10) bildet der Feldstärkeverlauf deutlich
erkennbar zwei Spitzen, die etwas höhere unerwünschterweise
direkt an der Grenzfläche und außerhalb der Gate-Kante. Auch wird
der Elektronenstrom beim Übergang vom Kanal in die Drain-Zone nicht so
tief in das Silizium gedrückt. Als Folge davon ist die
Lawinengenerationszone nahe der Grenzfläche bei
(Abb. 6.10) bildet der Feldstärkeverlauf deutlich
erkennbar zwei Spitzen, die etwas höhere unerwünschterweise
direkt an der Grenzfläche und außerhalb der Gate-Kante. Auch wird
der Elektronenstrom beim Übergang vom Kanal in die Drain-Zone nicht so
tief in das Silizium gedrückt. Als Folge davon ist die
Lawinengenerationszone nahe der Grenzfläche bei
 , also außerhalb der Gate-Überdeckung.
, also außerhalb der Gate-Überdeckung.
Der Vergleich der beiden Dosiswerte bei  zeigt für die höhere Dosis (Abb. 6.11) eine Spaltung
der lateralen Feldstärkenspitze. Da aber der Drainstrom dazwischen
hindurch fließt, ist die Generationsrate hinreichend klein und
resultiert im kleinsten Substratstrom der vier Vergleichspunkte.
Bei der niedrigeren LDD-Dosis steigt der Substratstrom mit der
Gate-Source-Spannung monoton an. Die Erklärung ist in
Abb. 6.12 ersichtlich: Das laterale elektrische Feld hat
sein Maximum an der Grenzfläche bei etwa
zeigt für die höhere Dosis (Abb. 6.11) eine Spaltung
der lateralen Feldstärkenspitze. Da aber der Drainstrom dazwischen
hindurch fließt, ist die Generationsrate hinreichend klein und
resultiert im kleinsten Substratstrom der vier Vergleichspunkte.
Bei der niedrigeren LDD-Dosis steigt der Substratstrom mit der
Gate-Source-Spannung monoton an. Die Erklärung ist in
Abb. 6.12 ersichtlich: Das laterale elektrische Feld hat
sein Maximum an der Grenzfläche bei etwa  , der Drainstrom
(Elektronenstrom) bleibt ebenso an der Grenzfläche, fließt also
durch das Gebiet mit der Feldstärkenspitze. Daraus resultierend
zeigt die Lawinengenerationsrate ihr Maximum (über
, der Drainstrom
(Elektronenstrom) bleibt ebenso an der Grenzfläche, fließt also
durch das Gebiet mit der Feldstärkenspitze. Daraus resultierend
zeigt die Lawinengenerationsrate ihr Maximum (über  )
an der Grenzfläche und außerhalb der Gate-Kante, eine für hohe
Degradation und kurze Lebensdauer des MOS-Transistors verantwortliche
Kombination.
)
an der Grenzfläche und außerhalb der Gate-Kante, eine für hohe
Degradation und kurze Lebensdauer des MOS-Transistors verantwortliche
Kombination.



