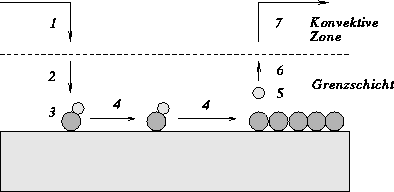
Abbildung 4.7: Schematische Darstellung des Abscheidevorganges.




Der Begriff CVD steht abkürzend für Chemical Vapor Deposition und bezeichnet die Abscheidung eines festen amorphen, poly- oder monokristllinen Films auf einem Substrat aus der Gasphase. Die Gase, die den oder die Reaktanten enthalten werden hierbei in einen Reaktor geleitet, dort durch Energiezufuhr dissoziert und die Radikale einer Reaktion zugeführt. Die Energiezufuhr kann entweder thermisch, also durch Wärme oder durch Anregung der Reaktanten in einem Plasma erfolgen.
Der Depositionsprozeß besteht aus einer Reaktionsfolge, an der Transportvorgänge und chemische Reaktionen beteiligt sind. Abbildung 4.7 zeigt eine schematische Darstellung des Abscheidevorganges.
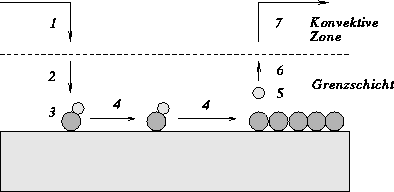
Abbildung 4.7: Schematische Darstellung des Abscheidevorganges.
Die Teilprozesse lassen sich folgendermaßen beschreiben:
Niedertemperaturoxide werden durch einen Silanprozeß bei Abscheidetemperaturen
von  hergestellt. Die Siliziumschicht wird dabei durch
Zersetzung von Silan in Gegenwart von Sauerstoff abgeschieden:
hergestellt. Die Siliziumschicht wird dabei durch
Zersetzung von Silan in Gegenwart von Sauerstoff abgeschieden:

Das Gasgemisch besteht in der Praxis aus Argon, Stickstoff und Sauerstoff mit einem Zusatz von 1% Silan.
Für die Herstellung von Siliziumnitridschichten wird als Trägergas Argon oder Stickstoff verwendet, dem Silan, Ammoniak und Wasserstoff beigemischt wird. Die Reaktion an der Substratoberfläche kann durch folgende Gleichung beschrieben werden:

Der Prozeß wird im Temperaturbereich von  bis
bis  durchgeführt.
durchgeführt.
Auf ähnliche Weise können Polysiliziumschichten, Bor- und Phosphorglasschichten sowie auch Metall- und Metallsilizidschichten abgeschieden werden.
Der Transport der Reaktionsgase zur Substratoberfläche erfolgt gleichzeitig
über Strömungs- und Diffusionsprozesse. Nahe der Oberfläche wird die
Oberflächenreaktion von Diffusionsprozessen bestimmt. Wenn die
Reaktionsgaskonzentration an der Scheibenoberfläche nur wenig kleiner ist
als die Konzentration im Gasgemisch, das in den Reaktor geleitet wird,
spricht man von einem reaktionsbestimmten Prozeß, weil die Reaktionsrate an
der Oberfläche das Schichtwachstum bestimmt. Im Gegensatz dazu spricht man
bei Prozessen, bei denen die Oberflächenreaktion so groß ist, daß die
Reaktionsgaskonzentration nahe der Oberfläche stark abnimmt von
diffusionsbestimmten Prozessen. Reaktionsbestimmte Prozesse werden
angestrebt, da sie zu gleichmäßigeren Abscheideraten führen und die
Anordnung der Halbleiterscheiben im CVD-Reaktor weniger kritisch ist. Der
entscheidende Parameter, der eine Verschiebung der Gasphasenreaktion in
Richtung eines reaktionsbestimmten Prozesses ermöglicht, ist der Gasdruck
im CVD-Reaktor. Erniedrigt man den Druck, sinkt der Konzentrationsgradient
senkrecht zur Oberfläche quadratisch, wodurch im Extremfall an jedem Punkt
der Halbleiterscheibe nahezu die gleiche Konzentration an Reaktionsgasen
herrscht. Aus diesem Grund gehören Niederdruck-Reaktoren (LPCVD - engl.:
Low Pressure Chemical Vapor Deposition) heute zu den meist verbreiteten
CVD-Anlagen. Ihr Druckbereich liegt zwischen 20 und 100  .
.
Ausführungsformen von CVD-Reaktoren unterscheiden sich durch die Art der Heizung, die Art der Gaszuführung und die Anordnung der Halbleiterscheiben. Abbildung 4.8 zeigt einen weit verbreiteten Reaktortyp. Die Heizung der Siliziumscheiben erfolgt über eine Heizwicklung oder Heizlampen. Sofern die Reaktorwände nicht eigens gekühlt werden, findet auch eine Schichtabscheidung auf der Reaktorwand statt.



