6.3 Untersuchung der Stufenbedeckung bei Sputter-Depositionen




Next: 6.4 Strukturierung und Beschichtung
Up: 6 Anwendungen
Previous: 6.2 Plasmaunterstütztes Ätzen tiefer
Da reale Halbleiterscheiben topographisch stark strukturiert sind, ist
die Beschichtung von Kanten ein wesentliches Kriterium für die Qualität
der Beschichtung. Diese Stufenbedeckung wird definiert als das Verhältnis
aus minimaler Dicke an Stufen zur mittleren Dicken auf ebenen Flächen und
liegt üblicherweise bei ungefähr 50 Prozent. Die folgenden Simulationen
untersuchen die Stufenbedeckung anhand idealer nichtplanarer Strukturen und
zeigen den Einfluß der Winkelverteilung einfallender Teilchen auf das
Resultat der Beschichtung. Anhand der Ergebnisse wird ersichtlich, daß die
Untersuchung dieses Problems eine dreidimensionale Simulation voraussetzt,
da minimale Beschichtungsdicken vor allem in den Ecken der Geometrien
erreicht werden.
Abbildung 6.8 zeigt das Resultat der Beschichtung, wenn für die
Verteilungsfunktion  vorgegeben wird. Die
Depositionsrate beträgt
vorgegeben wird. Die
Depositionsrate beträgt  bei
bei  Depositionszeit.
Die resultierende Depositionsrate an einem Oberflächenpunkt setzt sich aus
Flußbeiträgen zusammen, die über den geltenden Sichtbarkeitsbereiches
dieses Punktes an die zu beschichtende Oberfläche gelangen. Der deponierte
Film wächst an der Oberseite der Geometrie daher entsprechend der
vorgegebenen Depositionsrate, an tieferen Stellen entsprechend dem
sichtbaren Raumwinkel. Die vorgegebene Verteilungsfunktion führt bei der
gezeigten Geometrie zu guter Stufenbedeckung und zu einer akzeptablen
Konformität der deponierten Materialschicht.
Depositionszeit.
Die resultierende Depositionsrate an einem Oberflächenpunkt setzt sich aus
Flußbeiträgen zusammen, die über den geltenden Sichtbarkeitsbereiches
dieses Punktes an die zu beschichtende Oberfläche gelangen. Der deponierte
Film wächst an der Oberseite der Geometrie daher entsprechend der
vorgegebenen Depositionsrate, an tieferen Stellen entsprechend dem
sichtbaren Raumwinkel. Die vorgegebene Verteilungsfunktion führt bei der
gezeigten Geometrie zu guter Stufenbedeckung und zu einer akzeptablen
Konformität der deponierten Materialschicht.
Abbildung 6.9 zeigt das Ergebnis der Sputter-Deposition, wenn
für die Verteilungsfunktion  vorgegeben wird. Durch die stärkere Anisotropie der
Verteilungsfunktion verschlechtert sich die Stufenbedeckung der
Beschichtung. Am Boden der Geometrie erhält man die gleiche Depositionsrate
wie an der Oberseite der Geometrie, an den Seitenwänden sinkt die Dicke
des deponierten Filmes aufgrund der auftretenden Schattierung jedoch stark.
vorgegeben wird. Durch die stärkere Anisotropie der
Verteilungsfunktion verschlechtert sich die Stufenbedeckung der
Beschichtung. Am Boden der Geometrie erhält man die gleiche Depositionsrate
wie an der Oberseite der Geometrie, an den Seitenwänden sinkt die Dicke
des deponierten Filmes aufgrund der auftretenden Schattierung jedoch stark.
Welche Verteilungsfunktion für die Simulation anzuwenden ist, hängt von
den Prozeßparametern der Sputter-Anlage und deren Geometrie ab.
Abhängig von der Winkelverteilung einfallender Teilchen und der
vorgegebenen zu beschichtenden Geometrie kann es während der Deposition zu
der Ausbildung eines Vakuumeinschlusses (engl.: void) kommen
(Abbildung 6.10). Die Form dieses Einschlusses ist von großem
Interessse, denn sie ist wieder ein Maß für die erzielte Stufenbedeckung
der Beschichtung. Vakuumeinschlüsse können in nachfolgenden
Planarisierungsschritten unabsichtlich wieder geöffnet werden, wodurch
dann an Stellen geätzt wird, an denen es nicht erwünscht ist.

Abbildung 6.8: Sputter-Deposition bei vorgegebener Verteilungsfunktion
 .
.

Abbildung 6.9: Sputter-Deposition bei vorgegebener Verteilungsfunktion
 .
.
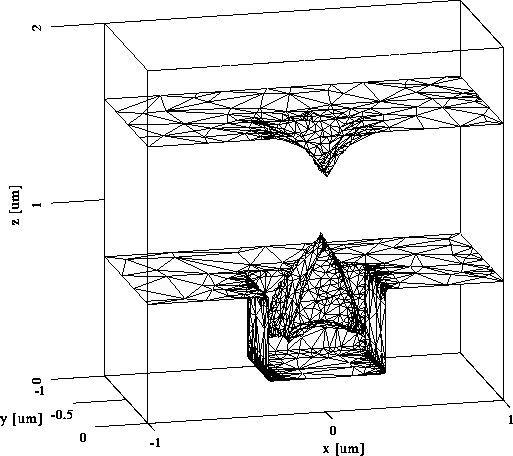
Abbildung 6.10: Die Ausbildung eines Vakuumeinschlusses während
der Beschichtung.
Abbildung 6.10 zeigt eine Beschichtung bei isotroper
Verteilungsfunktion einfallender Teilchen. Die Depositionsrate beträgt  bei
bei  Depositionszeit.
Depositionszeit.
Die Simulation dieses Problems bringt für die meisten heute verfügbaren
Simulatoren große Schwierigkeiten mit sich. Die Simulatoren verfolgen im
allgemeinen das Ziel, solche Bereiche aus der Geometrie zu entfernen, denn
in den meisten Fällen handelt es sich dabei um Oberflächen-Loops, die als
negative Begleiterscheinung bei der Bewegung der Oberfläche auftreten. Das
Problem besteht nun darin, zu entscheiden, welche der Gebiete physikalisch
korrekt sind und daher im Simulationsgebiet verbleiben sollen und welche
nicht.
Für die hier gezeigten Beipiele wurden  Zellen
für die Materialbeschreibung verwendet, die
Simulationszeiten lagen zwischen 30 und 90 Minuten auf einem HP 9000/755
Arbeitsplatzrechner.
Zellen
für die Materialbeschreibung verwendet, die
Simulationszeiten lagen zwischen 30 und 90 Minuten auf einem HP 9000/755
Arbeitsplatzrechner.




Next: 6.4 Strukturierung und Beschichtung
Up: 6 Anwendungen
Previous: 6.2 Plasmaunterstütztes Ätzen tiefer
Martin Stiftinger
Thu Nov 24 17:41:25 MET 1994
 vorgegeben wird. Die
Depositionsrate beträgt
vorgegeben wird. Die
Depositionsrate beträgt  bei
bei  Depositionszeit.
Die resultierende Depositionsrate an einem Oberflächenpunkt setzt sich aus
Flußbeiträgen zusammen, die über den geltenden Sichtbarkeitsbereiches
dieses Punktes an die zu beschichtende Oberfläche gelangen. Der deponierte
Film wächst an der Oberseite der Geometrie daher entsprechend der
vorgegebenen Depositionsrate, an tieferen Stellen entsprechend dem
sichtbaren Raumwinkel. Die vorgegebene Verteilungsfunktion führt bei der
gezeigten Geometrie zu guter Stufenbedeckung und zu einer akzeptablen
Konformität der deponierten Materialschicht.
Depositionszeit.
Die resultierende Depositionsrate an einem Oberflächenpunkt setzt sich aus
Flußbeiträgen zusammen, die über den geltenden Sichtbarkeitsbereiches
dieses Punktes an die zu beschichtende Oberfläche gelangen. Der deponierte
Film wächst an der Oberseite der Geometrie daher entsprechend der
vorgegebenen Depositionsrate, an tieferen Stellen entsprechend dem
sichtbaren Raumwinkel. Die vorgegebene Verteilungsfunktion führt bei der
gezeigten Geometrie zu guter Stufenbedeckung und zu einer akzeptablen
Konformität der deponierten Materialschicht.




 vorgegeben wird. Durch die stärkere Anisotropie der
Verteilungsfunktion verschlechtert sich die Stufenbedeckung der
Beschichtung. Am Boden der Geometrie erhält man die gleiche Depositionsrate
wie an der Oberseite der Geometrie, an den Seitenwänden sinkt die Dicke
des deponierten Filmes aufgrund der auftretenden Schattierung jedoch stark.
vorgegeben wird. Durch die stärkere Anisotropie der
Verteilungsfunktion verschlechtert sich die Stufenbedeckung der
Beschichtung. Am Boden der Geometrie erhält man die gleiche Depositionsrate
wie an der Oberseite der Geometrie, an den Seitenwänden sinkt die Dicke
des deponierten Filmes aufgrund der auftretenden Schattierung jedoch stark.


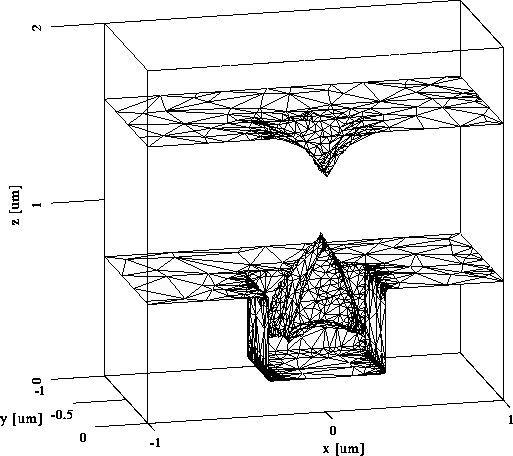
 Depositionszeit.
Depositionszeit.
 Zellen
für die Materialbeschreibung verwendet, die
Simulationszeiten lagen zwischen 30 und 90 Minuten auf einem HP 9000/755
Arbeitsplatzrechner.
Zellen
für die Materialbeschreibung verwendet, die
Simulationszeiten lagen zwischen 30 und 90 Minuten auf einem HP 9000/755
Arbeitsplatzrechner.