
In Kapitel 5 wurde gezeigt, daß es eine Reihe von Bauelementparametern gibt, die aufgrund des technologischen Herstellungsverfahren als Fitparameter in Frage kommen. Dies sind im wesentlichen die lateralen Parameter der Oberflächenstruktur des Bauelements, die durch Ätzprozesse beeinflußt werden - wie die Gatelänge, die Recesslänge, etc. - aber auch vertikale Parameter, wie der Gate-Kanal Abstand (s. hierzu 5.1.1). Schichtdicken im Inneren des Bauelements sind geringeren Schwankungen unterworfen, da die MBE in der Lage ist, die epitaktische Struktur nahezu mit Atomlagengenauigkeit zu erzeugen. Aber auch innerhalb der Schichten gibt es Parameter, die Schwankungen unterworfen sind und damit einen Einfluß auf das Verhalten des Bauelementes haben. Neben der Dotierstoffdichte ND ist dabei der Al-Gehalt einer AlxGa1-xAs-Schicht zu nennen. Selbst eine geringfügige Abweichung dieses Parameters vom nominellen Wert kann von großer Bedeutung sein, wenn es sich bei der betrachteten Schicht um eine dotierte AlxGa1-xAs-Schicht handelt. In diesem Fall kann eine geringe Erhöhung des Al-Gehalts eine starke Zunahme von tiefen Störstellen, den DX-Zentren, bedeuten.
Das in Abschnitt 3.4. vorgestellte und im Rahmen dieser Arbeit in MINIMOS NT implementierte Generations-/Rekombinationsmodell berücksichtigt die Änderung des Anteils der DX-Zentren an der gesamten Dotierstoffkonzentration nach den Ergebnissen von SCHUBERT und PLOOG. Danach steigt die Konzentration der DX-Zentren oberhalb eines Al-Gehalts von 20% in einer dotierten AlxGa1-xAs-Schicht exponentiell an (Abb. 3.2). Die im Rahmen dieser Arbeit betrachteten Bauelemente besitzen in allen AlxGa1-xAs-Schichten nominell einen Al-Anteil von x = 0.2. Der Anteil an DX-Zentren sollte demnach nur ca. 1.5% der gesamten Dotierstoffkonzentration betragen. Ist jedoch der wahre Al-Gehalt nur geringfügig höher als der vorgegebene nominelle Wert, dann steigt die Konzentration an DX-Zentren sprunghaft an. Für x = 0.21 ergibt sich bereits ein Anteil von DX-Zentren von ca. 13%.
Allerdings genügt bereits der geringe Anteil an DX-Zentren von 1.5% der gesamten Dotierstoffkonzentration, um bei höheren Gatespannungen in der Drainstrom Charakteristik ein Sättigungsverhalten zu induzieren. Für negative Gatespannung sind die DX-Zentren unterhalb des Gates vollständig ionisiert (Abb. 6.17).

Wird die Gatespannung erhöht, so ändert sich die Dichte der ionisierten DX-Zentren zunächst nur wenig. Erst wenn das Donatorniveau der DX-Zentren in den Bereich des FERMI-Niveaus absinkt, überwiegt der Elektroneneinfang aus dem Leitungsband die Ladungsträgergeneration und die Konzentration der ionisierten DX-Zentren sinkt (Abb.6.18).

Durch die ionisierten DX-Zentren ändert sich jedoch die Raumladungszone unter dem Gate und der Verlauf der Leitungsbandkante unter dem Gate wird flacher, so daß das Ladungskontrollverhalten verschlechtert wird, was sich als Sättigungsverhalten in der Drainstromcharakteristik bemerkbar macht. Mit der Zunahme des Al-Gehalts einer dotierten AlxGa1-xAs-Schicht und der damit verbundenen Zunahme des Anteils an DX-Zentren, verstärkt sich auch das Sättigungsverhalten (Abb.6.19).
Insgesamt beeinflußt eine hohe Dichte von DX-Zentren auch das Hochfrequenzverhalten des Bauelements negativ, da sich das Einfangen und Abgeben von Ladungsträgern bei tiefen Störstellen auf einer wesentlich größeren Zeitskala abspielt. Eingefangene Ladungsträger werden daher von den DX-Zentren wie in einer Falle festgehalten. Diesem Umstand verdanken die DX-Zentren auch ihre Bezeichnung als deep traps.
Tiefe Störstellen werden für eine Reihe von Anomalien in HFETs verantwortlich gemacht. Neben der Sättigung des Drainstroms (bei steigendem VGS) sind dies vor allem Verschiebungen der Thresholdspannung [28] oder der sogenannte Kinkeffekt [144]. Bei letzterem handelt es sich um eine intensive Ladungsträgergeneration aus besetzten tiefen Störstellen, die zu einem Anstieg des Drainstroms bei Erhöhung der Drainspannung führt. Ein gutes Beispiel dafür ist das Ausgangskennlinienfeld des P-01 (Abb. 6.8). Trotz Einführung des Generations-/Rekombinationsmodells für tiefe Störstellen konnte dieses Verhalten in der Simulation bislang jedoch nicht beobachtet werden, da die Generation von Ladungsträgern in der Simulation zu gering ist, um einen solchen Effekt zu erzeugen.
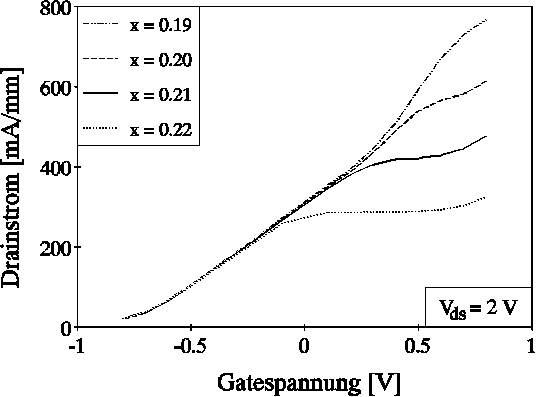
Abbildung 6.19: Transferkennlinie des LN-16, simuliert mit MINIMOS NT für verschiedene Al-Konzentrationen der dotierten AlxGa1-xAs Supplyschicht.