
Auch für den Leistungstransistor P-01 ist es nicht gelungen eine gute Übereinstimmung der Simulation an die Messung zu erzielen. Die Transferkennlinie ist ähnlich wie beim LN-19 in der Simulation zu negativen Gatespannungen hin verschoben (Abb. 6.27).

Abbildung 6.27: Vergleich der simulierten Transferkennlinie (durchgezogene Linie) und der Steilheit (gestrichelte Linie) des P-01 bei VDS = 2 V mit den gemessenen Werten (geschlossene bzw. offene Kreise).
Das Steilheitsmaximum tritt dagegen bei Simulation und Messung bei derselben Gatespannung auf. Allerdings zeigt die simulierte Steilheit einen wesentlich flacheren Verlauf als die Messung und bleibt über den gesamten Bereich auf einem hohen Niveau. Auch hier kann für den flachen Verlauf der Steilheit in der Simulation bei negativen Gatespannungen eine Überbewertung des Bufferstroms, der sich aufgrund der Rückseitendotierung ergibt, als Ursache angegeben werden.
Aufgrund der Verschiebung der Transferkennlinie stimmt auch beim P-01 das Ausgangskennlinienfeld (Abb.6.28) nicht mit der Messung überein.
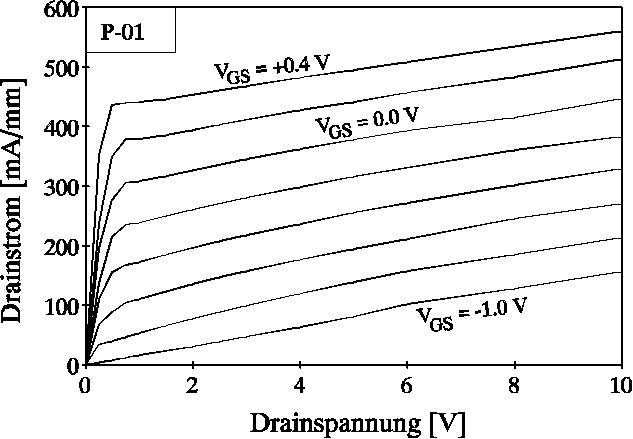
Abbildung 6.28: Simuliertes Ausgangskennlinienfeld für den P-01. Gatespannung: -1.0 V VGS +0.4 V, Schrittweite: DVGS = 0.2 V.
Im Gegensatz zur Messung bleibt der Ausgangsleitwert hier permanent auf einem hohen Niveau. Auch hier zeigt die Kontaktierung des Kanals einen zu geringen Kontaktwiderstand (ohmscher Bereich), während der Ausgangsleitwert zu groß ist. Ein Kink ist hier im Gegensatz zur Messung ebenfalls nicht zu beobachten. Die Aktivierung von Ladungsträgern aus der Rückseitendotierung ist in der Simulation zu gering, um einen sichtbaren Effekt zu bewirken.
Abbildung 6.29 zeigt auch für den P-01 unterhalb des Kanals - der den Hauptanteil des Stroms führt - eine nicht zu vernachlässigende Komponente der Stromdichte, die sehr weit in den Buffer hineinreicht.
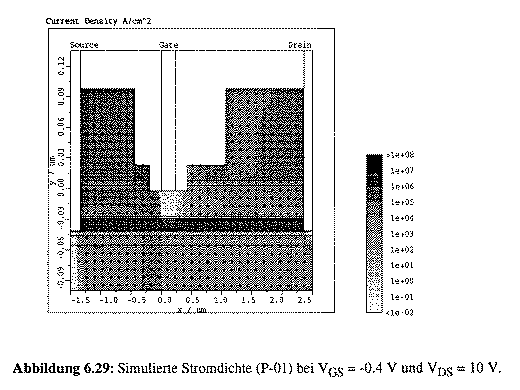
Bei Betrachtung der Ladungsträgerkonzentration bei gleichen Spannungsverhältnissen ist ebenfalls eine erhöhte Dichte im Bereich des Buffers festzustellen (Abb. 6.30). Bei der hohen Drainspannung (VDS = 10 V) reicht eine Gatespannung von VGS = -0.4 V vollkommen aus um die Supplyschicht unterhalb des Gates weitestgehend von freien Ladungsträgern zu verarmen. Die Verarmungszone reicht sogar bis in den Kanal hinein, womit der hohe Strom (s.a. Abb. 6.28) wiederum nur durch einen verstärkten Bufferstrom zu erklären ist. In Abbildung 6.30 ist weiterhin erkennbar, daß die verminderte Capschicht nahe des Gate auf der Drainseite ebenfalls bereits geringfügig von Ladungsträgern befreit ist. Dies unterstreicht, daß eine sehr dünne Capschicht durchaus von Ladungsträgern verarmt sein kann, was im realen Bauelement zur Verschlechterung der Kontaktwiderstände führt (vgl. Kapitel 5, Abschnitt 5.2.2, D.), wenn stromführende Bereiche von der Verarmung beeinflußt werden.

Das 'Ausräumen' der Capschicht verstärkt sich bei zunehmender
Gatespannung weiter, nimmt aber beim P-01 noch kein kritisches
Ausmaß an (Abb. 6.31). Auch bei VGS = +0.8 V kann noch kein
parasitärer Kanal im dotierten AlxGa1-xAs beobachtet werden.
Die Transferkennlinie wird daher fast vollständig durch Modulation
der Ladungsträger im
InyGa1-yAs-Kanal bestimmt. Auffallend ist auch eine verringerte
Ladungsträgerkonzentration innerhalb des Buffers in der Nähe
des Drainkontaktes. Dies deutet auf eine Verlagerung des Stromflusses
auf die oberen Bereiche des Bauelements hin - also auf eine erhöhte
Stromdichte in der Supplyschicht zwischen Gate und Drain. In Abbildung
6.32 kann dieser Sachverhalt auch festgestellt werden. Gegenüber
Abbildung 6.29 ist die Stromdichte im Bereich der Supplyschicht
erhöht, während sie in der Bufferschicht auf der Drainseite
deutlich erniedrigt ist.
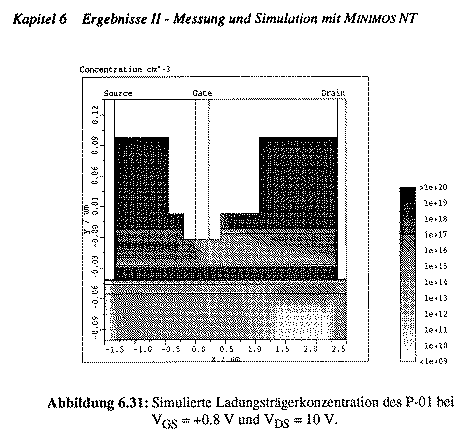

Bei der Simulation des P-01 wurde eine Oberflächenladungsdichte von NSS = 1.51012 cm-2 berücksichtigt, sowie auch die Generation und Rekombination über tiefe Störstellen. Ohne DX-Zentren zeigt der P-01 in der Simulation keine Sättigung der Transferkennlinie. Bei Berücksichtigung von DX-Zentren in dotierten AlxGa1-xAs-Schichten durch das im Rahmen dieser Arbeit implementierte Generations-/Rekombinationsmodell, ist jedoch eine geringfügige Sättigung - wie auch in der Messung - in der Transferkennlinie zu beobachten. Ionisierte DX-Zentren spielen bei dem rückseitendotierten DH-HFET auch im Bereich der Rückseitendotierung eine Rolle. Abbildung 6.33 zeigt die Dichte der ionisierten tiefen Störstellen bei negativer Gatespannung. Unter dem Gate ist die Dichte ionisierter Störstellen besonders hoch. Dies entspricht den ionisierten DX-Zentren. Die schwachen Konzentrationen in den übrigen Schichten sind auf EL2-Störstellen zurückzuführen.

Bei Erhöhung der Gatespannung werden nun nicht nur die DX-Zentren direkt unter dem Gate von Ladungsträgern neutralisiert, sondern es ändert sich auch deutlich die Konzentration der ionisierten Störstellen in der dotierten Schicht unterhalb des InyGa1-yAs-Kanals (Abb. 6.34). Diese Ladungsträger, die von DX-Zentren auf der Rückseite des Kanals eingefangen wurden, können bei hohen Drainspannungen wieder freigesetzt werden und führen im realen Bauelement zu einer Erhöhung des Drainstroms und damit zu einem Kink im Ausgangskennlinienfeld. Dieses Verhalten ist in Abbildung 6.8 deutlich sichtbar, in der Simulation tritt es dagegen nicht auf (Abb. 6.28), da die Zahl der generierten Ladungsträger sich bei den hohen Stromdichten nicht bemerkbar macht.

Um die Darstellung der simulierten Kennlinien auch für den P-01 zu komplettieren, wird abschließend in Abbildung 6.35 die Transitfrequenz den Meßwerten gegenüber gestellt. Wie bereits beim LN-19 zeigt sich auch hier allenfalls in Bezug auf die Größenordnung und die Lage des Maximums der Kennlinie eine Übereinstimmung zwischen Simulation und Messung.
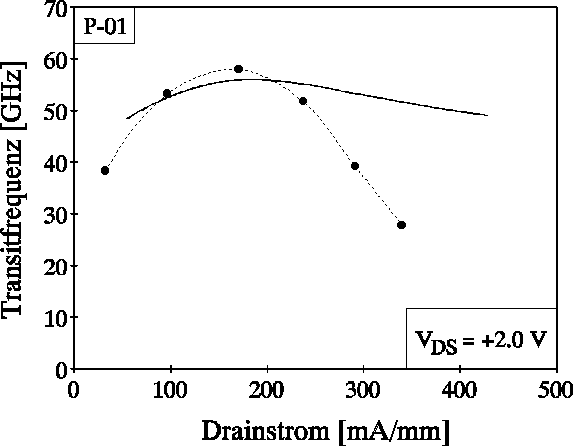
Abbildung 6.35: Simulierte (durchgezogene Linie) und gemessene (Symbole) Transitfrequenzen für den P-01 bei Vds = 2 V.
Die auch bei sehr positiven Gatespannungen extrem niedrigen Gateströme
(IG 2.510-8 mA/mm) deuten darauf hin, daß auch das implementierte
SCHOTTKY-Kontakt-modell nochmals überprüft und eventuell
eine größere Tunnelwahrscheinlichkeit berücksichtigt
werden sollte.