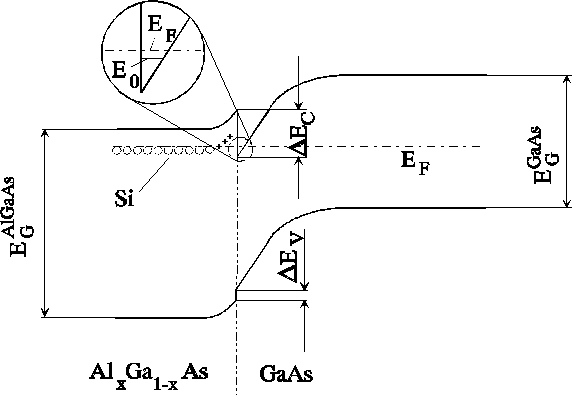
Das Ziel der vorliegenden Arbeit ist die Analyse moderner Transistoren auf der Basis von Elementen aus der III. und V. Hauptgruppe des Periodensystems, in denen der Stromtransport durch hochbewegliche Elektronen bestimmt wird. Die untersuchten Bauelemente sind unter der Bezeichnung HFET (Heterostructure FET), MODFET (MOdulation Doped FET) oder auch HEMT (High Electron Mobility Transistor) bekannt. Ganz allgemein sind Verbindungen aus Halbleitern der III. und V. Hauptgruppe in den vergangenen Jahren für die kommerzielle Bauelementfertigung immer bedeutender geworden. Die Variabilität dieser Bauelemente ist gegenüber den konventionellen Si-Bauelementen mit der Einführung moderner Epitaxieverfahren enorm gesteigert worden. Mit Hilfe der Molekularstrahlepitaxie (Molecular Beam Epitaxy, MBE) oder der metallorganischen Gasphasenepitaxie (Metal Organic Vapour Phase Epitaxy, MOVPE) können extrem dünne Schichten, bis zur atomaren Monolage, in nahezu jeder gewünschten Zusammensetzung und mit variablem Dotierungsprofil hergestellt werden. Damit werden einer zielgerichteten Entwicklung dieser Bauelemente sehr vielfältige Möglichkeiten geboten.
Eine zentrale Bedeutung bei der Bauelemententwicklung im Bereich der III-V-Halbleiter besitzen AlxGa1-xAs/GaAs-Strukturen. Feldeffekttransistoren (Field Effect Transistor, FET) auf der Basis MBE gewachsener Verbindungen dieses Typs eröffnen immer mehr Märkte, die bisher nicht durch Si-Bauelemente abgedeckt werden konnten. Dies gilt vor allem für die Bereiche der Hoch- und Höchstfrequenztechnik von 100 MHz bis 100 GHz. Anwendungsbeispiele sind Phased-Array-Radarsysteme (3-10 GHz), das Local Area Network (LAN, 18.5 GHz, bzw. 19.2 GHz), die Satellitenkommunikation (1.6-30 GHz), der Mobilfunk (Mobiltelefon: 0.9-1.8 GHz, Relais-Sender: 18-55 GHZ) oder die Verkehrsüberwachung (60-80 GHz) [74]. Neben dem MESFET (MEtal Semiconductor FET), dessen Anwendungsbereiche zunehmend von anderen Bauelementen übernommen werden, wird hier vor allem der HFET, aber auch der HBT (Hetero Bipolar Transistor) eingesetzt, dessen Kommerzialisierung jedoch aufgrund des komplizierten Herstellungsprozesses nur sehr langsam fortschreitet.
HFET und HBT sind Heterostrukturbauelemente. Ganz allgemein versteht man unter einem Heteroübergang die Kombination zweier unterschiedlicher Materialien, wie z.B. Metall-Halbleiterkontakte oder Halbleiter-Halbleiterübergänge. Das Energiebanddiagramm einer Heterostruktur (Abb. 1.1) ist wesentlich komplizierter, als das eines Dotierungsübergangs, wie beispielsweise eines pn-Übergangs.
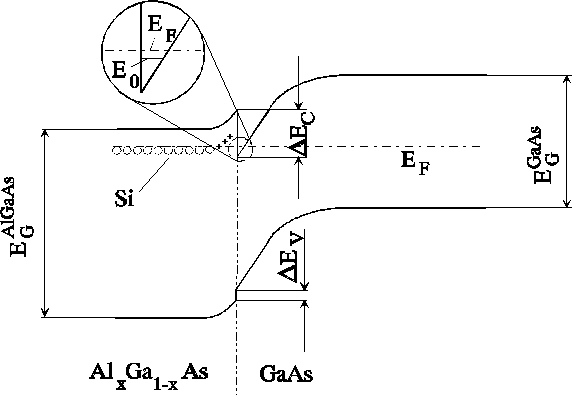
Abbildung 1.1: Leitungs- und Valenzbandkanten bei einem AlxGa1-xAs/GaAs-Heteroübergang. Aufgrund unterschiedlicher Energielücken und Austrittsarbeiten der beteiligten Halbleiter treten an der Grenzfläche einer Heterostruktur sowohl im Leitungsband, als auch im Valenzband Diskontinuitäten (DEC, DEV) auf. Bei geeigneter Materialkombination entsteht im Bereich der Leitungsbanddiskontinuität ein dreiecksförmiges Energieminimum (Potentialtopf), in dem es aufgrund der starken Lokalisierung zur Ausbildung quantisierter Energieniveaus kommt. Diese werden, mit dem niedrigsten beginnend, sukzessive aufgefüllt. Es entsteht ein quasi-zweidimensionales Elektronengas (Quasi 2-Dimensional Electron Gas, Q2DEG). Aufgrund der Besetzung sind im allgemeinen nur die ersten drei Energieniveaus für das Verhalten des Transistors relevant. Meist trägt bereits das energetisch niedrigste Energieniveau (E0) 50-90% der Ladungsträger des Q2DEG.
Die Idee der Heterostruktur, speziell die Verbindung zweier unterschiedlicher Halbleiter, wurde bereits Anfang der 60er Jahre von H. KRÖMER [78] entwickelt. Mit der ternär/binär-Verbindung AlxGa1-xAs/GaAs, die sich durch eine beinahe perfekte Gitteranpassung auszeichnet, war auch frühzeitig ein geeigneter Kandidat für eine mögliche Realisierung einer Heterostruktur gefunden. Allerdings wurden erst 1978 mit der Entwicklung von MBE und MOVPE entscheidende Fortschritte bei der Herstellung eines Heteroübergangs erzielt, der sich innerhalb weniger Atomlagen vollzieht. In den darauffolgenden Jahren verbesserte sich die Qualität insbesondere der MBE gewachsenen AlxGa1-xAs/GaAs-Heterostrukturen sehr schnell. Die erste Probe, an der in starken Magnetfeldern und bei tiefen Temperaturen SHUBNIKOV-DE HAAS-Oszillationen gemessen werden konnten, besaß nur eine Beweglichkeit von me = 5000 cm2/Vs (T = 4.2 K) [122]. Dieser Wert lag 1982 bereits bei über me = 106 cm2/Vs (T = 4.2 K) [64, 69]. Parallel dazu ermöglichte die zunehmende Probengüte die Beobachtung von Quanteneffekten des sich an der AlxGa1-xAs/GaAs-Grenzfläche ausbildenden Q2DEG. Nachdem K. V. KLITZING 1980 am Q2DEG in Si-MOSFETs (Metal Oxide Semiconductor FET) den quantisierten HALL-Effekt entdeckt hatte [77], konnte dieser 1981 auch an AlxGa1-xAs/GaAs-Heterostrukturen gemessen werden [135].
Die AlxGa1-xAs/GaAs-Heterostruktur besitzt gegenüber vielen anderen Halbleiter-Halbleiter-Heteroübergängen einen entscheidenden Vorzug, der letztendlich mitverantwortlich für die hohen erreichbaren Elektronenbeweglichkeiten ist: In der Mischkristallreihe vom GaAs zum AlAs läßt sich der Bandabstand zwischen Leitungs- und Valenzband über den Al-Gehalt variieren, ohne daß sich dabei die Gitterkonstante wesentlich verändert (Abb. 1.2). Daher ist es möglich, AlxGa1-xAs- und GaAs-Schichten sehr rein zu wachsen und die Grenzflächen aneinander grenzender Materialien nahezu versetzungsfrei herzustellen (lattice matched growth).
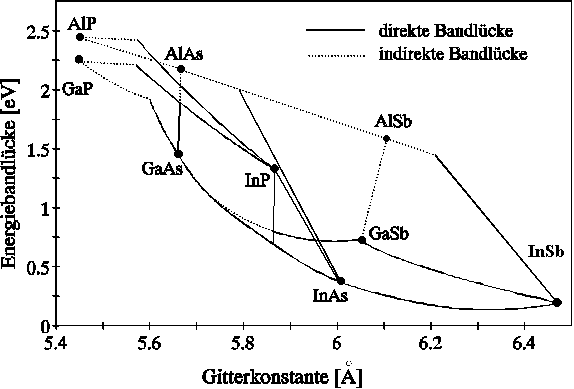
Abbildung 1.2: Bandabstand und Gitterkonstante einiger
III-V-Halbleiter
(nach [89]).
Dies ist nicht der Fall, wenn man versucht, ternäre Verbindungen
aus InyGa1-yAs mit GaAs oder AlxGa1-xAs zu kombinieren, um den
geringeren Bandabstand des InyGa1-yAs auszunutzen, der tiefere
Potentialtöpfe ermöglicht und so zu einem verbesserten
Einschluß der Ladungsträger führt. In der Mischkristallreihe
vom GaAs zum InAs ändert sich die Gitterkonstante mit zunehmendem
In-Gehalt sehr stark. Damit ergeben sich jedoch bei Heteroverbindungen
von GaAs und/oder AlxGa1-xAs mit InyGa1-yAs Gitterverspannungen,
die den maximalen In-Gehalt, bzw. die maximale Schichtdicke für
die Erzeugung homogener Grenzflächen technologisch begrenzen.
Unterhalb dieser technologischen Grenze kann
InyGa1-yAs nahezu versetzungsfrei auf GaAs, bzw. AlxGa1-xAs aufgewachsen
werden. Man spricht in diesem Fall von einer pseudomorphen Heterostruktur,
bzw. von fehlangepaßten (lattice mismatched growth)
oder verspannten Gittern (strained layers). Oberhalb der
kritischen Dicke kommt es an den Grenzflächen zu Versetzungen.
Die kritische Dicke Lc einer auf GaAs gewachsenen InyGa1-yAs-Schicht in Abhängigkeit des In-Gehalts kann mittels des mechanischen Gleichgewichtsmodells von MATTHEWS und BLAKESLEE [84] abgeschätzt werden (Abb. 1.3). Diese Abhängigkeit wurde 1987 von ANDERSSON et al. [11] experimentell verifiziert. Die in Abbildung 1.3 eingezeichneten Punkte stellen die am häufigsten verwendeten Schichtdicken in HFETs bei entsprechendem In-Gehalt dar (s.a. [92]). Bei einem In-Gehalt von y = 0.2 liegt danach die maximale Schichtdicke bei 12 nm.
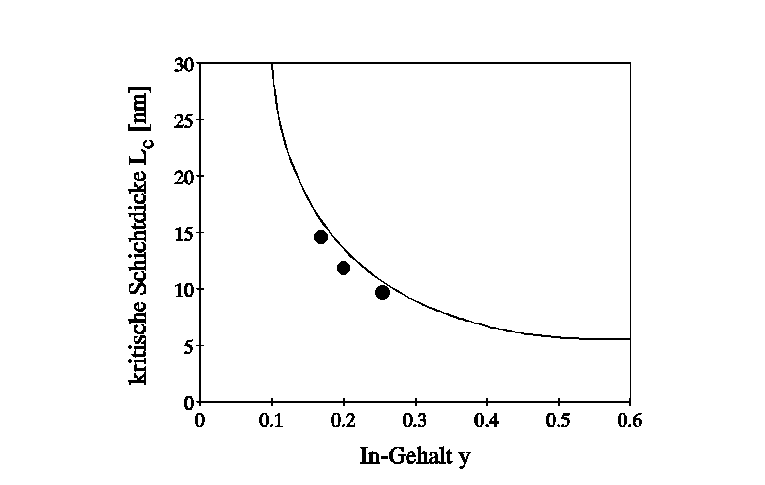
Abbildung 1.3: Abhängigkeit der kritischen InyGa1-yAs-Schichtdicke Lc (auf GaAs) vom In-Gehalt y (nach [11, 51, 83]).

Die elektrischen Eigenschaften (Performance) eines HFET werden jedoch nicht nur von seinem Schichtaufbau, sondern auch durch das Dotierungsprofil und die (laterale) Struktur (Layout) maßgeblich bestimmt. Die Zahl der Parameter, die seine Performance im Detail beeinflussen, ist bereits bei einfachen Bauelementen beträchtlich und nimmt mit zunehmender Entwicklung aufgrund der steigenden Komplexität der Strukturen weiter zu. Eine systematische Untersuchung der Einflüsse aller Parameter durch technologische Versuchsreihen ist daher schon allein aus Kostengründen nicht möglich. Ein leistungsfähiges Simulationsprogramm für Heterostrukturen kann eine meßtechnische Analyse von Technologievarianten zwar nicht vollständig ersetzen, aber die Entwicklungszeiten für neue Strukturen und den Materialverbrauch erheblich vermindern, indem es wertvolle Vorhersagen für die zu erwartenden Einflüsse von Strukturveränderungen auf die Bauelementeigenschaften macht.
Im Rahmen dieser Arbeit wurde das Verhalten von HFETs analysiert, um eine Basis von Daten und Parametern zu extrahieren, die der Entwicklung eines physikalischen Modells zur Simulation von Heterostrukturbauelementen dienen. Hierfür wurde hauptsächlich der zweidimensionale Bauelementsimulator MINIMOS NT verwendet, der von DR. C. FISCHER am Institut für Mikroelektronik der Technischen Universität Wien, das unter der Leitung von Prof. S. SELBERHERR steht, entwickelt wurde. In Zusammenarbeit mit Kollegen des Instituts für Mikroelektronik der TU Wien wurden physikalische Modelle für GaAs, AlxGa1-xAs und InyGa1-yAs entwickelt und in MINIMOS NT implementiert.
Die in diesem Kapitel beschriebenen Materialien GaAs, AlxGa1-xAs und InyGa1-yAs bilden die Grundlage aller im folgenden analysierten Bauelemente. Das folgende Kapitel beschreibt den Aufbau und die Funktionsweise von HFETs, sowie die Herstellung und ihre Vorteile gegenüber anderen Bauelementen. Kapitel 3 stellt die Grundlegenden physikalischen Gleichungen und Modelle für die Simulation vor und Kapitel 4 gibt einen Überblick über den entwickelten Simulator MINIMOS NT. Mit Hilfe verschiedener Simulationsverfahren werden im Kapitel 5 die Einflüsse einiger Parameter auf die elektrischen Eigenschaften eines HFET dargestellt und damit das Verhalten dieses Bauelements unter verschiedenen Konditionen erläutert. Die Analyse von HFETs erfolgt schließlich mittels der Gegenüberstellung von Meß- und Simulationsergebnissen in Kapitel 6. Die Ergebnisse werden in Kapitel 7 diskutiert und in Kapitel 8 wird ein Ausblick auf die Möglichkeiten der Verbesserung des entwickelten Simulators im Hinblick auf eine Optimierung und die künftigen Anforderungen gegeben.