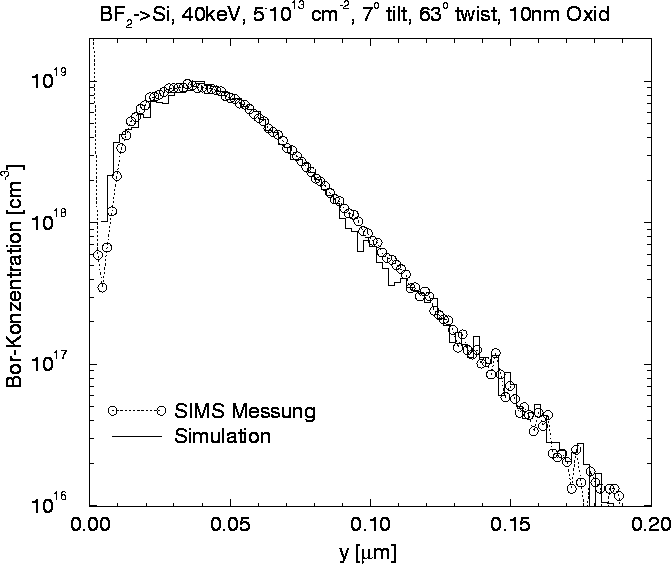
Abbildung 6.8: Vergleich des Simulationsergebnisses mit der
SIMS Messung. Die durchgezogene Linie repräsentiert das
Histogramm der Monte Carlo Simulation, die punktierte Linie und die Symbole
kennzeichnen die experimentellen Daten.
Auf Grund des atomaren Massenverhältnisses von Bor (11) zu ![]() (49) erhält das Bor-Ion bei einer 40keV-
(49) erhält das Bor-Ion bei einer 40keV-![]() -Implantation rund 9keV
an Energie. Dieses Verhältnis spiegelt sich auch in den Werten für die
mittlere Eindringtiefe
-Implantation rund 9keV
an Energie. Dieses Verhältnis spiegelt sich auch in den Werten für die
mittlere Eindringtiefe ![]() wieder (Abbildung 6.2:
wieder (Abbildung 6.2:
![]() 150nm, Abbildung 6.8:
150nm, Abbildung 6.8: ![]() 37nm). Allerdings
ist die Konzentration an Gitterschäden sowohl in vertikaler als auch in
lateraler Richtung höher als bei einer vergleichbaren
10keV-Bor-Implantation (vgl. Abbildungen 6.10 und
6.22). Diese zusätzlichen Punktdefekte werden
durch Fluor induziert.
37nm). Allerdings
ist die Konzentration an Gitterschäden sowohl in vertikaler als auch in
lateraler Richtung höher als bei einer vergleichbaren
10keV-Bor-Implantation (vgl. Abbildungen 6.10 und
6.22). Diese zusätzlichen Punktdefekte werden
durch Fluor induziert.

Abbildung 6.9: Simulation einer Punktantwort mit 40keV-![]() -Ionen
und die daraus resultierende Bor-Konzentration in [cm-3].
-Ionen
und die daraus resultierende Bor-Konzentration in [cm-3].

Abbildung 6.10: Simulation einer Punktantwort mit 40keV-![]() -Ionen
und die daraus resultierende Silizium-Interstitial-Konzentration in cm[-3].
-Ionen
und die daraus resultierende Silizium-Interstitial-Konzentration in cm[-3].