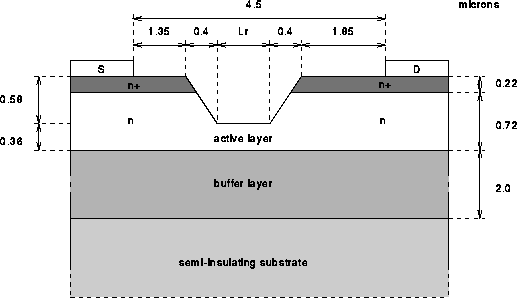
Abbildung 4.13: Aufbau und Geometrie des `ungated' MESFET




Um die in der Simulation verwendeten physikalischen Modelle zu überprüfen, und den Einfluß verschiedener Parameter und physikalischer Effekte auf das Verhalten des Bauelements zu demonstrieren, ist der `ungated' MESFET besonders geeignet. Dabei wird die Strom-Spannungskennlinie des MESFET vor dem Aufbringen eines Gatekontaktes gemessen. Im wesentlichen stellt ein `ungated' MESFET eine Widerstandsstrecke dar, die alle geometrischen Merkmale des MESFET aufweist, und anhand der sich die elektrischen Eigenschaften der aktiven Schicht in Verbindung mit dem Substrat gut charakterisieren lassen. Für die Simulation bietet diese Struktur die Möglichkeit, die Modelle für die Beweglichkeit, den Einfluß der Oberfläche und des Substrates zu überprüfen. Aus den Forschungslaboratorien von SIEMENS in München standen Meßwerte für einen `ungated' MESFET auf einem epitaktisch hergestellten Substrat zur Verfügung. Abb. 4.13 zeigt den Aufbau und die Geometrie des Bauelements.
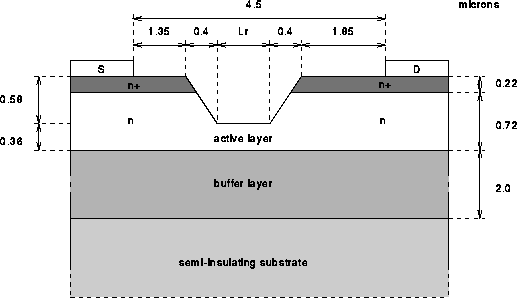
Abbildung 4.13: Aufbau und Geometrie des `ungated' MESFET
Das Bauelement ist aus drei Epi-Schichten auf einem semi-isolierenden Substrat
aufgebaut. An der Oberfläche befindet sich eine  dicke, hochdotierte
n-Schicht, die für eine gute ohmsche Kontaktierung von Source und Drain
sorgen soll. Die Dotierungskonzentration beträgt
dicke, hochdotierte
n-Schicht, die für eine gute ohmsche Kontaktierung von Source und Drain
sorgen soll. Die Dotierungskonzentration beträgt  .
Darunter befindet sich die aktive Schicht mit einer Dicke von
.
Darunter befindet sich die aktive Schicht mit einer Dicke von  und
einer Dotierungskonzentration von
und
einer Dotierungskonzentration von  . Zur Verbesserung
der Qualität der aktiven Schicht ist diese auf einen sogenannten `buffer
layer', der ebenfalls epitaktisch hergestellt wird, aufgewachsen.
Der `buffer layer' bewirkt die Relaxation der an der Oberfläche des
semi-isolierenden Substrats vorhandenen Gitterdefekte (vgl. Kap.
2.2.3). Das Bauelement besitzt einen `recess', d.h. zwischen Source
und Drain wurde eine Vertiefung geätzt, in der später der Gatekontakt
aufgebracht wird. Mit der Tiefe des `recesses' kann der Sättigungsstrom des
Bauelements bei offenem Kanal sehr genau eingestellt werden. Die Dicke der
aktiven Schicht im Kanalbereich beträgt hier
. Zur Verbesserung
der Qualität der aktiven Schicht ist diese auf einen sogenannten `buffer
layer', der ebenfalls epitaktisch hergestellt wird, aufgewachsen.
Der `buffer layer' bewirkt die Relaxation der an der Oberfläche des
semi-isolierenden Substrats vorhandenen Gitterdefekte (vgl. Kap.
2.2.3). Das Bauelement besitzt einen `recess', d.h. zwischen Source
und Drain wurde eine Vertiefung geätzt, in der später der Gatekontakt
aufgebracht wird. Mit der Tiefe des `recesses' kann der Sättigungsstrom des
Bauelements bei offenem Kanal sehr genau eingestellt werden. Die Dicke der
aktiven Schicht im Kanalbereich beträgt hier  , die Länge des
`recess'
, die Länge des
`recess'  beträgt
beträgt  . Als Passivierung der Oberfläche zwischen den
Kontakten wurde Siliziumnitrid mit einer relativen Dieelektizitätskonstante von
. Als Passivierung der Oberfläche zwischen den
Kontakten wurde Siliziumnitrid mit einer relativen Dieelektizitätskonstante von
 angenommen.
angenommen.
MESFETs auf epitaktischen Substraten haben
den Vorteil, daß aufgrund des Aufbaus, die Dotierungsprofile
der überanderliegenden Schichten schärfer begrenzt und im allgemeinen besser
bekannt sind. Das erleichtert den Vergleich von Messung und Simulation, da die
genaue Kenntnis des Dotierungsprofils dabei ein entscheidender Faktor ist.
Allerdings ist der Sättigungsstrom des zur Verfügung stehenden
MESFET mit ca.  bei
bei  Gateweite relativ hoch, und der Einfluß der
Kontakt- und der Meßwiderstände auf die Strom-Spannungskennlinie kann nicht
mehr vernachlässigt werden. Außerdem ist an der Kennlinie die durch die hohe
Verlustleistung auftretende Erwärmung des Bauelements zu erkennen. Bei
zunehmender Drainspannung sinkt der Strom aufgrund der Temperaturabhängigkeit
der Beweglichkeit wieder. Der Einfluß der Serienwiderstände kann in der
Simulation berücksichtigt werden, der Wert dieser Widerstände ist allerdings
nicht ganz genau bekannt. Die Summe aller Serienwiderstände wurde mit
Gateweite relativ hoch, und der Einfluß der
Kontakt- und der Meßwiderstände auf die Strom-Spannungskennlinie kann nicht
mehr vernachlässigt werden. Außerdem ist an der Kennlinie die durch die hohe
Verlustleistung auftretende Erwärmung des Bauelements zu erkennen. Bei
zunehmender Drainspannung sinkt der Strom aufgrund der Temperaturabhängigkeit
der Beweglichkeit wieder. Der Einfluß der Serienwiderstände kann in der
Simulation berücksichtigt werden, der Wert dieser Widerstände ist allerdings
nicht ganz genau bekannt. Die Summe aller Serienwiderstände wurde mit  angegeben. Der Einfluß der Erwärmung des Bauelements während
der Messung kann allerdings nicht berücksichtigt werden.
angegeben. Der Einfluß der Erwärmung des Bauelements während
der Messung kann allerdings nicht berücksichtigt werden.
Abb. 4.14 zeigt die Strom-Spannungskennlinie des Bauelements. Sie wurde an vier verschiedenen Stellen auf dem Wafer gemessen. Mit Ausnahme eines Ausreißers streuen die Messungen um etwa 5%.
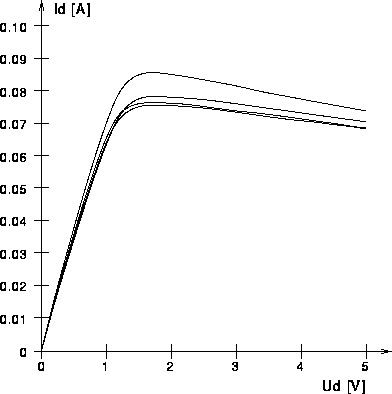
Abbildung 4.14: Gemessene Ausgangskennlinien des `ungated' MESFET
Um eine Übereinstimmung der Simulation mit den Meßergebnissen zu erhalten, wird zuerst der Einfluß folgender physikalischer Effekte und Parameter auf die Ausgangskennlinie untersucht:
 tiefer
als im darunterliegenden Halbleiter. Der Einfluß der Oberflächenzustände kann
in der Simulation durch die Einführung von festen Oberflächenladungen an der
Grenzfläche berücksichtigt werden. Die Konzentration der
Oberflächenladungen, die benötigt wird, um eine Reduktion des
Oberflächenpotentials um etwa
tiefer
als im darunterliegenden Halbleiter. Der Einfluß der Oberflächenzustände kann
in der Simulation durch die Einführung von festen Oberflächenladungen an der
Grenzfläche berücksichtigt werden. Die Konzentration der
Oberflächenladungen, die benötigt wird, um eine Reduktion des
Oberflächenpotentials um etwa  zu erzielen, ist natürlich
dotierungsabhängig. Da aber die Dotierung an der Oberfläche in den meisten
Fällen konstant ist, kann dieser Wert einmal ermittelt und dann an der gesamten
Oberfläche verwendet werden. Bei stark inhomogener Dotierung oder bei
transienten Simulationen müssen allerdings die Besetzung und die
Umladungsvorgänge der Oberflächenzustände zusätzlich berücksichtigt werden.
zu erzielen, ist natürlich
dotierungsabhängig. Da aber die Dotierung an der Oberfläche in den meisten
Fällen konstant ist, kann dieser Wert einmal ermittelt und dann an der gesamten
Oberfläche verwendet werden. Bei stark inhomogener Dotierung oder bei
transienten Simulationen müssen allerdings die Besetzung und die
Umladungsvorgänge der Oberflächenzustände zusätzlich berücksichtigt werden.
 sind dabei
von Interesse.
sind dabei
von Interesse.
Als Beweglichkeitsmodell für die Elektronen wird hier das reduzierte
Zweibandtransportmodell (vgl. 3.4.3) verwendet. Für die
Dotierungsabhängigkeit der Beweglichkeit wurden die Parameter nach Hilsum
[31] verwendet. Wenn nicht speziell darauf hingeweisen wird, ist das
verwendete Substrat mit  p-dotiert und eine
Oberflächenzustandsdichte von
p-dotiert und eine
Oberflächenzustandsdichte von  wird berücksichtigt.
Die `recess'-Länge beträgt
wird berücksichtigt.
Die `recess'-Länge beträgt  , und die Serienwiderstände werden
vernachlässigt.
In die Simulation einbezogen wurde nur der `buffer layer',
er wird im folgenden auch als Substrat bezeichnet.
, und die Serienwiderstände werden
vernachlässigt.
In die Simulation einbezogen wurde nur der `buffer layer',
er wird im folgenden auch als Substrat bezeichnet.
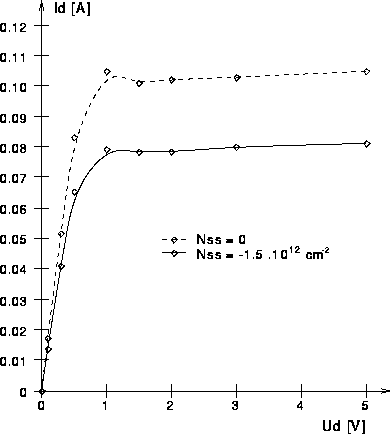
Abbildung 4.15: Einfluß der Oberflächenzustandsdichte:
 und
und 
Abb. 4.15 zeigt den starken Einfluß der Oberflächenzustände auf
die Ausgangskennlinie. Für die Oberflächenzustandsdichte wurde ein Wert von
 angenommen. Abb. 4.16 zeigt die Wirkung
auf die Potentialverteilung in einer Tiefe von
angenommen. Abb. 4.16 zeigt die Wirkung
auf die Potentialverteilung in einer Tiefe von  bis
bis  . Die
`recess'-Oberfläche befindet sich bei
. Die
`recess'-Oberfläche befindet sich bei  . Man erkennt, daß
das Potential an der Oberfläche um
. Man erkennt, daß
das Potential an der Oberfläche um  niedriger liegt als im Kanal. Der
wirksame Kanalquerschnitt wird um beinahe
niedriger liegt als im Kanal. Der
wirksame Kanalquerschnitt wird um beinahe  verringert.
verringert.

Abbildung: Potentialverteilung im `ungated' MESFET mit
Berücksichtigung der Oberflächenzustände 
Die Depletionszone an der Oberfläche muß also in der Simulation unbedingt berücksichtigt werden. Speziell in Betriebsfällen mit offenem Kanal ist diese Depletionszone der limitierende Faktor für den Sättigungsstrom.
Abb. 4.17 zeigt den Einfluß verschiedener Substrate.
Simuliert wurde das Bauelement mit einem n-Substrat mit  ,
einem p-Substrat mit
,
einem p-Substrat mit  und einem EL2-Substrat mit
und einem EL2-Substrat mit
 und
und  .
Wie schon in
Kap. 4.2 gezeigt wurde, wird durch das n-Substrat keine
Potentialbarriere gegen das Eindringen der Elektronen aufgebaut. Die
Stromleitung kann daher auch im Substrat erfolgen, der Sättigungsstrom liegt
beinahe um die Hälfte höher. Im EL2-Substrat ist gegenüber dem p-Substrat
die Potentialbarriere einerseits durch die geringere Akzeptorenkonzentration,
andererseits durch die Kompensationseffekte der EL2 Störstellen geringer.
Der Ausgangsstrom liegt daher auch etwas höher.
.
Wie schon in
Kap. 4.2 gezeigt wurde, wird durch das n-Substrat keine
Potentialbarriere gegen das Eindringen der Elektronen aufgebaut. Die
Stromleitung kann daher auch im Substrat erfolgen, der Sättigungsstrom liegt
beinahe um die Hälfte höher. Im EL2-Substrat ist gegenüber dem p-Substrat
die Potentialbarriere einerseits durch die geringere Akzeptorenkonzentration,
andererseits durch die Kompensationseffekte der EL2 Störstellen geringer.
Der Ausgangsstrom liegt daher auch etwas höher.
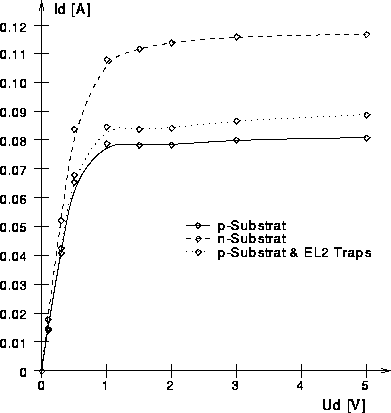
Abbildung: Einfluß des `buffer layer':
p-Substrat  ,
,
n-Substrat  ,
,
EL2-Substrat 
Abb. 4.18 zeigt den Einfluß der `recess'-Länge  auf die
Ausgangskennlinie. Man kann erkennen, daß die Länge der durch die
Oberflächenladungen erzeugten verarmten Zone einen starken Einfluß auf den
Widerstand der gesamten Halbleiterstrecke hat. Mit abnehmender Länge der
verarmten Zone im Kanalbereich wird der Leitwert im linearen Bereich größer,
und der Sättigungsstrom steigt.
auf die
Ausgangskennlinie. Man kann erkennen, daß die Länge der durch die
Oberflächenladungen erzeugten verarmten Zone einen starken Einfluß auf den
Widerstand der gesamten Halbleiterstrecke hat. Mit abnehmender Länge der
verarmten Zone im Kanalbereich wird der Leitwert im linearen Bereich größer,
und der Sättigungsstrom steigt.

Abbildung 4.18: Einfluß der `recess'-Länge:  ,
,  und
und

Abb. 4.19 zeigt den Einfluß des mit  angegebenen
Serienwiderstandes. Man erkennt hier die Auswirkung auf den Anstieg im linearen
Bereich.
angegebenen
Serienwiderstandes. Man erkennt hier die Auswirkung auf den Anstieg im linearen
Bereich.
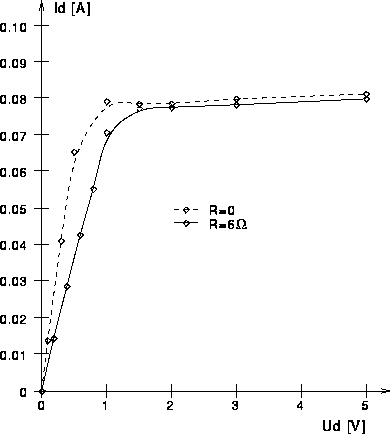
Abbildung 4.19: Einfluß der Serienwiderstände:  und
und 
Abb. 4.20 zeigt schließlich den Vergleich mit der Messung. Bei der Simulation wurden hier auch die Serienwiderstände berücksichtigt. Sowohl die Simulation mit dem reinen p-Substrat als auch die Simulation mit einem realistischeren EL2-Substrat zeigt sehr gute Übereinstimmung mit den gemessenen Daten, sieht man vom Einfluß der Erwärmung auf die gemessene Kennlinie ab.
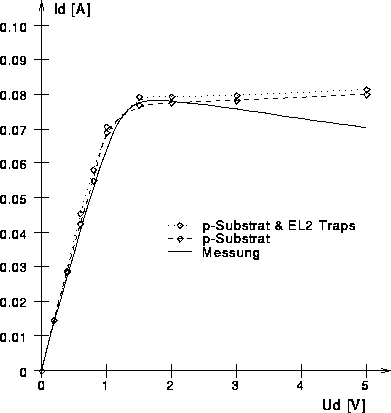
Abbildung 4.20: Vergleich Messung-Simulation mit zwei verschiedenen Substraten:
p-Substrat 
EL2-Substrat 
Diese Simulationen zeigen, daß sich nur durch eine Einbeziehung aller oben
beschriebenen physikalischen Effekte eine gute Übereinstimmung mit dem realen
Bauelement erzielen läßt. Darüberhinaus kann man davon ausgehen, daß die
Annahme einer Akzeptorkonzentration von  nicht ganz
unrealistisch ist. Die Änderungen, die sich durch Berücksichtigung
verschiedener EL2 Konzentrationen ergeben, liegen im Bereich der Streuung der
Meßwerte über den Wafer, und lassen daher keine Rückschlüsse auf die
tatsächliche EL2 Konzentration zu.
nicht ganz
unrealistisch ist. Die Änderungen, die sich durch Berücksichtigung
verschiedener EL2 Konzentrationen ergeben, liegen im Bereich der Streuung der
Meßwerte über den Wafer, und lassen daher keine Rückschlüsse auf die
tatsächliche EL2 Konzentration zu.



