
Abbildung 2.1: prinzipieller Aufbau eines MESFET




Der MESFET ist wie der Sperrschicht-FET ein unipolares Bauelement, in dem der Widerstand einer Halbleiterstrecke durch das elektrische Feld einer sogenannten Gateelektrode gesteuert werden kann. Der Ladungsträgertransport erfolgt im wesentlichen durch die im betrachteten Halbleitermaterial als Majoritätsträger vorhandenen Ladungsträger, d.h. Elektronen im n-Kanal und Löcher im p-Kanal Transistor. Ein MESFET besteht aus einem Halbleitersubstrat, auf dem drei Kontakte - Source, Gate und Drain - angebracht sind. Source und Drain werden durch ohmsche Kontakte mit möglichst geringem Kontaktwiderstand realisiert und bilden mit dem Halbleitersubstrat eine Widerstandsstrecke, deren Widerstand durch die Zusammensetzung des Halbleitermaterials bestimmt wird. Die Zusammensetzung des Halbleiters kann entweder durch selektive Dotierung oder durch eine bestimmte Schichtfolge (Epitaxie) erreicht werden. Wird nun zwischen Source und Drain ein gleichrichtender Kontakt (Schottkykontakt) aufgebracht, so entsteht unter diesem Kontakt im Halbleiter eine Verarmungszone, deren Ausdehnung durch die an diesem Kontakt angelegte Spannung gesteuert werden kann. Durch die Veränderung der Dicke der Verarmungszone wird auch der für den Stromfluß zur Verfügung stehende Querschnitt des Halbleitermaterials und damit dessen Widerstand verändert.

Abbildung 2.1: prinzipieller Aufbau eines MESFET
Abb. 2.1 zeigt den prinzipiellen Aufbau eines MESFET.
Die Struktur des Bauteils mit den drei Kontakten Source, Gate
und Drain auf der aktiven Schicht und die Form der Depletionszone (DPZ)
unter dem Gatekontakt sind klar zu erkennen.
Von der Dicke und Dotierung der aktiven Schicht hängt es nun ab, ob das
bei  durch
den Schottkykontakt im Halbleiter erzeugte elektrische
Feld ausreicht, den Kanal vollständig abzuschnüren oder nicht. Ist für
durch
den Schottkykontakt im Halbleiter erzeugte elektrische
Feld ausreicht, den Kanal vollständig abzuschnüren oder nicht. Ist für
 kein leitender Kanal vorhanden, so spricht man vom ``normally-off''
MESFETim Gegensatz zum ``normally-on'' MESFETbei dem bei
kein leitender Kanal vorhanden, so spricht man vom ``normally-off''
MESFETim Gegensatz zum ``normally-on'' MESFETbei dem bei  Strom fließt.
Durch Anlegen einer positiven Spannung an das Gate kann man nun den
``normally-off'' Transistor aufsteuern. Allerdings ist dabei die positive
Gatespannung durch die Barrierenhöhe des Schottkykontakts (
Strom fließt.
Durch Anlegen einer positiven Spannung an das Gate kann man nun den
``normally-off'' Transistor aufsteuern. Allerdings ist dabei die positive
Gatespannung durch die Barrierenhöhe des Schottkykontakts ( )
begrenzt, da für höhere Gatespannungen die Gatediode voll aufgesteuert wird
und die Transistorwirkung verloren geht.
Bei ``normally-on'' Typen kann durch Anlegen einer negativen Gatespannung die
Dicke des leitenden Kanals bis zur Abschnürung verringert werden.
)
begrenzt, da für höhere Gatespannungen die Gatediode voll aufgesteuert wird
und die Transistorwirkung verloren geht.
Bei ``normally-on'' Typen kann durch Anlegen einer negativen Gatespannung die
Dicke des leitenden Kanals bis zur Abschnürung verringert werden.
Der Stromtransport in einem MESFET soll nun anhand eines Beispiels erläutert werden. Dazu betrachten wir die Elektronenkonzentration in einem Silizium und einem GaAs MESFET.
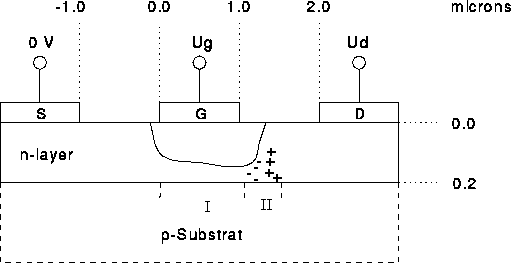
Abbildung 2.2: Aufbau und Geometrie des MESFET zur Erläuterung des Stromtransports
Der berechnete Transistor ist in Abb. 2.2
dargestellt. Er besteht aus einer konstant dotierten n-Schicht auf einem
p-Substrat. Die Störstellenkonzentration der n-Schicht beträgt
 , die des Substrates
, die des Substrates  . Die aktive Schicht ist
. Die aktive Schicht ist
 dick. Die Gatelänge beträgt so wie der Source-Gate- und der
Gate-Drain-Abstand
dick. Die Gatelänge beträgt so wie der Source-Gate- und der
Gate-Drain-Abstand  . Erhöht man die Drainspannung bei konstanter
Gatespannung, so steigt zunächst der Strom linear mit der Spannung an.
Die Abbildungen 2.3 und 2.4 zeigen die
Elektronenkonzentration bei
. Erhöht man die Drainspannung bei konstanter
Gatespannung, so steigt zunächst der Strom linear mit der Spannung an.
Die Abbildungen 2.3 und 2.4 zeigen die
Elektronenkonzentration bei  und
und  .
.

Abbildung 2.3: Elektronenkonzentration im Silizium MESFET  und
und 
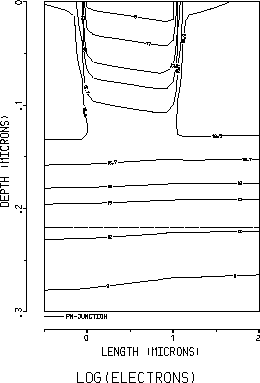
Abbildung 2.4: Elektronenkonzentration im GaAs MESFET  und
und 
Man sieht den leitenden Kanal, der sich zur Drainseite hin verengt.
Das Verhalten des Silizium- und des GaAs MESFET ist bei diesem Arbeitspunkt gleich.
Erhöht man die Drainspannung weiter, so erreichen die Elektronen im Bereich I
unter der Depletionszone die Sättigungsgeschwindigkeit und der Strom wird
begrenzt. Im Bereich II kommt es zu einer Abschnürung des Kanals. Dieses
Absinken der Elektronenkonzentration ist in Abb. 2.5, die den
Silizium MESFET bei  und
und  zeigt, deutlich zu erkennen.
zeigt, deutlich zu erkennen.
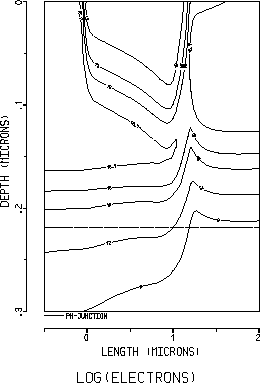
Abbildung 2.5: Elektronenkonzentration im Silizium MESFET  und
und 
Beim GaAs MESFET zeigt sich in diesem Arbeitspunkt eine zusätzliche Besonderheit. Aufgrund der speziellen Feldabhängigkeit der Driftgeschwindigkeit mit einem lokalen Maximum (vgl. Kap. 3.4) bildet sich im Bereich II eine lokale Dipolschicht aus Elektronen und einer schmalen Raumladungszone, eine sogenannte Domäne. Sie ist in den Abbildungen 2.6 und 2.7 deutlich an der Überhöhung der Elektronenkonzentration am drainseitigen Gateende zu erkennen. Die Domänenbildung kann zu spontaner Oszillation führen, wenn sich die Domäne unter dem Einfluß des elektrischen Feldes in Richtung Drain bewegt. Dieser Effekt wurde 1963 von Gunn experimentell entdeckt [23] und konnte mit der Theorie von Ridley und Watkins [69] und Hilsum [30] über den negativen differentiellen Widerstand ein Jahr später von Krömer [47] erklärt werden. Dieser Effekt wird in der Praxis zur Mikrowellenerzeugung in Gunndioden verwendet.
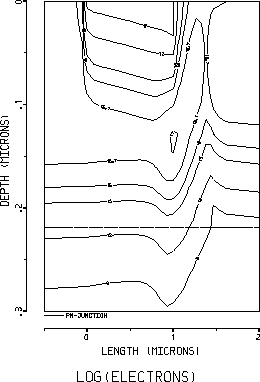
Abbildung 2.6: Elektronenkonzentration im GaAs MESFET  und
und 
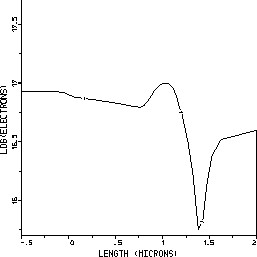
Abbildung: Schnitt durch die Domäne im GaAs MESFET 
Verringert man nun die Gatespannung, so kommt es zu einer Verengung bzw. einer
vollständigen Abschnürung des Kanals. Dieser Fall ist in den Abbildungen
2.8
und 2.9 bei  und
und  dargestellt. Hier zeigen die
beiden MESFETs wieder das gleiche Verhalten. Der Kanal ist vollständig
abgeschnürt, die Domäne des GaAs MESFET wurde abgebaut.
dargestellt. Hier zeigen die
beiden MESFETs wieder das gleiche Verhalten. Der Kanal ist vollständig
abgeschnürt, die Domäne des GaAs MESFET wurde abgebaut.
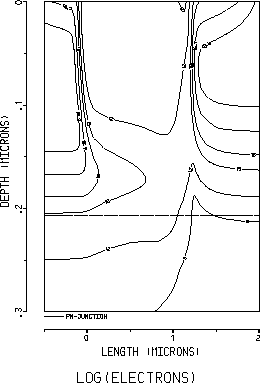
Abbildung 2.8: Elektronenkonzentration im Silizium MESFET  und
und 
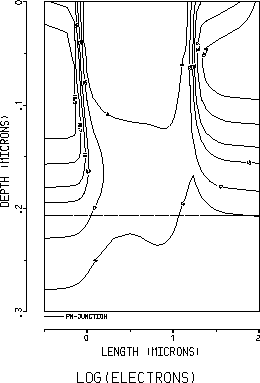
Abbildung 2.9: Elektronenkonzentration im GaAs MESFET  und
und 



