6.4 Optimiertes Drain-Profil




Next: 6.5 Fertigungsaspekte der LDD-Implantation
Up: 6 Unterdrückung heißer Ladungsträger
Previous: 6.3.3 Variation der LDD-Implantationsdosis
Als Resultat der vorangegangenen Überlegungen wurde die Festlegung
der Spacer-Länge auf  und der LDD-Implantation auf
und der LDD-Implantation auf
 als optimaler Kompromiß zwischen
Unterdrückung heißer Ladungsträger und hohem Sättigungs-Drainstrom
getroffen. Das zugehörige Gesamtdotierungsprofil als Isolinen
mit skizzierter Gate- und Spacer-Struktur zeigt Abb. 6.13,
die Drain-Seite in axonometrischer Darstellung Abb. 6.14.
als optimaler Kompromiß zwischen
Unterdrückung heißer Ladungsträger und hohem Sättigungs-Drainstrom
getroffen. Das zugehörige Gesamtdotierungsprofil als Isolinen
mit skizzierter Gate- und Spacer-Struktur zeigt Abb. 6.13,
die Drain-Seite in axonometrischer Darstellung Abb. 6.14.

Abbildung: Isolinien der Gesamtdotierungskonzentration [ ]
und schematische
Gate-Spacer-Struktur des optimierten LDD-
]
und schematische
Gate-Spacer-Struktur des optimierten LDD- -MOSFETs.
-MOSFETs.
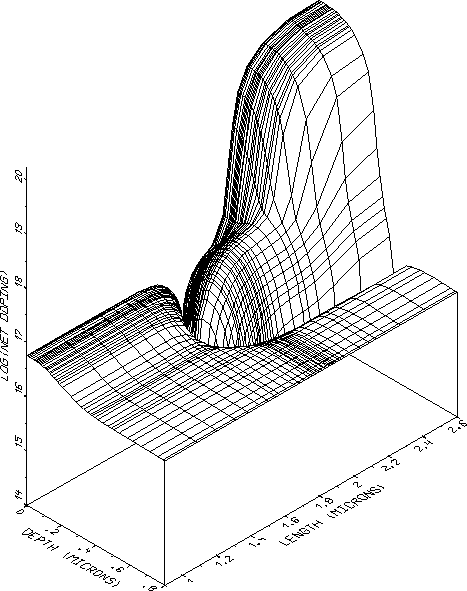
Abbildung: Gesamtdotierungskonzentration [ ]
der Drain-Seite des optimierten LDD-
]
der Drain-Seite des optimierten LDD- -MOSFETs.
-MOSFETs.
Die  -Zone der optimierten LDD-Struktur hat ihr Maximum tief im
Silizium und weicht an der Grenzfläche deutlich vor der Kanaldotierung
zurück. Aufgrund der mit
-Zone der optimierten LDD-Struktur hat ihr Maximum tief im
Silizium und weicht an der Grenzfläche deutlich vor der Kanaldotierung
zurück. Aufgrund der mit  für eine LDD-Implantation relativ
hohen Implantationsenergie ist eine BLDD-Struktur
(buried LDD) [Wei86] entstanden. Im Vergleich von 18 zumeist LDD-artigen Drain-Strukturen
in [San89a] wird die BLDD-Struktur ganz generell bei Lebensdauer,
Stromtreiberfähigkeit und Kurzkanalverhalten jeweils als gut eingestuft.
für eine LDD-Implantation relativ
hohen Implantationsenergie ist eine BLDD-Struktur
(buried LDD) [Wei86] entstanden. Im Vergleich von 18 zumeist LDD-artigen Drain-Strukturen
in [San89a] wird die BLDD-Struktur ganz generell bei Lebensdauer,
Stromtreiberfähigkeit und Kurzkanalverhalten jeweils als gut eingestuft.
Martin Stiftinger
Mon Oct 17 21:16:53 MET 1994
 und der LDD-Implantation auf
und der LDD-Implantation auf
 als optimaler Kompromiß zwischen
Unterdrückung heißer Ladungsträger und hohem Sättigungs-Drainstrom
getroffen. Das zugehörige Gesamtdotierungsprofil als Isolinen
mit skizzierter Gate- und Spacer-Struktur zeigt Abb. 6.13,
die Drain-Seite in axonometrischer Darstellung Abb. 6.14.
als optimaler Kompromiß zwischen
Unterdrückung heißer Ladungsträger und hohem Sättigungs-Drainstrom
getroffen. Das zugehörige Gesamtdotierungsprofil als Isolinen
mit skizzierter Gate- und Spacer-Struktur zeigt Abb. 6.13,
die Drain-Seite in axonometrischer Darstellung Abb. 6.14.





 ]
und schematische
Gate-Spacer-Struktur des optimierten LDD-
]
und schematische
Gate-Spacer-Struktur des optimierten LDD- -MOSFETs.
-MOSFETs.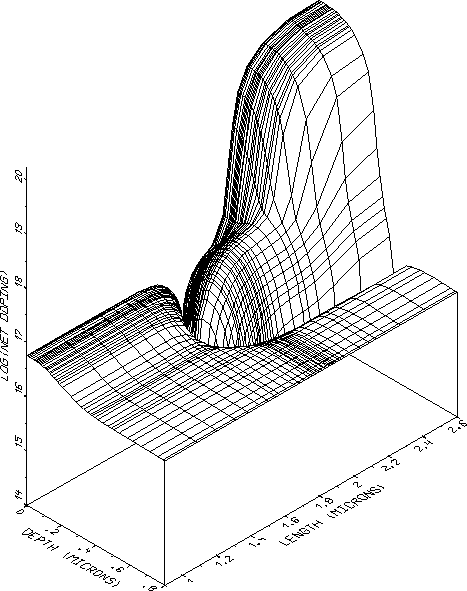
 -Zone der optimierten LDD-Struktur hat ihr Maximum tief im
Silizium und weicht an der Grenzfläche deutlich vor der Kanaldotierung
zurück. Aufgrund der mit
-Zone der optimierten LDD-Struktur hat ihr Maximum tief im
Silizium und weicht an der Grenzfläche deutlich vor der Kanaldotierung
zurück. Aufgrund der mit  für eine LDD-Implantation relativ
hohen Implantationsenergie ist eine BLDD-Struktur
(buried LDD)
für eine LDD-Implantation relativ
hohen Implantationsenergie ist eine BLDD-Struktur
(buried LDD)