 mit Zusätzen von
mit Zusätzen von  und
und
 ), wobei sich das Verfahren durch eine sehr gute Reproduzierbarkeit
auszeichnet.
), wobei sich das Verfahren durch eine sehr gute Reproduzierbarkeit
auszeichnet.




Das heute industriell gebräuchlichste Verfahren für die Herstellung von
Metallisierungen ist das Sputter-Verfahren, das zur Gruppe der
PVD-Verfahren (PVD - engl.: Physical Vapor Deposition) zählt und auch
Kathodenzerstäubung genannt wird. Es ermöglicht die Abscheidung von
Schichten definierter Zusammensetzung (z.B.  mit Zusätzen von
mit Zusätzen von  und
und
 ), wobei sich das Verfahren durch eine sehr gute Reproduzierbarkeit
auszeichnet.
), wobei sich das Verfahren durch eine sehr gute Reproduzierbarkeit
auszeichnet.
Abbildung 4.6 zeigt das Prinzip des Verfahrens. In einer
Vakuumkammer wird bei konstantem Gasdruck von ca. 1  durch eine Gleich-
oder Hochfrequenzspannung zwischen zwei Elektroden ein Plasma gezündet.
Die vorwiegend im Kathodenfall beschleunigten positiven Gasionen (meist
Argonionen) können durch ihre hohe kinetische Energie (ca.
durch eine Gleich-
oder Hochfrequenzspannung zwischen zwei Elektroden ein Plasma gezündet.
Die vorwiegend im Kathodenfall beschleunigten positiven Gasionen (meist
Argonionen) können durch ihre hohe kinetische Energie (ca. )
beim Aufprall auf die Kathode Atome aus deren Oberfläche herausschlagen.
Während die Gasionen entsprechend dem vertikal gerichteten
elektrischen Feld senkrecht auf das Target prallen, ist die Energie der
gesputterten Atome gering (einige keV), und sie verlassen die
Targetoberfläche nach allen Richtungen, wobei z.B. eine
Cosinus-Winkelverteilung angenommen werden kann [Wid88]. Substrate, die
auf der Anode liegen, werden mit einer Materialschicht belegt, die der
Targetzusammensetzung entspricht.
)
beim Aufprall auf die Kathode Atome aus deren Oberfläche herausschlagen.
Während die Gasionen entsprechend dem vertikal gerichteten
elektrischen Feld senkrecht auf das Target prallen, ist die Energie der
gesputterten Atome gering (einige keV), und sie verlassen die
Targetoberfläche nach allen Richtungen, wobei z.B. eine
Cosinus-Winkelverteilung angenommen werden kann [Wid88]. Substrate, die
auf der Anode liegen, werden mit einer Materialschicht belegt, die der
Targetzusammensetzung entspricht.
Beim sogenannten Bias-Sputtern wird die Hochfrequenz gezielt an beiden Elektroden eingekoppelt. Damit können die elektrischen Potentiale der Platten unabhängig voneinander variiert werden. Ein Teil der Ionen wird somit in Richtung der Halbleiterscheibe beschleunigt und erreicht beim Auftreffen eine Energie, die ausreicht, um Teilchen von der Oberfläche zu entfernen (Rücksputtern). Da die Sputterrate winkelabhängig ist, werden konvexe Strukturen stärker abgetragen, wodurch eine Kantenabschrägung erreicht wird. Die abgesputterten Teilchen werden durch Redeposition wieder an der Halbleiterscheibe angelagert, sodaß insgesamt eine planarisierende Wirkung erzielt wird.
Zur Erhöhung der Sputter-Rate sind die Reaktoren oft mit Elektro- oder Permanentmagneten ausgerüstet. Bei diesem sogenannten Magnetron-Sputtern werden die ionisierten Elektronen mit Hilfe des Magnetfeldes relativ lange im Plasmabereich gehalten. In gleichem Maße nimmt die Stoßwahrscheinlichkeit und damit die Zahl der generierten Ionen/Elektronenpaare zu.
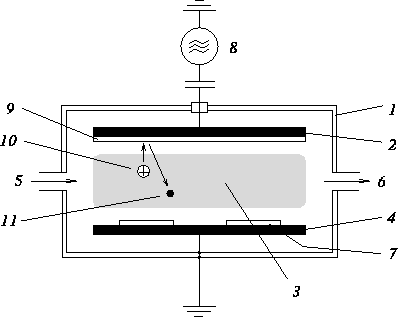
Abbildung 4.6: Schema des Sputter-Reaktors und des Sputterprinzips;
1 Vakuumkammer, 2 obere Elektrode, 3 Plasma, 4 untere Elektrode,
5 Gaseinlaß, 6 Anschluß für Vakuumpumpe,
7 Halbleiterscheiben, 8 Hochfrequenzspannung, 9 Sputtertarget,
10 Ion des Plasmas, 11 Targetatom.
Die Ionenstromdichte und damit die Sputter-Rate kann so um ein bis zwei Größenordnungen gesteigert werden.



