5.2.2 Anwendung im Fall eines nMOS-Transistors




Next: 5.3 Diskussion der Ergebnisse
Up: 5.2 Ergebnisse
Previous: 5.2.1 Kalibrierung des Modells
Die Monte-Carlo-Methode wird zur Berechnung von Gate-Strömen herangezogen,
wobei für einen Transistor mit  Gate-Länge,
Gate-Länge,  Oxiddicke und
Oxiddicke und
 Weite drei verschiedene Modelle für die vom transversalen elektrischen
Feld an der Si/SiO
Weite drei verschiedene Modelle für die vom transversalen elektrischen
Feld an der Si/SiO -Grenzfläche abhängigen Transmissionsraten verwendet
werden. In Abbildung 5.5 ist das transversale elektrische Feld
für eine Drain-Spannung
-Grenzfläche abhängigen Transmissionsraten verwendet
werden. In Abbildung 5.5 ist das transversale elektrische Feld
für eine Drain-Spannung  bei variabler Gate-Spannung als Funktion des
Abstands vom Source dargestellt. Im Bereich des Übergangs zur Sperrschicht im
Drain-Bereich fällt das transversale elektrische Feld deutlich ab und wird
sogar negativ, falls
bei variabler Gate-Spannung als Funktion des
Abstands vom Source dargestellt. Im Bereich des Übergangs zur Sperrschicht im
Drain-Bereich fällt das transversale elektrische Feld deutlich ab und wird
sogar negativ, falls  ist. In Abbildung 5.6 ist die
Dotierung des
ist. In Abbildung 5.6 ist die
Dotierung des  Transistors festgehalten. Das laterale elektrische Feld
(Abbildung 5.7) für
Transistors festgehalten. Das laterale elektrische Feld
(Abbildung 5.7) für  und
und  zeigt einen starken
Abfall in der Kanalzone, wodurch Elektronen in diesem Bereich sehr stark in
Richtung Drain beschleunigt werden. Da eine Monte-Carlo-Rechnung mit
zeigt einen starken
Abfall in der Kanalzone, wodurch Elektronen in diesem Bereich sehr stark in
Richtung Drain beschleunigt werden. Da eine Monte-Carlo-Rechnung mit  Teilchen sehr zeitaufwendig ist, wird das Simulationsgebiet auf diejenige Region
eingeschränkt, in der Hochenergieeffekte nicht mehr zu vernachlässigen
sind. Die Elektronenenergie ist mit einem isotropen Mehrbandmodell berechnet
worden und in Abbildung 5.8 für
Teilchen sehr zeitaufwendig ist, wird das Simulationsgebiet auf diejenige Region
eingeschränkt, in der Hochenergieeffekte nicht mehr zu vernachlässigen
sind. Die Elektronenenergie ist mit einem isotropen Mehrbandmodell berechnet
worden und in Abbildung 5.8 für  und
und  dargestellt. Dabei ist ersichtlich, daß in der Nähe der
Drain-Sperrschichtzone die betrachteten Ladungsträger eine sehr hohe
durchschnittliche Energie aufweisen und somit an dieser Stelle verstärkt
Injektion in das Gate-Oxid zu erwarten sein wird.
dargestellt. Dabei ist ersichtlich, daß in der Nähe der
Drain-Sperrschichtzone die betrachteten Ladungsträger eine sehr hohe
durchschnittliche Energie aufweisen und somit an dieser Stelle verstärkt
Injektion in das Gate-Oxid zu erwarten sein wird.
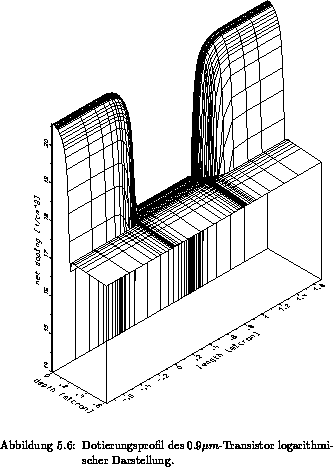
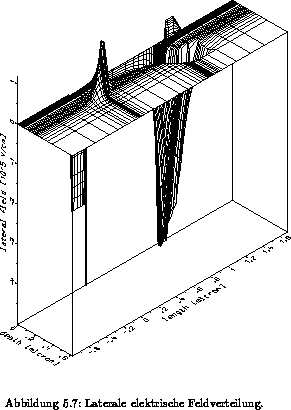


Die Parameter für die einzelnen Phononenstreuprozesse sind in
Tabelle 5.3 angegeben. Zusätzlich wird noch Störstellenstreuung und
Stoßionisation berücksichtigt, wobei der Vorfaktor dieses Streumechanismus'
gleich  [51] ist und ebenfalls zur Adjustierung verwendet wird. Im
Gegensatz zur Simulation homogener Injektion (Tabelle 5.1) sind die
Streuparameter der höherliegenden, löcherähnlichen Bänder der optischen
Deformationspotentialstreuung erhöht worden. Das Monte-Carlo-Fenster ist so
gewählt, daß sich das Simulationsgebiet in x-Richtung vom Source- bis zum
Drain-Bereich und in y-Richtung bis zur Depletionszone erstreckt. Erreicht ein
Elektron die Si/SiO
[51] ist und ebenfalls zur Adjustierung verwendet wird. Im
Gegensatz zur Simulation homogener Injektion (Tabelle 5.1) sind die
Streuparameter der höherliegenden, löcherähnlichen Bänder der optischen
Deformationspotentialstreuung erhöht worden. Das Monte-Carlo-Fenster ist so
gewählt, daß sich das Simulationsgebiet in x-Richtung vom Source- bis zum
Drain-Bereich und in y-Richtung bis zur Depletionszone erstreckt. Erreicht ein
Elektron die Si/SiO -Grenzfläche, dann wird es, sofern es aufgrund des
Vergleichs der Transmissionsrate mit einer Zufallszahl injiziert wird, der
Rechnung entzogen, andernfalls wird es reflektiert. Zur besseren
Übereinstimmung mit den experimentellen Daten wird ein Skalierfaktor, der das
transversale elektrische Feld nach dem pn-Übergang (
-Grenzfläche, dann wird es, sofern es aufgrund des
Vergleichs der Transmissionsrate mit einer Zufallszahl injiziert wird, der
Rechnung entzogen, andernfalls wird es reflektiert. Zur besseren
Übereinstimmung mit den experimentellen Daten wird ein Skalierfaktor, der das
transversale elektrische Feld nach dem pn-Übergang ( ) um
) um  erniedrigt, eingeführt.
erniedrigt, eingeführt.
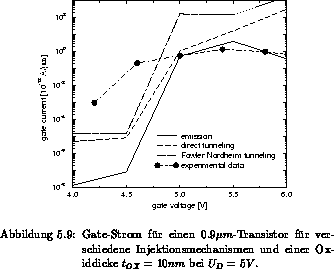
Zur Gate-Stromberechnung in Abbildung 5.9 mit der
Fowler-Nordheim-Näherung und mit dem Modell des direkten, quantenmechanischen
Tunnelns wird die Transmissionsrate mit dem Gewicht des die Grenzfläche
erreichenden Elektrons multipliziert. Deswegen tragen bei diesen Modellen alle
Elektronen zum Gate-Strom bei und resultieren in einem deutlich höheren Strom
als im Fall der Emission, bei der ein Elektron in SiO injiziert und danach
dessen Trajektorie im Oxid simuliert wird. Für Gate-Spannungen, die kleiner als
die Drain-Spannung sind, kann keine gute Übereinstimmung mit den
experimentellen Daten erzielt werden, der Gate-Strom wird stark
unterschätzt und schwankt trotz hoher Statistik nur innerhalb der
Größenordnung. Da das transversale, elektrische Feld im Bereich nach der
Sperrschicht negativ ist, wird bei der Simulation Injektion ausgeschlossen. Das
ist möglicherweise die Ursache, daß der Gate-Strom unter den experimentellen
Daten liegt. Wenn nun die Gate-Spannung näherungsweise gleich der
Drain-Spannung ist, steigt der Gate-Strom sehr stark an und strebt gegen die
experimentellen Werte. Im Bereich von
injiziert und danach
dessen Trajektorie im Oxid simuliert wird. Für Gate-Spannungen, die kleiner als
die Drain-Spannung sind, kann keine gute Übereinstimmung mit den
experimentellen Daten erzielt werden, der Gate-Strom wird stark
unterschätzt und schwankt trotz hoher Statistik nur innerhalb der
Größenordnung. Da das transversale, elektrische Feld im Bereich nach der
Sperrschicht negativ ist, wird bei der Simulation Injektion ausgeschlossen. Das
ist möglicherweise die Ursache, daß der Gate-Strom unter den experimentellen
Daten liegt. Wenn nun die Gate-Spannung näherungsweise gleich der
Drain-Spannung ist, steigt der Gate-Strom sehr stark an und strebt gegen die
experimentellen Werte. Im Bereich von  und einer Drain-Spannung von
und einer Drain-Spannung von
 kann mit der in dieser Arbeit entwickelten Methode der Emission von
Elektronen der Gate-Strom quantitativ richtig erklärt werden
(Abbildung 5.9). Experimentelle Daten sind
Referenz [161] entnommen. Beschränkt man sich bei den
Transmissionsraten nur auf Tunneln, so ist der Gate-Strom deutlich über den
experimentell gemessenen Werten und auch qualitativ kann ein Abflachen des
Gate-Stromes nicht beobachtet werden, falls die Gate-Spannung die Drain-Spannung
übersteigt. Dis Simulation des Gate-Stromes, bei dem die Transmissionsraten
nach der Approximation von Fowler-Nordheim berechnet werden, ist höher als im
Vergleich mit quantenmechanischen, direkten Tunneln.
kann mit der in dieser Arbeit entwickelten Methode der Emission von
Elektronen der Gate-Strom quantitativ richtig erklärt werden
(Abbildung 5.9). Experimentelle Daten sind
Referenz [161] entnommen. Beschränkt man sich bei den
Transmissionsraten nur auf Tunneln, so ist der Gate-Strom deutlich über den
experimentell gemessenen Werten und auch qualitativ kann ein Abflachen des
Gate-Stromes nicht beobachtet werden, falls die Gate-Spannung die Drain-Spannung
übersteigt. Dis Simulation des Gate-Stromes, bei dem die Transmissionsraten
nach der Approximation von Fowler-Nordheim berechnet werden, ist höher als im
Vergleich mit quantenmechanischen, direkten Tunneln.

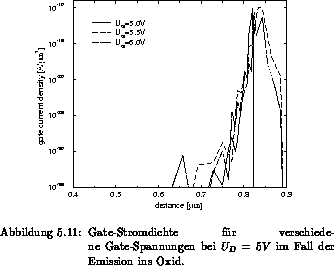
Die Stromdichte an der Si/SiO -Grenzfläche der einzelnen Modelle ist in
Abbildung 5.10 festgehalten. Zur besseren Veranschaulichung wird
die Transmissionsrate der Fowler-Nordheim-Näherung in die beiden Komponenten
Tunneln und thermionische Emission unterteilt. Tunneln tritt ein, falls die
Energie normal zur Grenzfläche kleiner als die Potentialbarriere ist,
thermionische Emission dagegen, falls die Energie normal zur Grenzfläche
größer als die Potentialschwelle ist. Links vor der Drain-Verarmungszone
(
-Grenzfläche der einzelnen Modelle ist in
Abbildung 5.10 festgehalten. Zur besseren Veranschaulichung wird
die Transmissionsrate der Fowler-Nordheim-Näherung in die beiden Komponenten
Tunneln und thermionische Emission unterteilt. Tunneln tritt ein, falls die
Energie normal zur Grenzfläche kleiner als die Potentialbarriere ist,
thermionische Emission dagegen, falls die Energie normal zur Grenzfläche
größer als die Potentialschwelle ist. Links vor der Drain-Verarmungszone
( ) trägt nur Tunneln zur Gate-Stromdichte bei. Die Anteile des
Gate-Stromes, die mit der Fowler-Nordheim-Näherung als auch mit dem
quantenmechanischen Tunnelmodell berechnet werden, weisen quantitativ und
qualitativ sehr ähnliches Aussehen auf. Im Bereich nach der Verarmungszone
trägt zusätzlich auch thermionische Emission zur Gate-Stromdichte
bei. Transmissionsraten, denen ein quantenmechanisches Modell zugrunde liegt,
werden nicht unterteilt, da auch oberhalb der Potentialschwelle Reflexionen
möglich sind. Abbildung 5.10 zeigt die Gate-Stromdichte für
verschiedene Gate-Spannungen. Da das transversale Feld für eine Gate-Spannung
) trägt nur Tunneln zur Gate-Stromdichte bei. Die Anteile des
Gate-Stromes, die mit der Fowler-Nordheim-Näherung als auch mit dem
quantenmechanischen Tunnelmodell berechnet werden, weisen quantitativ und
qualitativ sehr ähnliches Aussehen auf. Im Bereich nach der Verarmungszone
trägt zusätzlich auch thermionische Emission zur Gate-Stromdichte
bei. Transmissionsraten, denen ein quantenmechanisches Modell zugrunde liegt,
werden nicht unterteilt, da auch oberhalb der Potentialschwelle Reflexionen
möglich sind. Abbildung 5.10 zeigt die Gate-Stromdichte für
verschiedene Gate-Spannungen. Da das transversale Feld für eine Gate-Spannung
 bei ungefähr
bei ungefähr  sehr klein wird, fällt die Stromdichte auf
Null ab, wobei das Maximum kurz nach der Verarmungszone auftritt. Wenn die
Gate-Spannung erhöht wird, erstreckt sich die Stromdichte vom pn-Übergang bis
zum drain-seitigen Ende der Oxidschicht. Das Maximum der Stromdichte liegt immer
bei ungefähr
sehr klein wird, fällt die Stromdichte auf
Null ab, wobei das Maximum kurz nach der Verarmungszone auftritt. Wenn die
Gate-Spannung erhöht wird, erstreckt sich die Stromdichte vom pn-Übergang bis
zum drain-seitigen Ende der Oxidschicht. Das Maximum der Stromdichte liegt immer
bei ungefähr  .
.




Next: 5.3 Diskussion der Ergebnisse
Up: 5.2 Ergebnisse
Previous: 5.2.1 Kalibrierung des Modells
Martin Stiftinger
Mon Aug 7 18:44:55 MET DST 1995
 Gate-Länge,
Gate-Länge,  Oxiddicke und
Oxiddicke und
 Weite drei verschiedene Modelle für die vom transversalen elektrischen
Feld an der Si/SiO
Weite drei verschiedene Modelle für die vom transversalen elektrischen
Feld an der Si/SiO -Grenzfläche abhängigen Transmissionsraten verwendet
werden. In Abbildung 5.5 ist das transversale elektrische Feld
für eine Drain-Spannung
-Grenzfläche abhängigen Transmissionsraten verwendet
werden. In Abbildung 5.5 ist das transversale elektrische Feld
für eine Drain-Spannung  bei variabler Gate-Spannung als Funktion des
Abstands vom Source dargestellt. Im Bereich des Übergangs zur Sperrschicht im
Drain-Bereich fällt das transversale elektrische Feld deutlich ab und wird
sogar negativ, falls
bei variabler Gate-Spannung als Funktion des
Abstands vom Source dargestellt. Im Bereich des Übergangs zur Sperrschicht im
Drain-Bereich fällt das transversale elektrische Feld deutlich ab und wird
sogar negativ, falls  ist. In Abbildung 5.6 ist die
Dotierung des
ist. In Abbildung 5.6 ist die
Dotierung des  Transistors festgehalten. Das laterale elektrische Feld
(Abbildung 5.7) für
Transistors festgehalten. Das laterale elektrische Feld
(Abbildung 5.7) für  und
und  zeigt einen starken
Abfall in der Kanalzone, wodurch Elektronen in diesem Bereich sehr stark in
Richtung Drain beschleunigt werden. Da eine Monte-Carlo-Rechnung mit
zeigt einen starken
Abfall in der Kanalzone, wodurch Elektronen in diesem Bereich sehr stark in
Richtung Drain beschleunigt werden. Da eine Monte-Carlo-Rechnung mit  Teilchen sehr zeitaufwendig ist, wird das Simulationsgebiet auf diejenige Region
eingeschränkt, in der Hochenergieeffekte nicht mehr zu vernachlässigen
sind. Die Elektronenenergie ist mit einem isotropen Mehrbandmodell berechnet
worden und in Abbildung 5.8 für
Teilchen sehr zeitaufwendig ist, wird das Simulationsgebiet auf diejenige Region
eingeschränkt, in der Hochenergieeffekte nicht mehr zu vernachlässigen
sind. Die Elektronenenergie ist mit einem isotropen Mehrbandmodell berechnet
worden und in Abbildung 5.8 für  und
und  dargestellt. Dabei ist ersichtlich, daß in der Nähe der
Drain-Sperrschichtzone die betrachteten Ladungsträger eine sehr hohe
durchschnittliche Energie aufweisen und somit an dieser Stelle verstärkt
Injektion in das Gate-Oxid zu erwarten sein wird.
dargestellt. Dabei ist ersichtlich, daß in der Nähe der
Drain-Sperrschichtzone die betrachteten Ladungsträger eine sehr hohe
durchschnittliche Energie aufweisen und somit an dieser Stelle verstärkt
Injektion in das Gate-Oxid zu erwarten sein wird.




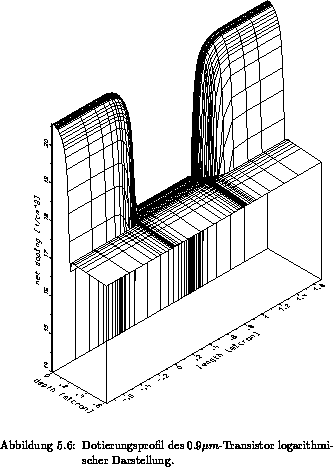
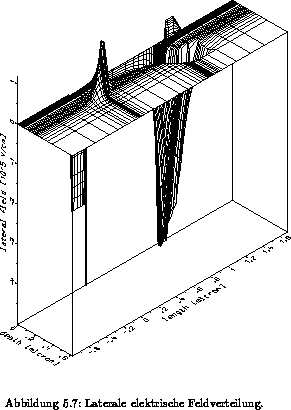



 ) um
) um  erniedrigt, eingeführt.
erniedrigt, eingeführt.
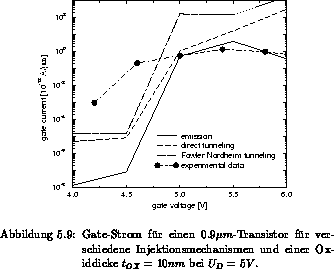
 und einer Drain-Spannung von
und einer Drain-Spannung von

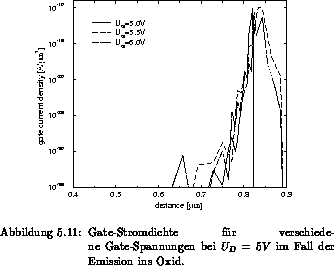
 sehr klein wird, fällt die Stromdichte auf
Null ab, wobei das Maximum kurz nach der Verarmungszone auftritt. Wenn die
Gate-Spannung erhöht wird, erstreckt sich die Stromdichte vom pn-Übergang bis
zum drain-seitigen Ende der Oxidschicht. Das Maximum der Stromdichte liegt immer
bei ungefähr
sehr klein wird, fällt die Stromdichte auf
Null ab, wobei das Maximum kurz nach der Verarmungszone auftritt. Wenn die
Gate-Spannung erhöht wird, erstreckt sich die Stromdichte vom pn-Übergang bis
zum drain-seitigen Ende der Oxidschicht. Das Maximum der Stromdichte liegt immer
bei ungefähr