
Abbildung 2.19: Das interatomare Potential zwischen Bor und den Siliziumatomreihen wird in dieser Abbildung durch Kontinuumspotentiale

Abbildung 2.19: Das interatomare Potential zwischen Bor und den
Siliziumatomreihen wird in dieser Abbildung durch
Kontinuumspotentiale ![]() [eV] ersetzt und an Hand von
Konturdiagrammen für a) [100], b) [111] und c) [110]-Richtung
dargestellt [Hob96]. Eine Längeneinheit entspricht der
Gitterkonstante
[eV] ersetzt und an Hand von
Konturdiagrammen für a) [100], b) [111] und c) [110]-Richtung
dargestellt [Hob96]. Eine Längeneinheit entspricht der
Gitterkonstante ![]() Å. Die Atome befinden sich in
den Zentren der dunkel gefärbten Kreise und man sieht sehr deutlich
daß der [110] Kanal den weitaus größten Raum für ,,Channeling`` zur
Verfügung stellt.
Å. Die Atome befinden sich in
den Zentren der dunkel gefärbten Kreise und man sieht sehr deutlich
daß der [110] Kanal den weitaus größten Raum für ,,Channeling`` zur
Verfügung stellt. ![]() ist auf Grund von Beiträgen aus
anderen Reihen nicht exakt zirkularsymmetrisch.
ist auf Grund von Beiträgen aus
anderen Reihen nicht exakt zirkularsymmetrisch.
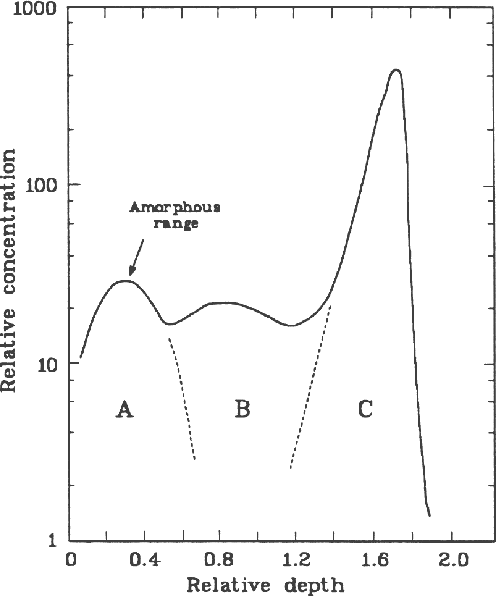
Abbildung 2.20: Schematische
Darstellung der Reichweitenverteilung unter Beruecksichtigung von
Channeling-Phaenomenen. Bereich A repraesentiert implantierte Ionen,
die keine Abhaengigkeit von der Struktur des Targets zeigen,
das Plateau in Bereich B wird dadurch erzeugt, dass Ionen aus den
Kanaelen herausgestreut werden und der Peak im Teil C resultiert aus
der erhoehten Eindringtiefe der Ionen im ,,Channeling``-Fall
[EK95]. Solche oder aehnliche Verteilungen erhaelt man
z.B. bei 150keV-Bor-Implantationen in <110> Silizium.
Auf ihrem Weg durch den Siliziumkristall können die Ionen durch Streuprozesse in Leerräume (Kanäle bzw. ,,Channels``) zwischen den Atomreihen und -ebenen eintreten, wo sie anschließend von den interatomaren Potentialen der ,,Target``-Atome geleitet werden. Da sowohl die Kernabbremsung durch Vermeidung harter, nuklearer Stöße mit den ,,Target``-Atomen als auch die elektronische Abbremsung auf Grund geringerer Kristallelektronendichten in der Mitte der Kanäle (siehe Abbildung 2.19) vermindert ist, haben kanalisierte Ionen eine erheblich größere Reichweite als jene Teilchen, die sich in zufällige (,,Random``) Richtungen bewegen (siehe Abbildung 2.20). Je nachdem, ob sich das Ion entlang von Atomebenen oder -reihen bewegt, unterscheidet man planares und axiales ,,Channeling``.
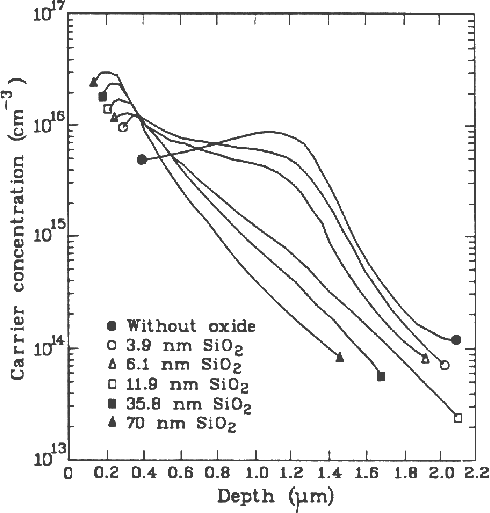
Abbildung 2.21: Channeling von Phosphor in 111- Silizium,
implantiert mit 300keV und einer Dosis von 10![]() als eine Funktion der Streuoxiddicke. Die Aktivierung der
Dotierstoffe erfolgte bei 850
als eine Funktion der Streuoxiddicke. Die Aktivierung der
Dotierstoffe erfolgte bei 850![]() C [Mol71].
C [Mol71].
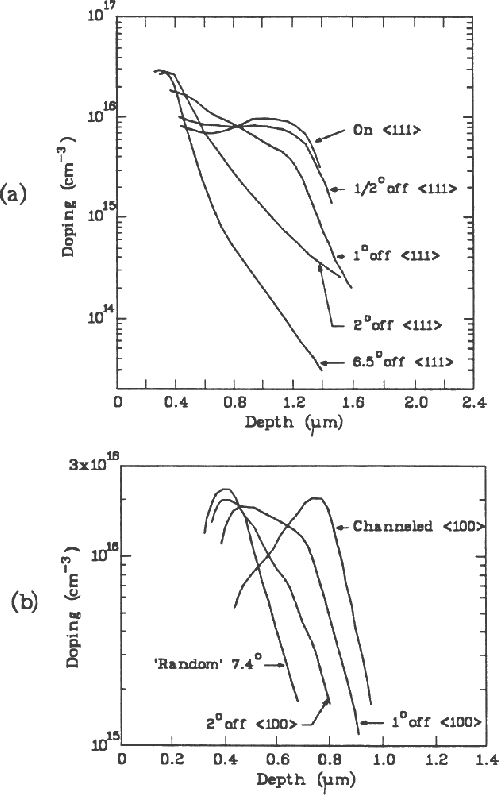
Abbildung 2.22: Abhaengigkeit des Channeling-Effekts vom
Kippwinkel, dargestellt an Hand von a) Phosphor implantiert mit
300keV und einer Dosis von 10![]() in <111>\
Silizium [Mol71] und b) Bor implantiert mit 150keV und
einer Dosis von
in <111>\
Silizium [Mol71] und b) Bor implantiert mit 150keV und
einer Dosis von ![]() in <100>\
Silizium [Sei71a]. Die Aktivierung der Dotierstoffe
erfolgte bei 850
in <100>\
Silizium [Sei71a]. Die Aktivierung der Dotierstoffe
erfolgte bei 850![]() C.
C.

Abbildung 2.23: Channeling-Karte fuer Bor in Silizium implantiert
mit 10keV. Dunkle Bereiche zeigen Channeling-Richtungen
[Hob96]. Der linke obere Teil wurde mit Hilfe
verbesserter Channeling-Theorien dargestellt, der rechte
untere Teil wurde hingegen mit Monte Carlo Simulation berechnet
[Hob95a].
In der Einleitung wurde bereits angesprochen, daß man zusehends
oberflächennahe pn-Übergänge herstellen möchte, aber auch die
Reproduzierbarkeit gewinnt eine immer größere Bedeutung [Sim92]
(vgl. auch Abbildung 2.3). Bei Verwendung von Streuoxiden
kommt deren Dicke noch als zusätzlicher Faktor hinzu
(siehe Abbildung 2.21) [Boh95c]. Daher ist man versucht, den
Channeling-Effekt möglichst zu unterdrücken, und es wird i.a. der
Wafer gegenüber der Strahlachse verkippt und um seine eigene Achse
verdreht (siehe Abbildung 2.22). Als Standardwert für den Kippwinkel
hat sich 7![]() etabliert , obwohl der optimale Wert
eine Funktion der Ionenart und Implantationsenergie ist. Zur Problemlösung
haben sich sogenannte ,,Channeling``-Karten als hilfreich
erwiesen, denn sie zeigen, bei welchen Einfallsrichtungen des Ionenstrahls
auf das ,,Target`` ,,Channeling`` an der Oberfläche auftritt
(siehe Abbildung 2.23).
etabliert , obwohl der optimale Wert
eine Funktion der Ionenart und Implantationsenergie ist. Zur Problemlösung
haben sich sogenannte ,,Channeling``-Karten als hilfreich
erwiesen, denn sie zeigen, bei welchen Einfallsrichtungen des Ionenstrahls
auf das ,,Target`` ,,Channeling`` an der Oberfläche auftritt
(siehe Abbildung 2.23).
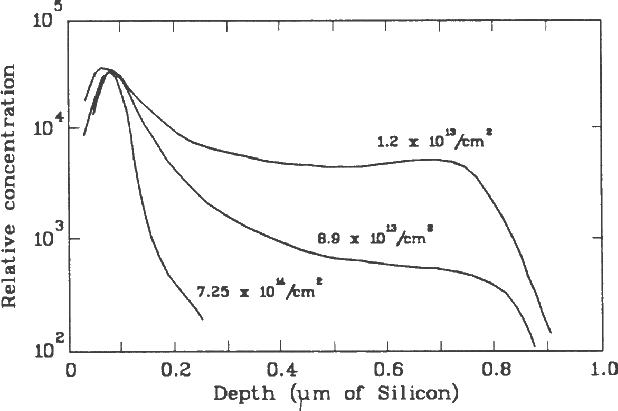
Abbildung 2.24: Abhaengigkeit des Channeling-Effekts von
der Implantationsdosis, dargestellt an Hand von
40keV-Phosphor-Implantationen in <110> Silizium
[Dea68].
Wie bereits dargestellt, besteht ein sehr enger Zusammenhang zwischen Kristallstruktur und Channeling-Phänomen. Daraus wird ersichtlich, daß letzteres auch entscheidend von der Gitterdefektdichte im Kristall (siehe Kapitel 2.8) und damit von der Implantationsdosis abhängt (siehe Abbildung 2.24). Im Extremfall liegen amorphisierte Zonen vor, und Channeling wird vollständig unterdrückt.
Die Temperaturabhängigkeit wurde in Zusammenhang mit den Gitterschwingungen näher erläutert, und soll hier nur mehr zur Vervollständigung angeführt werden.
Es läßt sich wie folgt zusammenfassen: