Trägt man nun D als Funktion der aus den X-TEM Bildern gemessenen Tiefen
der a/k-Grenzschichten auf, so erhält man z.B. für die 300keV Implantation
die Abbildung 5.2. Aus diesen Kurven läßt sich jene
Implantationsdosis ![]() ablesen, die benötigt wird, um einkristallines
Silizium in einer bestimmten Entfernung von der Wafer-Oberfläche zu
amorphisieren. Die Substrattemperatur T fungiert dabei als Parameter für
die Kurvenschar.
ablesen, die benötigt wird, um einkristallines
Silizium in einer bestimmten Entfernung von der Wafer-Oberfläche zu
amorphisieren. Die Substrattemperatur T fungiert dabei als Parameter für
die Kurvenschar.
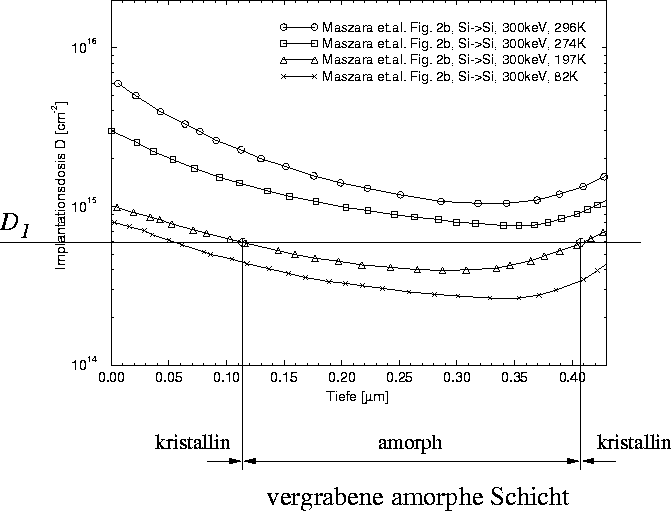
Abbildung 5.2: Beziehung zwischen Implantationsdosis D und
der Lage der a/k-Grenzschichten. Diese Kurven entstanden durch
Auswertung der X-TEM Bilder für Implantationen mit 300keV-Si-Ionen
bei Temperaturen zwischen 82 und 296![]() . Implantiert man z.B. mit
einer Dosis
. Implantiert man z.B. mit
einer Dosis ![]() so entsteht bei einer Temperatur von 197
so entsteht bei einer Temperatur von 197![]() eine
vergrabene amorphe Schicht.
eine
vergrabene amorphe Schicht.
Drei Eigenschaften des Amorphisierungsvorganges lassen sich aus diesen Verläufen sofort ableiten:
Implantiert man nun z.B. mit einer Dosis ![]() (siehe Abbildung 5.2)
so entsteht bei
(siehe Abbildung 5.2)
so entsteht bei ![]() eine vergrabene amorphe Schicht und diese
entscheidet maßgeblich über die Kategorie der sekundären Defekte.
eine vergrabene amorphe Schicht und diese
entscheidet maßgeblich über die Kategorie der sekundären Defekte.