 ).
).




Die zur Zeit am weitesten verbreitete Methode zur Herstellung integrierter
Schaltungen ist die Ionenimplantation. Sie eignet sich aufgrund ihrer
Flexibilität und Wirtschaftlichkeit am besten zur Herstellung von einzelnen
FETs bis zu gesamten MMICs. Kommerzielle Implantationsanlagen erreichen
heute einen Durchsatz von 100 Wafers pro Stunde. So beträgt zum Beispiel
die Implantationszeit für eine typische Kanalimplantation
40 Sekunden (Implanter `Eaton NV 6200', Dosis  ).
).
Bei der Ionenimplantation werden hochenergetische Ionen auf das zu dotierende
Substrat geschossen. Die Verteilung der implantierten Atome im Halbleiter
kann dabei durch die Energie, den Einschußwinkel und
durch die Verwendung von Masken gezielt beeinflußt werden. Durch mehrfache,
hintereinander durchgeführte Implantationen können so selbst komplizierte
Dotierungsprofile mit guter Genauigkeit und Reproduzierbarkeit hergestellt
werden. Durch die Bombardierung des Halbleiters mit den hochenergetischen
Ionen wird das Kristallgitter gestört. Diese Gitterschäden müssen in einem
nachfolgenden Prozeßschritt ausgeheilt werden. Die Ausheilung wird
normalerweise durch Erwärmung im Temperaturbereich von 700 - 900  C
durchgeführt. Die dabei auftretenden Diffusionsprozesse und
Kompensationsmechanismen beeinflussen zusätzlich die endgültige Form des
elektrisch aktiven Dotierungsprofils.
C
durchgeführt. Die dabei auftretenden Diffusionsprozesse und
Kompensationsmechanismen beeinflussen zusätzlich die endgültige Form des
elektrisch aktiven Dotierungsprofils.
Um die Form der Verteilung der implantierten Atome in Abhängigkeit von der Geometrie des Substrates und den Prozeßparametern exakt zu berechnen, kann man nun die Bahnen der ins Substrat eingetretenen Ionen berechnen und mittels Monte-Carlo-Methoden die Verteilungfunktion ermitteln. Allerdings erfordert diese Methode hohen Aufwand an Computerresourcen und ist daher für den täglichen Einsatz zur Ermittlung von Dotierungsprofilen noch nicht geeignet [34]. Es lassen sich aber aus solchen Berechnungen Parameter gewinnen, die es ermöglichen, die Dotierungsprofile mit analytischen Verteilungsfunktionen zu beschreiben.
In erster Näherung läßt sich das Profil einer im rechten Winkel zur Substratoberfläche in homogenes Material erfolgten Implantation eindimensional mit einer Gaußschen Verteilungsfunktion annähern.

Hier bedeutet  den Abstand zur Oberfläche,
den Abstand zur Oberfläche,  ist die implantierte
Dosis.
Die Reichweite
ist die implantierte
Dosis.
Die Reichweite  bezeichnet den Abstand des Maximums von der Oberfläche,
und die Standardabweichung
bezeichnet den Abstand des Maximums von der Oberfläche,
und die Standardabweichung  bezeichnet die Breite
der Verteilungsfunktion.
Beide Parameter sind von der Implantationsenergie abhängig.
Die Energieabhängigkeit dieser Parameter kann nun experimentell,
aus theoretischen Überlegungen oder, wie oben erwähnt, aus
Monte-Carlo-Rechnungen gewonnen werden.
bezeichnet die Breite
der Verteilungsfunktion.
Beide Parameter sind von der Implantationsenergie abhängig.
Die Energieabhängigkeit dieser Parameter kann nun experimentell,
aus theoretischen Überlegungen oder, wie oben erwähnt, aus
Monte-Carlo-Rechnungen gewonnen werden.
Die älteste Theorie zur Berechnung der
energieabhängigen Parameter ist die LSS-Theorie [51][72],
bei der die
Wahrscheinlichkeit für die Eindringtiefe eines Ions mit bestimmter Masse und
Energie in ein Substrat mit bestimmter Atomdichte berechnet wird. Daraus lassen
sich dann die makroskopischen Mittelwerte der resultierenden Verteilungsfunktion
ermitteln.
Als Referenz für tabellierte Implantationsparameter einer großen Zahl
verschiedener Dopanden und verschiedener Substrate nach der LSS-Theorie sei
hier das Buch von Gibbons angeführt [19]. Speziell für die
Implantation in GaAs wurden in [34]
Implantationsparameter aus Monte-Carlo-Berechnungen extrahiert. Die Abbildungen
2.11 und 2.12 zeigen die Energieabhängigkeit der
Reichweite und der Standardabweichung für die Dopanden B, P, As, Si, O, Mg und
Be im Energiebereich von  bis
bis  . Simulationen von GaAs MESFETs mit Si
Kanalimplantation und Mg `buffer layer' (vgl. auch Kap. 4.5) unter
Verwendung
dieser Implantationsdaten und der Vergleich mit experimentellen Daten scheinen
allerdings darauf hinzuweisen, daß die Reichweiten von Si überschätzt
werden. Ein Vergleich mit den Daten aus [19] zeigt die doch deutlich
größeren Reichweiten von Si nach [34].
. Simulationen von GaAs MESFETs mit Si
Kanalimplantation und Mg `buffer layer' (vgl. auch Kap. 4.5) unter
Verwendung
dieser Implantationsdaten und der Vergleich mit experimentellen Daten scheinen
allerdings darauf hinzuweisen, daß die Reichweiten von Si überschätzt
werden. Ein Vergleich mit den Daten aus [19] zeigt die doch deutlich
größeren Reichweiten von Si nach [34].
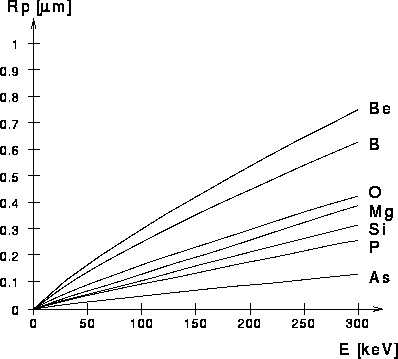
Abbildung: Reichweite in GaAs nach [34]

Abbildung: Standardabweichung in GaAs nach [34]
In den Abbildungen 2.13 und 2.14 sind deshalb die Reichweite und die Standardabweichung für die beiden wichtigsten Dopanden in GaAs, den Donator Silizium und den Akzeptor Magnesium, aus Monte-Carlo-Rechnungen und der LSS-Theorie dargestellt.
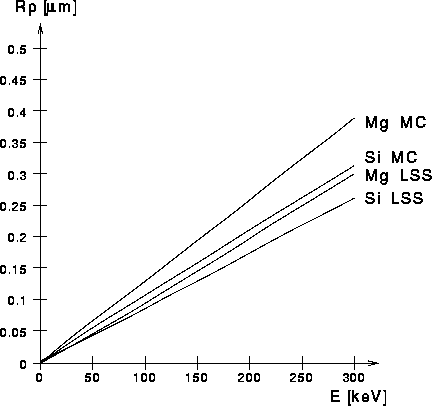
Abbildung 2.13: Vergleich der Reichweite von Si und Mg in GaAs
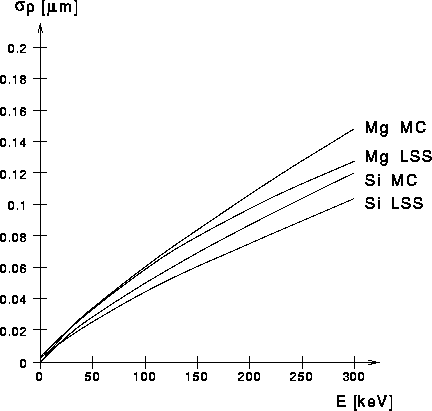
Abbildung 2.14: Vergleich der Standardabweichung von Si und Mg in GaAs
Mit dem auf die Ionenimplantation folgenden Ausheilschritt bei Temperaturen von
bis zu 900  C verfolgt man zwei Ziele. Einerseits sollen dem
Kristallgitter zugefügte Schäden in der Kristallstruktur beseitigt werden,
andererseits soll auch eine möglichst hohe elektrische Aktivierung der
implantierten Atome erreicht werden. Aufgrund der polaren Natur von GaAs können
die Siliziumatome sowohl als Donator wie auch als Akzeptor wirken.
Sitzt ein Si Atom auf einem Ga Gitterplatz, so wirkt es als Donator, während Si
an As Plätzen als Akzeptor wirkt. Während des Ausheilens kommt es nun
zu Austauschprozessen zwischen den verschiedenen Si Atomen und
Gitterfehlstellen. Diese Prozesse sind sehr stark von den spezifischen
Ausheilbedingungen und den Anfangsverteilungen der beteiligten Atome und
Gitterdefekte abhängig.
C verfolgt man zwei Ziele. Einerseits sollen dem
Kristallgitter zugefügte Schäden in der Kristallstruktur beseitigt werden,
andererseits soll auch eine möglichst hohe elektrische Aktivierung der
implantierten Atome erreicht werden. Aufgrund der polaren Natur von GaAs können
die Siliziumatome sowohl als Donator wie auch als Akzeptor wirken.
Sitzt ein Si Atom auf einem Ga Gitterplatz, so wirkt es als Donator, während Si
an As Plätzen als Akzeptor wirkt. Während des Ausheilens kommt es nun
zu Austauschprozessen zwischen den verschiedenen Si Atomen und
Gitterfehlstellen. Diese Prozesse sind sehr stark von den spezifischen
Ausheilbedingungen und den Anfangsverteilungen der beteiligten Atome und
Gitterdefekte abhängig.
Die bei der Ausheilung auftretende Diffusion der implantierten Atome läßt sich in erster Näherung durch eine zweidimensionale Diffusionsgleichung mit konstantem Diffusionskoeffizienten (2.2) beschreiben.
Die Lösung dieser Gleichung mit der Randbedingung
 und der Anfangsbedingung
und der Anfangsbedingung

lautet
Bei Kenntnis des Diffusionskoeffizienten läßt sich auf diese Weise die Form des Dotierungsprofils berechnen. In der Literatur [48] findet man für die meisten Dopanden die Temperaturabhängigkeit der Diffusionskoeffizienten nach dem Arrheniusgesetz:

Diese Werte sind allerdings sehr stark von den jeweiligen Prozeßbedingungen abhängig, und gelten meist nur in sehr eingeschränkten Temperaturbereichen (Tab. 2.1).

Tabelle 2.1: Diffusionskoeffizienten in GaAs
Die Annahme konstanter Diffusionkoeffizienten stellt eine grobe Vereinfachung dar, wie Untersuchungen über die Diffusion von Si und Mg in GaAs gezeigt haben [63]. Die Diffusionskoeffizienten hängen so wie bei der Diffusion in Silizium von den Ladungsträgerkonzentrationen ab. In [63] wurde auch die Aktivierung der Dopanden in Abhängigkeit von Konzentration und Temperatur untersucht. Abb. 2.15 zeigt, daß für sehr hohe Konzentrationen von Si, wie sie bei Kontaktimplantationen auftreten, die Aktivierung sehr stark absinkt und daher in der Berechnung des Dotierungsprofils berücksichtigt werden muß.
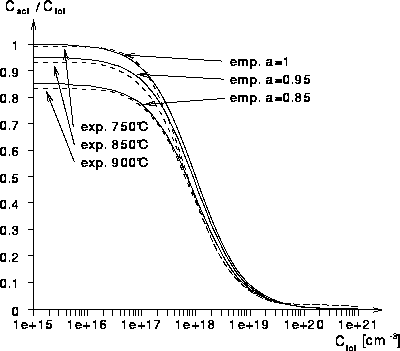
Abbildung: Aktivierung von Si in GaAs: Experimente nach [63]
und empirische Funktion 2.6
Um für die Simulation eine einfache Möglichkeit zur Berechnung der Dotierungsprofile bereitzustellen, wurden folgende Modelle implementiert:
 und
und  nach [34]. Zusätzlich für Si und Mg
die Daten nach [19].
nach [34]. Zusätzlich für Si und Mg
die Daten nach [19].
 zu
spezifizieren.
zu
spezifizieren.
wobei  die aktive und
die aktive und  die gesamte Konzentration des Dopanden
bezeichnet und
die gesamte Konzentration des Dopanden
bezeichnet und  ein einstellbarer Vorfaktor ist.
ein einstellbarer Vorfaktor ist.
Dieses Modell stellt natürlich nur eine grobe Näherung dar. Für eine genauere Spezifizierung der Dotierungsprofile müssen entweder experimentelle Daten oder die Prozeßsimulation herangezogen werden [16].



