5.1 Retrograde-Wanne




Next: 5.2 -Kanal-Transistor mit -Polysilizium-Gate
Up: 5 Prozeßvereinfachung bei der
Previous: 5 Prozeßvereinfachung bei der
Mit fortschreitender Transistorverkleinerung muß die
Dotierungskonzentration der Wannen, welche die Transistoren durch
Ausbildung eines in Sperrichtung gepolten  -Überganges
elektrisch voneinander trennen, angehoben werden. Punchthrough-Effekt,
Drain-Reststrom, Kurzkanal-, DIBL-Effekt, aber vor allem die
CMOS-Latchup-Festigkeit erfordern eine hohe Dotierungskonzentration
im Bereich des vertikalen Source- und Drain-
-Überganges
elektrisch voneinander trennen, angehoben werden. Punchthrough-Effekt,
Drain-Reststrom, Kurzkanal-, DIBL-Effekt, aber vor allem die
CMOS-Latchup-Festigkeit erfordern eine hohe Dotierungskonzentration
im Bereich des vertikalen Source- und Drain- -Übergangs.
An der Grenzfläche zum Gate hingegen
ist die Dotierungskonzentration von der erforderlichen Threshold-Spannung
festgelegt. Hohe Dotierungskonzentration führt zur
Beweglichkeitsabnahme der
Ladungsträger und vermindert damit die Stromtreiberfähigkeit.
-Übergangs.
An der Grenzfläche zum Gate hingegen
ist die Dotierungskonzentration von der erforderlichen Threshold-Spannung
festgelegt. Hohe Dotierungskonzentration führt zur
Beweglichkeitsabnahme der
Ladungsträger und vermindert damit die Stromtreiberfähigkeit.
Traditionell werden die implantierten Wannen durch stundenlange
Thermodiffusion (z.B.  Stunden bei
Stunden bei  )
)
 tief getrieben und weisen ein
Plateau mit nahezu konstanter Dotierung in der Größenordnung von etwa
tief getrieben und weisen ein
Plateau mit nahezu konstanter Dotierung in der Größenordnung von etwa
 in der aktiven Region bei Halbmikrometer-Technologien auf.
Das in der breiten Anwendung relativ neue Konzept der Retrograde-Wanne
weist einen deutlichen Dotierungsgradienten auf. Die Wanne ist
etwa
in der aktiven Region bei Halbmikrometer-Technologien auf.
Das in der breiten Anwendung relativ neue Konzept der Retrograde-Wanne
weist einen deutlichen Dotierungsgradienten auf. Die Wanne ist
etwa  tief und fällt,
wie in Abb. 5.2 ersichtlich, zur
Oberfläche hin stark ab (retrograde=sich zurückziehen).
Die Maximalkonzentration der Retrograde-Wanne
kann auf die Anforderungen größtmöglicher Latchup-Festigkeit
abgestimmt den Wert von
tief und fällt,
wie in Abb. 5.2 ersichtlich, zur
Oberfläche hin stark ab (retrograde=sich zurückziehen).
Die Maximalkonzentration der Retrograde-Wanne
kann auf die Anforderungen größtmöglicher Latchup-Festigkeit
abgestimmt den Wert von  erreichen.
erreichen.
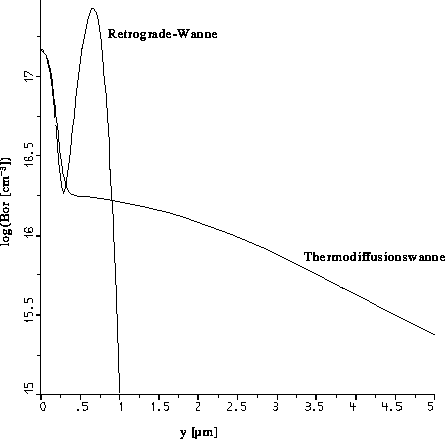
Abbildung: Vergleich der Profile von
Retrograde- und konventioneller Thermodiffusionswanne
für einen 
 -Kanal-Transistor (Wannenprofile
mit Threshold-Justier-Implantation).
-Kanal-Transistor (Wannenprofile
mit Threshold-Justier-Implantation).
Hergestellt wird die Retrograde-Wanne durch Hochenergieimplantation
mit über  und im Vergleich zur Thermodiffusionswanne
kurzem Ausheilen (z.B.
und im Vergleich zur Thermodiffusionswanne
kurzem Ausheilen (z.B.  Minuten bei
Minuten bei  ).
Werden zur Implantation doppelt oder dreifach geladene Ionen (nahezu
ausschließlich Phosphor und Bor) verwendet, können die herkömmlichen
Mittelenergie-Implantationsapparate mit Beschleunigungsspannungen
bis
).
Werden zur Implantation doppelt oder dreifach geladene Ionen (nahezu
ausschließlich Phosphor und Bor) verwendet, können die herkömmlichen
Mittelenergie-Implantationsapparate mit Beschleunigungsspannungen
bis  für diesen Fertigungsschritt weiterhin eingesetzt werden.
für diesen Fertigungsschritt weiterhin eingesetzt werden.
Bei CMOS-Prozessen
bilden Source/Drain des  -Kanal-Transistors,
-Kanal-Transistors,  -Wanne,
-Wanne,  -Wanne und
Source/Drain des
-Wanne und
Source/Drain des  -Kanal-Transistors eine parasitäre
Thyristorstruktur [Tro78]. Dieser Thyristor kann unter ungünstigen Umständen
zünden (,,latch up``)
und die Funktion der Schaltung oder die Schaltung selbst gefährden.
Der Nachweis der Latchup-Festigkeit wurde für diese Prozeßentwicklung
mittels transienter, zweidimensionaler Simulation mit
CADDETH [Toy85] erbracht und in [Mas93] berichtet.
Weiterführende Simulationen der Latchup-Festigkeit werden in
[Sle92] angestellt.
-Kanal-Transistors eine parasitäre
Thyristorstruktur [Tro78]. Dieser Thyristor kann unter ungünstigen Umständen
zünden (,,latch up``)
und die Funktion der Schaltung oder die Schaltung selbst gefährden.
Der Nachweis der Latchup-Festigkeit wurde für diese Prozeßentwicklung
mittels transienter, zweidimensionaler Simulation mit
CADDETH [Toy85] erbracht und in [Mas93] berichtet.
Weiterführende Simulationen der Latchup-Festigkeit werden in
[Sle92] angestellt.
Durch die erhöhte Latchup-Immunität der Retrograde-Wannen kann
der Abstand zwischen  - und
- und  -Kanal-Transistor verringert und
somit wertvolle Chipfläche eingespart werden.
In [Kan91] wird beispielsweise für einen Halbmikron-Prozeß von
-Kanal-Transistor verringert und
somit wertvolle Chipfläche eingespart werden.
In [Kan91] wird beispielsweise für einen Halbmikron-Prozeß von  Reduktion des
Reduktion des
 Abstandes berichtet.
Eine erfolgreiche Anwendung des Retrograde-Wannen-Konzeptes für
eine leistungsfähige
Abstandes berichtet.
Eine erfolgreiche Anwendung des Retrograde-Wannen-Konzeptes für
eine leistungsfähige  -Technologie beschreibt [Cha92].
Vom Ansatz der sich zur Oberfläche hin zurückziehenden
Wannendotierungskonzentration sind auch Aoki et al.
[Aok92] bei ihrem
Low-Impurity-Channel Transistor (LICT) für
-Technologie beschreibt [Cha92].
Vom Ansatz der sich zur Oberfläche hin zurückziehenden
Wannendotierungskonzentration sind auch Aoki et al.
[Aok92] bei ihrem
Low-Impurity-Channel Transistor (LICT) für  Kanallänge
ausgegangen, zur Herstellung der niedriger dotierten
aktiven Zone wurde aber Epitaxie über vergrabenen, hochdotierten
Implantationswannen gewählt.
Kanallänge
ausgegangen, zur Herstellung der niedriger dotierten
aktiven Zone wurde aber Epitaxie über vergrabenen, hochdotierten
Implantationswannen gewählt.




Next: 5.2 -Kanal-Transistor mit -Polysilizium-Gate
Up: 5 Prozeßvereinfachung bei der
Previous: 5 Prozeßvereinfachung bei der
Martin Stiftinger
Mon Oct 17 21:16:53 MET 1994
 -Überganges
elektrisch voneinander trennen, angehoben werden. Punchthrough-Effekt,
Drain-Reststrom, Kurzkanal-, DIBL-Effekt, aber vor allem die
CMOS-Latchup-Festigkeit erfordern eine hohe Dotierungskonzentration
im Bereich des vertikalen Source- und Drain-
-Überganges
elektrisch voneinander trennen, angehoben werden. Punchthrough-Effekt,
Drain-Reststrom, Kurzkanal-, DIBL-Effekt, aber vor allem die
CMOS-Latchup-Festigkeit erfordern eine hohe Dotierungskonzentration
im Bereich des vertikalen Source- und Drain- -Übergangs.
An der Grenzfläche zum Gate hingegen
ist die Dotierungskonzentration von der erforderlichen Threshold-Spannung
festgelegt. Hohe Dotierungskonzentration führt zur
Beweglichkeitsabnahme der
Ladungsträger und vermindert damit die Stromtreiberfähigkeit.
-Übergangs.
An der Grenzfläche zum Gate hingegen
ist die Dotierungskonzentration von der erforderlichen Threshold-Spannung
festgelegt. Hohe Dotierungskonzentration führt zur
Beweglichkeitsabnahme der
Ladungsträger und vermindert damit die Stromtreiberfähigkeit.




 Stunden bei
Stunden bei  )
)
 tief getrieben und weisen ein
Plateau mit nahezu konstanter Dotierung in der Größenordnung von etwa
tief getrieben und weisen ein
Plateau mit nahezu konstanter Dotierung in der Größenordnung von etwa
 in der aktiven Region bei Halbmikrometer-Technologien auf.
Das in der breiten Anwendung relativ neue Konzept der Retrograde-Wanne
weist einen deutlichen Dotierungsgradienten auf. Die Wanne ist
etwa
in der aktiven Region bei Halbmikrometer-Technologien auf.
Das in der breiten Anwendung relativ neue Konzept der Retrograde-Wanne
weist einen deutlichen Dotierungsgradienten auf. Die Wanne ist
etwa  tief und fällt,
wie in Abb.
tief und fällt,
wie in Abb.  erreichen.
erreichen.
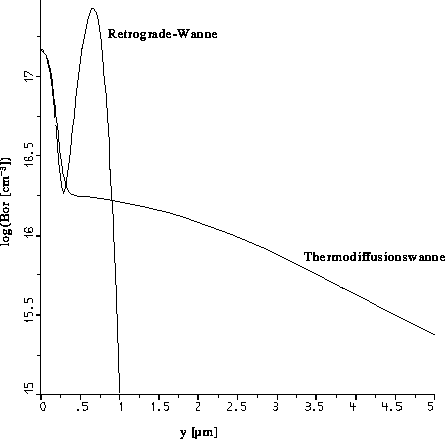

 -Kanal-Transistor (Wannenprofile
mit Threshold-Justier-Implantation).
-Kanal-Transistor (Wannenprofile
mit Threshold-Justier-Implantation). und im Vergleich zur Thermodiffusionswanne
kurzem Ausheilen (z.B.
und im Vergleich zur Thermodiffusionswanne
kurzem Ausheilen (z.B.  Minuten bei
Minuten bei  ).
Werden zur Implantation doppelt oder dreifach geladene Ionen (nahezu
ausschließlich Phosphor und Bor) verwendet, können die herkömmlichen
Mittelenergie-Implantationsapparate mit Beschleunigungsspannungen
bis
).
Werden zur Implantation doppelt oder dreifach geladene Ionen (nahezu
ausschließlich Phosphor und Bor) verwendet, können die herkömmlichen
Mittelenergie-Implantationsapparate mit Beschleunigungsspannungen
bis  für diesen Fertigungsschritt weiterhin eingesetzt werden.
für diesen Fertigungsschritt weiterhin eingesetzt werden.
 -Kanal-Transistors,
-Kanal-Transistors,  Reduktion des
Reduktion des
 Abstandes berichtet.
Eine erfolgreiche Anwendung des Retrograde-Wannen-Konzeptes für
eine leistungsfähige
Abstandes berichtet.
Eine erfolgreiche Anwendung des Retrograde-Wannen-Konzeptes für
eine leistungsfähige  -Technologie beschreibt
-Technologie beschreibt  Kanallänge
ausgegangen, zur Herstellung der niedriger dotierten
aktiven Zone wurde aber Epitaxie über vergrabenen, hochdotierten
Implantationswannen gewählt.
Kanallänge
ausgegangen, zur Herstellung der niedriger dotierten
aktiven Zone wurde aber Epitaxie über vergrabenen, hochdotierten
Implantationswannen gewählt.