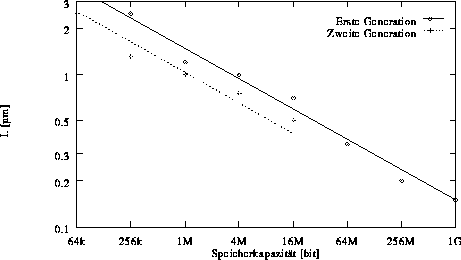
Abbildung: DRAM-Generationen: minimale Linienbreite von erster und zweiter Generation als Funktion der Speicherkapazität.




BEI der Entwicklung dynamischer Random-Access Memory (DRAM) Chips wird im globalen Konkurrenzkampf der Halbleiterfirmen gewaltiger Aufwand getrieben, um als erster eine neue DRAM-Generation am Markt einführen zu können. Der zu erzielende Preis je Chip ist am Beginn des neuen Produktzyklus hoch und der Erlös trotz geringer Stückzahlen attraktiv. Um möglichst schnell am Markt sein zu können, muß meist ein komplexer Prozeß, eine geringe Ausbeute und eine erhöhte Chipfläche in Kauf genommen werden.
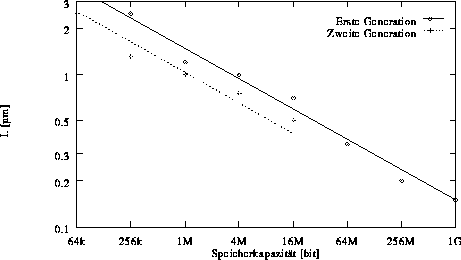
Abbildung: DRAM-Generationen:
minimale Linienbreite von erster und zweiter Generation
als Funktion der Speicherkapazität.
Wenn der Chippreis durch den Markteintritt der nächsten Konkurrenten dann sinkt, die absetzbare Stückzahl aber stark ansteigt, wird eine Weiterentwicklung (die sog. zweite Generation) der ursprünglichen DRAM-Technologie unternommen. In Abb. 5.1 ist die minimale Linienbreite von DRAM-Technologie erster und zweiter Generation über der DRAM-Speicherkapazität doppelt logarithmisch aufgetragen. Die Punkte indizieren für ihre Generation typische, konkrete DRAM-Chips [Pri91], die Parallelverschiebung der Mittelwertslinien beschreibt ein gleiches Verkleinerungsverhältnis der Gate-Länge bei der Überarbeitung der ersten Implementierung einer Speicherkapazität. Heute sind die ersten 16 Megabit DRAMs zweiter Generation im Handel erhältlich und die erste Generation von 64 Megabit Chips steht vor der Markteinführung.
Die Zielrichtung der Entwicklung des DRAM-Chips der zweiten Generation ist primär die Kostensenkung, erreichbar durch die untereinander verknüpften Maßnahmen zur Ausbeuteerhöhung, Flächenverminderung, Prozeßvereinfachung und durch massenproduktionsgerechte Prozeßschritte. Daraus leiten sich folgende (für hochentwickelte Halbleitertechnologien zum Teil krasse) Forderungen ab:
 - und
- und  -Wannen
wird das höhere Implantationsenergie und wesentlich
kürzere Diffusionszeit aufweisende Verfahren der Retrograde-Wanne bevorzugt.
-Wannen
wird das höhere Implantationsenergie und wesentlich
kürzere Diffusionszeit aufweisende Verfahren der Retrograde-Wanne bevorzugt.
 -Polysilizium wird für beide
Transistortypen, für den
-Polysilizium wird für beide
Transistortypen, für den  - und für den
- und für den  -Kanal-MOSFET,
verwendet.
-Kanal-MOSFET,
verwendet.
Diese Anforderungen an den CMOS-Prozeß wurden für den  DRAM Chip
der zweiten Generation mit einer Kanalläge von
DRAM Chip
der zweiten Generation mit einer Kanalläge von  aufgestellt.
Der vereinfachte
aufgestellt.
Der vereinfachte  DRAM Chip wird eine Kanallänge von
ca.
DRAM Chip wird eine Kanallänge von
ca.  aufweisen [Tan92] und durch
neue Fortschritte auf dem Gebiet der optischen Lithographie
ebenfalls noch ohne Phase-shift-Masken gefertigt werden können,
sodaß erwartet werden darf, daß alle aufgelisteten Anforderungen für
die Massenproduktion auch dieses Speicherbausteins Gültigkeit behalten.
aufweisen [Tan92] und durch
neue Fortschritte auf dem Gebiet der optischen Lithographie
ebenfalls noch ohne Phase-shift-Masken gefertigt werden können,
sodaß erwartet werden darf, daß alle aufgelisteten Anforderungen für
die Massenproduktion auch dieses Speicherbausteins Gültigkeit behalten.
 -Kanal-Transistor mit
-Kanal-Transistor mit  -Polysilizium-Gate
-Polysilizium-Gate



