5.2.2 Threshold-Justierung




Next: 5.2.3 -Wanne
Up: 5.2 -Kanal-Transistor mit -Polysilizium-Gate
Previous: 5.2.1 -Wanne
Bei gegebener Gate-Oxiddicke wird die
Threshold-Spannung über die Dosis einer Kanalimplantation
(Threshold-Justier-Implantation) eingestellt.
Die zur Erreichung der vorgegeben Threshold-Spannung  notwendige Kanalimplantationsdosis im
hier behandelten DRAM-Prozeß kann aus Abb. 5.3
mit
notwendige Kanalimplantationsdosis im
hier behandelten DRAM-Prozeß kann aus Abb. 5.3
mit  bestimmt werden. Diese Abbildung
der Threshold-Spannung über der Bor-Implantationsdosis zeigt auch
die Prozeßsensitivität auf unbeabsichtigte Dosisvariation.
Auch wenn die gemessene Threshold-Spannung des ersten
Prozeßdurchlaufs nicht vollständig mit dem Zielwert übereinstimmt,
kann hieraus die notwendige Dosiskorrektur abgelesen werden.
Abb. 5.4 zeigt das simulierte Kanaldotierungsprofil am Ende des
Gesamtfertigungsablaufs. Die Bor-Oberflächenkonzentration beträgt
bestimmt werden. Diese Abbildung
der Threshold-Spannung über der Bor-Implantationsdosis zeigt auch
die Prozeßsensitivität auf unbeabsichtigte Dosisvariation.
Auch wenn die gemessene Threshold-Spannung des ersten
Prozeßdurchlaufs nicht vollständig mit dem Zielwert übereinstimmt,
kann hieraus die notwendige Dosiskorrektur abgelesen werden.
Abb. 5.4 zeigt das simulierte Kanaldotierungsprofil am Ende des
Gesamtfertigungsablaufs. Die Bor-Oberflächenkonzentration beträgt
 .
.

Abbildung: Bestimmung der Threshold-Justier-Implantationsdosis für den
 -Kanal-Transistor: Threshold-Spannung
-Kanal-Transistor: Threshold-Spannung  als Funktion der
Bor-Kanalimplantationsdosis.
als Funktion der
Bor-Kanalimplantationsdosis.
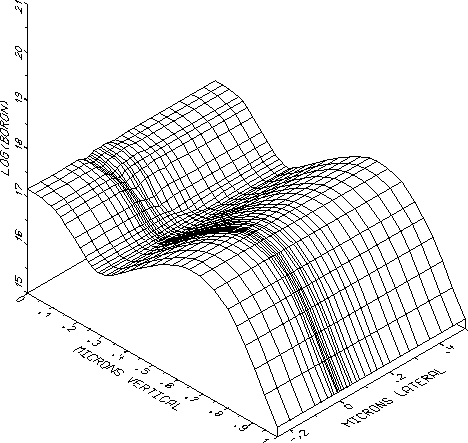
Abbildung: Bor-Dotierungsprofil [ ] für den
] für den
 -Kanal-Transistor: Ansicht der Drain-Seite,
Schnitt in der Kanalmitte. Die Unregelmäßigkeit unterhalb der
Gate-Kante (bei
-Kanal-Transistor: Ansicht der Drain-Seite,
Schnitt in der Kanalmitte. Die Unregelmäßigkeit unterhalb der
Gate-Kante (bei  lateral) entsteht durch den Einfluß der
Drain-Dotierung (gekoppelte Diffusion).
lateral) entsteht durch den Einfluß der
Drain-Dotierung (gekoppelte Diffusion).
Martin Stiftinger
Mon Oct 17 21:16:53 MET 1994
 notwendige Kanalimplantationsdosis im
hier behandelten DRAM-Prozeß kann aus Abb. 5.3
mit
notwendige Kanalimplantationsdosis im
hier behandelten DRAM-Prozeß kann aus Abb. 5.3
mit  bestimmt werden. Diese Abbildung
der Threshold-Spannung über der Bor-Implantationsdosis zeigt auch
die Prozeßsensitivität auf unbeabsichtigte Dosisvariation.
Auch wenn die gemessene Threshold-Spannung des ersten
Prozeßdurchlaufs nicht vollständig mit dem Zielwert übereinstimmt,
kann hieraus die notwendige Dosiskorrektur abgelesen werden.
Abb. 5.4 zeigt das simulierte Kanaldotierungsprofil am Ende des
Gesamtfertigungsablaufs. Die Bor-Oberflächenkonzentration beträgt
bestimmt werden. Diese Abbildung
der Threshold-Spannung über der Bor-Implantationsdosis zeigt auch
die Prozeßsensitivität auf unbeabsichtigte Dosisvariation.
Auch wenn die gemessene Threshold-Spannung des ersten
Prozeßdurchlaufs nicht vollständig mit dem Zielwert übereinstimmt,
kann hieraus die notwendige Dosiskorrektur abgelesen werden.
Abb. 5.4 zeigt das simulierte Kanaldotierungsprofil am Ende des
Gesamtfertigungsablaufs. Die Bor-Oberflächenkonzentration beträgt
 .
.





 -Kanal-Transistor: Threshold-Spannung
-Kanal-Transistor: Threshold-Spannung  als Funktion der
Bor-Kanalimplantationsdosis.
als Funktion der
Bor-Kanalimplantationsdosis.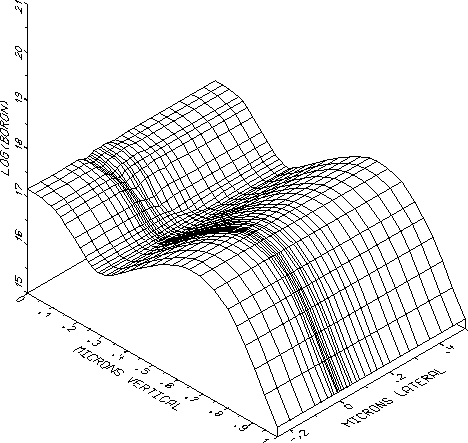
 ] für den
] für den
 lateral) entsteht durch den Einfluß der
Drain-Dotierung (gekoppelte Diffusion).
lateral) entsteht durch den Einfluß der
Drain-Dotierung (gekoppelte Diffusion).