 -Wanne
-Wanne




 -Wanne
-Wanne
Die Wannen-Dotierungskonzentration für den  -MOS-Transistor mit
vergrabenem Kanal ist bei vorgegebener Gegendotierung
durch die angestrebte Threshold-Spannung bestimmt. Die
Phosphor-Implantationsdosis kann aus Abb. 5.5 zu
-MOS-Transistor mit
vergrabenem Kanal ist bei vorgegebener Gegendotierung
durch die angestrebte Threshold-Spannung bestimmt. Die
Phosphor-Implantationsdosis kann aus Abb. 5.5 zu
 entnommen werden, damit die
für den
entnommen werden, damit die
für den  -MOSFET die Threshold-Spannung
-MOSFET die Threshold-Spannung  erreicht.
erreicht.

Abbildung: Bestimmung der  -Wannen-Implantationsdosis des
-Wannen-Implantationsdosis des
 -Kanal-Transistors: Threshold-Spannung
-Kanal-Transistors: Threshold-Spannung  als Funktion der Phosphor-Implantationsdosis.
als Funktion der Phosphor-Implantationsdosis.
Wie die Schnittdarstellung des simulierten Gesamtdotierungsprofils
in Abb. 5.6 (mit Drain-Profilierung durch
einmalige Bor-Implantation)
zeigt, liegt der  -Übergang unterhalb des
Gates, also der vergrabene Kanal in einer Tiefe von
-Übergang unterhalb des
Gates, also der vergrabene Kanal in einer Tiefe von  .
Die Dotierungskonzentration an der Grenzfläche muß mit einem
Wert von
.
Die Dotierungskonzentration an der Grenzfläche muß mit einem
Wert von  wegen der
Wannen-Gegendotierung niedriger sein als beim
wegen der
Wannen-Gegendotierung niedriger sein als beim  -Kanal-Transistor.
-Kanal-Transistor.
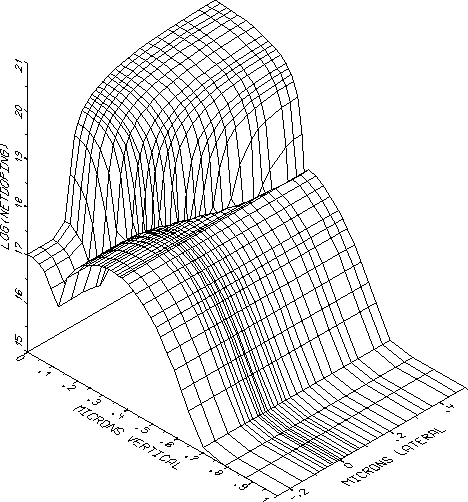
Abbildung: Gesamtdotierungsprofil [ ] für den
] für den
 -Kanal-Transistor: Ansicht der Drain-Seite,
Schnitt in der Kanalmitte.
-Kanal-Transistor: Ansicht der Drain-Seite,
Schnitt in der Kanalmitte.
Da der MOS-Transistor mit vergrabenem Kanal zu Punchthrough und
höherem Drain-Reststrom tendiert, wird man im bei der  -Wanne
besprochenen
Kompromiß eher eine höhere
-Wanne
besprochenen
Kompromiß eher eine höhere  -Wannen-Implantationsdosis
vorziehen. Freilich hat man die freie Wahl der Wannendosis
zugunsten einer Maskeneinsparung geopfert. Es bleibt also hier
nur die Verifikation dieses Ansatzes.
Im konkreten Entwicklungsbeispiel ist die maximale Dotierungskonzentration
der
-Wannen-Implantationsdosis
vorziehen. Freilich hat man die freie Wahl der Wannendosis
zugunsten einer Maskeneinsparung geopfert. Es bleibt also hier
nur die Verifikation dieses Ansatzes.
Im konkreten Entwicklungsbeispiel ist die maximale Dotierungskonzentration
der  -Wanne mit
-Wanne mit  relativ hoch, ob aber
hinreichend hoch zur Unterdrückung der Punchthrough-Neigung, ist am
einfachsten anhand der Subthreshold-Kennlinien
für verschiedene Kanallängen abzuklären.
relativ hoch, ob aber
hinreichend hoch zur Unterdrückung der Punchthrough-Neigung, ist am
einfachsten anhand der Subthreshold-Kennlinien
für verschiedene Kanallängen abzuklären.
Abb. 5.7 zeigt diese Subthreshold-Kennlinien des  weiten
weiten  -MOSFETs für die
Gate-Längen
-MOSFETs für die
Gate-Längen  und
und  für jeweils
Drain-Source-Spannung
für jeweils
Drain-Source-Spannung  und
und  . Es fällt der
große Drain-Reststrom für
. Es fällt der
große Drain-Reststrom für  auf; dieser Transistor ist
bei
auf; dieser Transistor ist
bei  im Durchbruch (siehe Abb. 5.8,
Potential-Konturlinie für
im Durchbruch (siehe Abb. 5.8,
Potential-Konturlinie für  ).
Der
).
Der  -Transistor hat immer noch einen Drain-Reststrom von
ca.
-Transistor hat immer noch einen Drain-Reststrom von
ca.  , ein Wert, der in dieser konkreten Anwendung gerade noch
innerhalb des Toleranzbereichs liegt.
, ein Wert, der in dieser konkreten Anwendung gerade noch
innerhalb des Toleranzbereichs liegt.
Für den  -MOSFET wird die kleinste Nenn-Gate-Länge mit
-MOSFET wird die kleinste Nenn-Gate-Länge mit  festgelegt. Unter Berücksichtigung von statistischen Prozeßvariationen
wird die minimale, noch tolerierbare (,,worst case``) gezeichnete
Gate-Länge mit
festgelegt. Unter Berücksichtigung von statistischen Prozeßvariationen
wird die minimale, noch tolerierbare (,,worst case``) gezeichnete
Gate-Länge mit  festgesetzt. Somit kann das
Punchthrough-Verhalten des
festgesetzt. Somit kann das
Punchthrough-Verhalten des  -Kanal-Transistors hingenommen werden. Es
werden keine Gegenmaßnahmen, wie etwa Anhebung der Wannendotierung oder
eine zusätzliche Punchthrough-Implantation, gesetzt.
-Kanal-Transistors hingenommen werden. Es
werden keine Gegenmaßnahmen, wie etwa Anhebung der Wannendotierung oder
eine zusätzliche Punchthrough-Implantation, gesetzt.
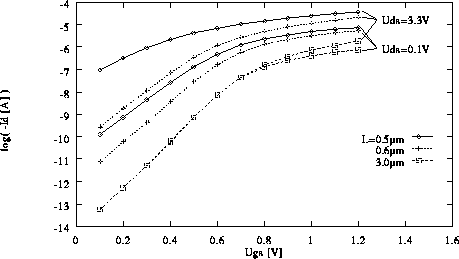
Abbildung:  -MOSFET-Subthreshold-Kennlinien für verschiedene
Gate-Längen
-MOSFET-Subthreshold-Kennlinien für verschiedene
Gate-Längen  jeweils für Drain-Source-Spannung
jeweils für Drain-Source-Spannung
 und
und  .
.

Abbildung: Punchthrough im  -
- -MOSFET: Isolinien des
Potentials [
-MOSFET: Isolinien des
Potentials [ ] für
] für  ,
,  .
.



