
Abbildung: Ergebnis einer dreidimensionalen Simulation: Querschnitt für y = 1
 m. Geometrie
nach Abb. 5.9
m. Geometrie
nach Abb. 5.9




Als Beispiel soll hier noch die Simulation der Implantation von Arsen in eine durch die Simulation eines anisotropen Ätzschrittes erhaltene Trenchstruktur gezeigt werden (amorphes Silizium). Die Geometrie ist in Abb. 5.9 gezeigt, die Auflösung mittels des Octrees in Abb. 5.10.

Abbildung: Ergebnis einer
dreidimensionalen Simulation: Querschnitt für y = 1  m. Geometrie
nach Abb. 5.9
m. Geometrie
nach Abb. 5.9

Abbildung: Ergebnis einer
dreidimensionalen Simulation: Querschnitt für x = 1  m. Geometrie
nach Abb. 5.9
m. Geometrie
nach Abb. 5.9
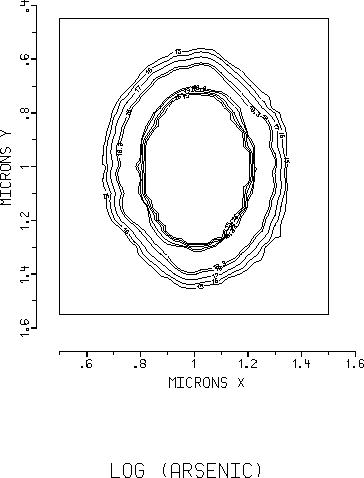
Abbildung: Ergebnis einer
dreidimensionalen Simulation: Querschnitt für z = 1.15  m.
Geometrie nach Abb. 5.9
m.
Geometrie nach Abb. 5.9

Abbildung: Ergebnis einer
dreidimensionalen Simulation von kristallinem Silizium: Querschnitt
für y = 0.0  m (in der Mitte der Geometrie). Als Teststruktur
wurde ein einfacher Siliziumwürfel angenommen.
m (in der Mitte der Geometrie). Als Teststruktur
wurde ein einfacher Siliziumwürfel angenommen.
In den Abb. 5.11 - 5.13 sind die Ergebnisse dargestellt. In Abb. 5.11 wurde der Trench in der Mitte, entlang der y/z-Ebene (vertikal) aufgeschnitten, in Abb. 5.12 entlang der x/z-Ebene (ebenfalls vertikal). Es werden Schnitte in beiden Richtungen gezeigt, weil der Trench nicht ganz rotationssymmetrisch ist (er ist in x-Richtung schmäler als in y-Richtung). In beiden Bildern kann man eine erhöhte Konzentration im Boden des Trenches sehen. Dies kommt daher, daß in den steilen Trenchflanken viel weniger Ionen stehen bleiben, weil sie dort ,,schleifender`` eintreten, als im flachen Boden. Die Ionen bleiben viel länger in der Randschicht des Trenches. Deshalb ist die Wiederaustrittswahrscheinlichkeit dort wesentlich höher als im Boden, wo die Ionen fast senkrecht zur Oberfläche eintreten und daher natürlich wesentlich schneller in das Material eindringen.
Da der Trench sehr ,,glatt`` und in Bezug auf die x/z- beziehungsweise
y/z-Ebene symmetrisch ist und für die Implantation ebenfalls
symmetrische Bedingungen angenommen wurden (Neigungswinkel des
einfallenden Ionenstrahles  , kontinuierliche Rotation der
Halbleiterprobe), sind die Profile ebenfalls sehr gleichmäßig. Diese
Symmetrie kann vor allem auch Abb. 5.13 entnommen
werden, wo der Trench parallel zur x/y-Ebene geschnitten wurde. Für
dieses Beispiel wurden 10 Millionen Teilchen in weniger als einer
halben Stunde auf einem HP 9000/735 Arbeitsplatzrechner gerechnet.
, kontinuierliche Rotation der
Halbleiterprobe), sind die Profile ebenfalls sehr gleichmäßig. Diese
Symmetrie kann vor allem auch Abb. 5.13 entnommen
werden, wo der Trench parallel zur x/y-Ebene geschnitten wurde. Für
dieses Beispiel wurden 10 Millionen Teilchen in weniger als einer
halben Stunde auf einem HP 9000/735 Arbeitsplatzrechner gerechnet.
Es soll hier noch darauf hingewiesen werden, daß in diesem Beispiel keine wirklich realistische Struktur behandelt wurde. Es sollte nur die prinzipielle Möglichkeit der Kopplung mit einem Topographiesimulator demonstriert werden. Die gekoppelte Simulation einer realistischen MOS-Transistor Struktur wird noch in Abschnitt 6.6 gezeigt.
In Abb. 5.14 ist ein Ergebnis einer kristallinen Simulation zu sehen. Es wurde Bor mit 100 keV in einen Siliziumblock implantiert, der mit einer dünnen Oxyd-Schicht (10nm) überzogen ist.
In diesem Bild (Abb. 5.14) ist ein Schnitt an der
Stelle des Eindringens des Ionenstrahles in den Siliziumblock gezeigt.
Die mittlere Eindringtiefe ist mit ungefähr 0.6 m wesentlich
höher als im amorphen Fall (etwa 0.32
m wesentlich
höher als im amorphen Fall (etwa 0.32  m). Es ist die
Punktantwort für eine Implantation in der Mitte des Targets
dargestellt. Die Punktantwort wurde aber vollkommen dreidimensional
- sowohl die Trajektorien selbst als auch die Geometrieabfragen -
gerechnet. Ein echt mehrdimensionales Beispiel (auch von der
Geometrie) wird in Abschnitt 6.7 gerechnet.
m). Es ist die
Punktantwort für eine Implantation in der Mitte des Targets
dargestellt. Die Punktantwort wurde aber vollkommen dreidimensional
- sowohl die Trajektorien selbst als auch die Geometrieabfragen -
gerechnet. Ein echt mehrdimensionales Beispiel (auch von der
Geometrie) wird in Abschnitt 6.7 gerechnet.



