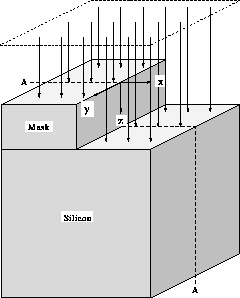
Abbildung 6.32: Geometrie mit einer einfachen Oxydmaske für das kristalline Modul.




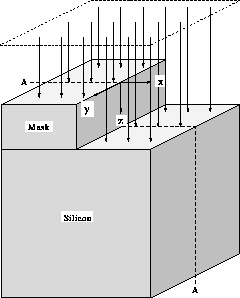
Abbildung 6.32: Geometrie mit einer
einfachen Oxydmaske für das kristalline Modul.
In diesem Abschnitt soll das Ergebnis der Simulation von kristallinem
Silizium, das teilweise maskiert ist, erörtert werden. Die Geometrie
ist in Abb. 6.32 gezeigt. Sie besteht aus einem
Siliziumblock mit einer einfachen Oxyd-Maske. Die Maske ist 0.5
 m dick. Es wurde die Implantation von Bor mit einer Energie von
30 keV simuliert.
m dick. Es wurde die Implantation von Bor mit einer Energie von
30 keV simuliert.
Im speziellen soll hier auch auf den Unterschied bei der Implantation in kristallines und amorphes Material eingegangen werden. Daher wird zum Vergleich auch dasselbe Beispiel nur unter Annahme eines amorphen Substrats gerechnet.
Es ergibt sich eine mittlere Eindringtiefe von ungefähr 0.35  m
in das kristalline Substrat. Im Gegensatz dazu beträgt die
Eindringtiefe im Falle von amorphem Silizium nur etwa 0.15
m
in das kristalline Substrat. Im Gegensatz dazu beträgt die
Eindringtiefe im Falle von amorphem Silizium nur etwa 0.15  m. Im
kristallinen Silizium gibt es bedingt durch die Kristallstruktur
Richtungen, in denen sich die Ionen leichter fortbewegen können, weil
sie dort mit weniger Targetatomen kollidieren [Tho73]. Bewegt
sich ein Ion in so einem Kanal, so wird das als ,,Channeling``
bezeichnet. Die Erhöhung der Eindringtiefe heißt also, daß das
Channeling eine nicht zu vernachlässigende Erhöhung der mittleren
Eindringtiefe bedingt.
m. Im
kristallinen Silizium gibt es bedingt durch die Kristallstruktur
Richtungen, in denen sich die Ionen leichter fortbewegen können, weil
sie dort mit weniger Targetatomen kollidieren [Tho73]. Bewegt
sich ein Ion in so einem Kanal, so wird das als ,,Channeling``
bezeichnet. Die Erhöhung der Eindringtiefe heißt also, daß das
Channeling eine nicht zu vernachlässigende Erhöhung der mittleren
Eindringtiefe bedingt.
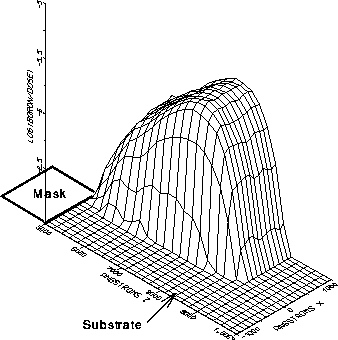
Abbildung: Borkonzentration bezogen auf implantierte Dosis nach Implantation
mit 30 keV in die kristalline Struktur nach
Abb. 6.32; Schnitt entlang A - A. Deutlich kann
die erhöhte Eindringtiefe in das kristalline Substrate gegenüber dem
amorphen Substrat (Abb. 6.34) gesehen werden.
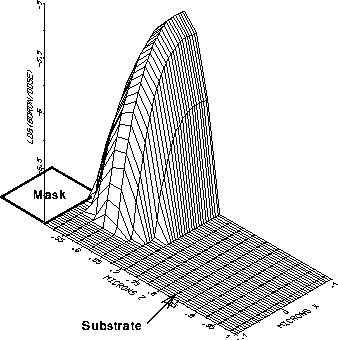
Abbildung 6.34: Borkonzentration für dasselbe Beispiel wie oben
(Abb. 6.33), nur für amorphes Substrat; deutlich
kann die geringere Eindringtiefe gesehen werden.
In der Realität wird allerdings die Eindringtiefe geringer sein, als durch das kristalline Modell vorhergesagt. Durch das Ionen-Bombardment wird der Kristall zunehmend zerstört, das heißt amorphisiert, und die Kanäle, in denen sich die Ionen leichter fortbewegen können, verschwinden. Die transiente Amorphisierung wurde im Rahmen dieser Arbeit nicht untersucht.
Die Ergebnisse sind in Abb. 6.33 und in
Abb. 6.34 für einen Querschnitt normal zur
y-Achse dargestellt (siehe Abb. 6.32, A-A). Die
Bor-Konzentration ist hier jeweils in 1/ m
m auf eine Dosis von
1/cm
auf eine Dosis von
1/cm normiert dargestellt. Der Implantationswinkel beträgt
normiert dargestellt. Der Implantationswinkel beträgt
 .
.
Im ersten Bild (Abb. 6.33) kann man deutlich
sehen, daß die Ionen im Vergleich zum amorphen Substrat
(Abb. 6.34) in das kristalline Silizium weiter
eindringen. Die Oberfläche des Substrates liegt bei 5.000 Å, die
mittlere Eindringtiefe ergibt sich aus statistischen Berechnungen
(Mittelwert der Differenz der z-Koordinate der Anfangs- und Endpunkte
der Trajektorien) zu ungefähr 0.35  m.
m.
In Abb 6.34 ist derselbe Querschnitt (A-A)
Abb. 6.32 für konstantes y dargestellt. Die
Längeneinheiten sind hier  m (=10
m (=10 Å). Die Oberfläche
liegt also bei 0.5
Å). Die Oberfläche
liegt also bei 0.5  m und wie man der Abb 6.33
entnehmen kann, liegt die mittlere Eindringtiefe ungefähr bei 0.15
m und wie man der Abb 6.33
entnehmen kann, liegt die mittlere Eindringtiefe ungefähr bei 0.15
 m.
m.



