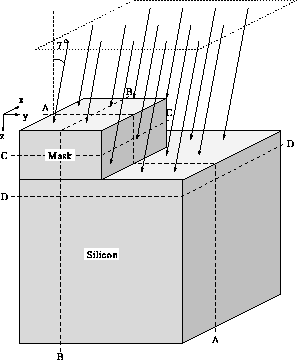
Abbildung 6.6: Struktur mit einer einfachen Oxydmaske.




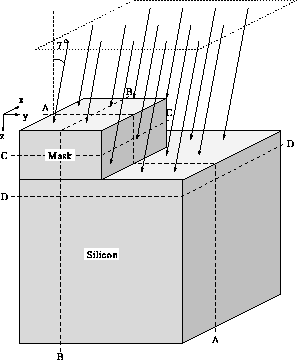
Abbildung 6.6: Struktur mit einer einfachen Oxydmaske.

Abbildung 6.7: Explosionszeichnung des Octrees für die Teststruktur aus
Abb. 6.6 mit einer einfachen Oxydmaske. Zu beachten
ist, daß die Struktur automatisch auf einen Würfel ergänzt wird.
Dieser Teil bildet das Vakuumgebiet.
In diesem Abschnitt wird ein einfaches Beispiel mit dem Modul für
allgemeine dreidimensionale Strukturen gerechnet. Die Geometrie ist in
Abb. 6.6 gezeigt und besteht aus einem
Silizium-Substrat-Block und einer darauf aufgesetzten einfachen Maske
aus SiO . Es wird Phosphor mit 80 keV unter einem
Implantationswinkel von
. Es wird Phosphor mit 80 keV unter einem
Implantationswinkel von  implantiert.
implantiert.
In einer Explosionszeichnung ist in Abb. 6.7 die Diskretisierung der Geometrie aus Abb. 6.6 mittels des Octrees dargestellt. Dabei wurden die drei Einzelgebiete - nämlich das Substrat, die Oxydmaske und das Vakuumgebiet - einzeln dargestellt. Zu beachten ist, daß das Vakuumgebiet in Abb. 6.7 automatisch generiert wird, und zwar so, daß sich ein Würfel ergibt, der die gesamte spezifizierte Geometrie enthält. Das ist notwendig, damit der Octree überhaupt verwendet werden kann.
Die Ergebnisse sind in den
Abbildungen 6.8 - 6.11
zu sehen. Bei einer Implantation mit einem Implantationswinkel von
 zeigen diese Querschnitte aufgrund der sonst gleichen
Bedingungen (gleiche Abmessungen in x- und y-Richtung) auch identische
Ergebnisse. Im hier gezeigten Beispiel gibt es aber Unterschiede im
strichliert eingerahmten Bereich, weil unter einem Winkel von
zeigen diese Querschnitte aufgrund der sonst gleichen
Bedingungen (gleiche Abmessungen in x- und y-Richtung) auch identische
Ergebnisse. Im hier gezeigten Beispiel gibt es aber Unterschiede im
strichliert eingerahmten Bereich, weil unter einem Winkel von
 implantiert wird. Dieser Unterschied in
Abb. 6.8 und Abb. 6.9 bei der
vertikalen Koordinate zwischen 1.0 und 1.5
implantiert wird. Dieser Unterschied in
Abb. 6.8 und Abb. 6.9 bei der
vertikalen Koordinate zwischen 1.0 und 1.5  m und einer vertikalen
Koordinate von ungefähr 2.4
m und einer vertikalen
Koordinate von ungefähr 2.4  m kommt davon, daß die Implantation
nur gegen die x/z-Ebene geneigt ist. Daher dringen die Ionen in die
Seitenflanke der Maske in y-Richtung weiter ein als in x-Richtung.
Durch die Neigung des einfallenden Ionenstrahles ist aber auch die
laterale Erweiterung des Implantationsprofiles unter der Maske auf der
Seite parallel zur x-Achse größer als auf der anderen.
m kommt davon, daß die Implantation
nur gegen die x/z-Ebene geneigt ist. Daher dringen die Ionen in die
Seitenflanke der Maske in y-Richtung weiter ein als in x-Richtung.
Durch die Neigung des einfallenden Ionenstrahles ist aber auch die
laterale Erweiterung des Implantationsprofiles unter der Maske auf der
Seite parallel zur x-Achse größer als auf der anderen.

Abbildung: Ergebnis einer Phosphor-Implantation mit 80 keV in die Struktur
nach Abb. 6.6 und Neigungswinkel von  zur
x/z-Ebene; Schnitt für konstantes x (A - A).
zur
x/z-Ebene; Schnitt für konstantes x (A - A).

Abbildung: Ergebnis einer Phosphor-Implantation mit 80 keV in die Struktur
nach Abb. 6.6 und Neigungswinkel von  zur
x/z-Ebene; Schnitt für konstantes y (B - B).
zur
x/z-Ebene; Schnitt für konstantes y (B - B).

Abbildung: Ergebnis einer Phosphor-Implantation (80 keV in die Struktur
nach Abb. 6.6, Neigungswinkel  zur
x/z-Ebene); Schnitt für konstantes z in der Mitte der Maske (C -
C).
zur
x/z-Ebene); Schnitt für konstantes z in der Mitte der Maske (C -
C).
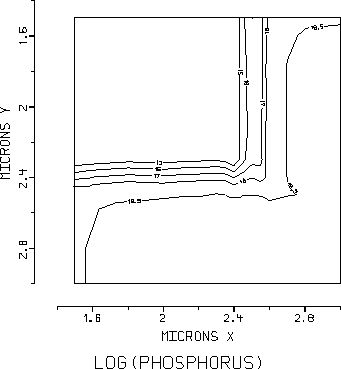
Abbildung: Ergebnis einer Phosphor-Implantation (80 keV in die Struktur
nach Abb. 6.6, Neigungswinkel  zur
x/z-Ebene); Schnitt für konstantes z im Substrat (D - D).
zur
x/z-Ebene); Schnitt für konstantes z im Substrat (D - D).
Dieser Effekt, daß die Ionen in einer Richtung lateral weiter in die
Seitenflanke des Targets eindringen als in der anderen, ist auch in
den Abb. 6.10
und 6.11 zu sehen. In
Abb. 6.10 reicht das Profil in die Maske in
einer lateralen Koordinate tiefer hinein als in der anderen -
während die Konturlinien in x-Richtung nur bis ungefähr 2.4  m
reichen, dringen die Ionen in y-Richtung bis 2.3
m
reichen, dringen die Ionen in y-Richtung bis 2.3  m ein (100 nm
tiefer). Außerdem ist eine Aufweitung des Profiles in y-Richtung
gegenüber x zu sehen. In Abb. 6.11 ist zu
sehen, daß die laterale Erweiterung des Implantationsprofiles in
x-Richtung unter der Maske geringer ist als in y-Richtung. Auch das
kommt daher, daß der einfallende Partikelstrom nur gegen die
x/z-Ebene geneigt ist. Hier zeigt sich auch die Notwendigkeit von
homogenen Bedingungen bei der Implantation, um möglichst
gleichförmige Implantationsprofile zu erhalten.
m ein (100 nm
tiefer). Außerdem ist eine Aufweitung des Profiles in y-Richtung
gegenüber x zu sehen. In Abb. 6.11 ist zu
sehen, daß die laterale Erweiterung des Implantationsprofiles in
x-Richtung unter der Maske geringer ist als in y-Richtung. Auch das
kommt daher, daß der einfallende Partikelstrom nur gegen die
x/z-Ebene geneigt ist. Hier zeigt sich auch die Notwendigkeit von
homogenen Bedingungen bei der Implantation, um möglichst
gleichförmige Implantationsprofile zu erhalten.



