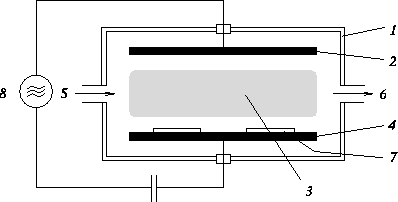
Abbildung 4.3: Aufbau eines Parallelplatten-Reaktors; 1 Vakuumkammer, 2 obere Elektrode, 3 Plasma, 4 untere Elektrode, 5 Gaseinlaß, 6 Anschluß für Vakuumpumpe, 7 Halbleiterscheiben, 8 Hochfrequenzspannung.




Am häufigsten werden heute Parallelplatten-Reaktoren eingesetzt, die je nach elektrischem Feld, Gasdruck und -art zu einem mehr chemischen oder mehr physikalischen Ätzverhalten führen. Abbildung 4.3 zeigt schematisch den Aufbau des Ätz-Reaktors.
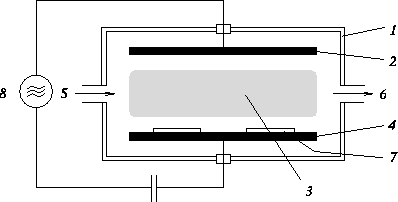
Abbildung 4.3: Aufbau eines Parallelplatten-Reaktors; 1 Vakuumkammer, 2 obere
Elektrode, 3 Plasma, 4 untere Elektrode, 5 Gaseinlaß, 6 Anschluß für
Vakuumpumpe, 7 Halbleiterscheiben, 8 Hochfrequenzspannung.
Er besteht aus einer Vakuumkammer mit Einlaß für das Ätzgas, einem
Anschluß für die Vakuumpumpe und zwei parallelen Elektroden. Die zu
ätzenden Halbleiterscheiben befinden sich auf einer der beiden Elektroden.
Dem vorher evakuierten Reaktor wird ein geeignetes Ätzgas (Verbindungen der
Halogene  ,
,  und
und  ) zugeführt. Druck und Flußrate des Ätzgases
werden konstant gehalten. Durch eine angelegte Hochfrequenzspannung wird das
Gas zwischen den Elektroden zur Glimmentladung gebracht. Es entsteht ein
Niederdruck-, Niedertemperaturplasma mit Ionen, Elektronen und angeregten
neutralen Teilchen (Radikale).
) zugeführt. Druck und Flußrate des Ätzgases
werden konstant gehalten. Durch eine angelegte Hochfrequenzspannung wird das
Gas zwischen den Elektroden zur Glimmentladung gebracht. Es entsteht ein
Niederdruck-, Niedertemperaturplasma mit Ionen, Elektronen und angeregten
neutralen Teilchen (Radikale).
Reaktives Ionenätzen und Plasmaätzen unterscheiden sich vor allem durch die Art der Ankopplung der Hochfrequenzspannung (Abbildung 4.4). Beim Plasmaätzen im Parallelplatten-Reaktor ist die Hochfrequenzspannung kapazitiv an die obere Elektrode gekoppelt. Die untere Elektrode ist mit der Vakuumkammer verbunden und geerdet.
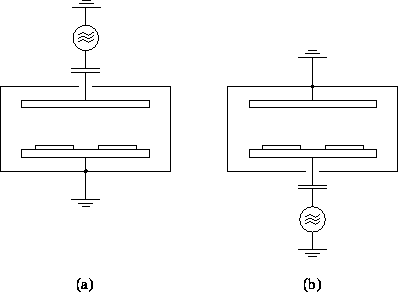
Abbildung 4.4: Unterschied zwischem (a) Plasmaätzen im Parallelplatten-Reaktor und (b) reaktivem Ionenätzen.
Zusammen mit der Kammer bildet die untere Elektrode eine größere Oberfläche als die obere Elektrode. Da das elektrische Potential an den Elektroden umgekehrt proportional zur vierten Potenz der Elektrodenflächen ist [Wid88], wird die obere Elektrode stärker negativ aufgeladen als die untere. Auf die relativ langsamen Ionen wirkt das zeitlich gemittelte elektrische Potential, dessen Verlauf in Abbildung 4.5 dargestellt wird.
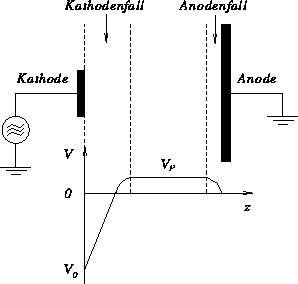
Abbildung 4.5: Zeitlich gemitteltes elektrisches Potential.
Die Ionen, die die zu ätzenden Halbleiterscheiben auf der unteren Elektrode
erreichen, haben in diesem Fall daher eine relativ geringe
kinetische Energie ( ). Aufgrund des hohen Gasdruckes
(
). Aufgrund des hohen Gasdruckes
( ) erleiden die Ionen auf ihrem Weg zu der zu ätzenden
Oberfläche Stöße von Atomen und Molekülen, wodurch die Ionenenergie
weiter verringert wird. Die Energie der Ionen ist häufig so gering,
daß der Prozeß hauptsächlich isotropen Charakter aufweist.
) erleiden die Ionen auf ihrem Weg zu der zu ätzenden
Oberfläche Stöße von Atomen und Molekülen, wodurch die Ionenenergie
weiter verringert wird. Die Energie der Ionen ist häufig so gering,
daß der Prozeß hauptsächlich isotropen Charakter aufweist.
Beim reaktiven Ionenätzen ist die Hochfrequenzspannung kapazitiv an die
untere Elektrode gekoppelt. Sie hat somit im Vergleich zur geerdeten oberen
Elektrode die kleinere Oberfläche und nimmt deshalb ein höheres
elektrisches Potential an. Der Gasdruck wird bei diesem Betriebsfall
niedriger gewählt ( ), wodurch Stoßprozesse weitgehend
vermieden werden. Die Ionen erreichen die Halbleiterscheiben mit relativ
hoher kinetischer Energie (einige
), wodurch Stoßprozesse weitgehend
vermieden werden. Die Ionen erreichen die Halbleiterscheiben mit relativ
hoher kinetischer Energie (einige  ) und können dort eine
chemischen Ätzreaktion auslösen oder verstärken. Zusätzlich kann eine
physikalische Ätzreaktion hervorgerufen werden.
) und können dort eine
chemischen Ätzreaktion auslösen oder verstärken. Zusätzlich kann eine
physikalische Ätzreaktion hervorgerufen werden.



