2.4.2 Impact of the Gate Depletion on MOSFET Characteristics




Next: 2.4.3 Analytical Estimation of
Up: 2.4 Numerical Modeling and
Previous: 2.4.1 Modeling of MOSFETs
Our numerical model is applied to study the performance of thin-oxide
submicrometer MOSFETs with an (implanted) nondegenerate gate. In the first
example we analyze the threshold voltage instabilities due to gate depletion
in a small 
 -gate/
-gate/ -channel device with very thin oxide
-channel device with very thin oxide
 . The device has an ideal threshold voltage of
. The device has an ideal threshold voltage of  and
is designed for room-temperature operation. Implanted source and drain
profiles are reconstructed from the data in the
literature [512][351][93][60] (see
also [472][301]). We simulated static characteristics in the
linear and the saturation region, transconductance, breakdown voltage and
threshold-voltage variation with channel metallurgical length for this device.
The results correspond to typical values reported for such experimental devices
in literature. Possible B-penetration in
and
is designed for room-temperature operation. Implanted source and drain
profiles are reconstructed from the data in the
literature [512][351][93][60] (see
also [472][301]). We simulated static characteristics in the
linear and the saturation region, transconductance, breakdown voltage and
threshold-voltage variation with channel metallurgical length for this device.
The results correspond to typical values reported for such experimental devices
in literature. Possible B-penetration in  -gate devices is neglected in
this study (Section 2.1.2). The numerically calculated
threshold voltage
-gate devices is neglected in
this study (Section 2.1.2). The numerically calculated
threshold voltage  and the voltage drop in the gate in the middle of
the channel
and the voltage drop in the gate in the middle of
the channel  are presented in Figure 2.15, with the
fixed charge at the gate/oxide interface
are presented in Figure 2.15, with the
fixed charge at the gate/oxide interface  being a parameter. As already
shown in Figure 2.5, a positive
being a parameter. As already
shown in Figure 2.5, a positive  reduces threshold
voltage increasing due to factor
reduces threshold
voltage increasing due to factor  in
in  -gate/
-gate/ -channel devices.
However, in
-channel devices.
However, in  -gate/
-gate/ -channel devices, a positive
-channel devices, a positive  increases
increases  and consequently,
and consequently,  becomes larger because of an increased
becomes larger because of an increased  .
Moreover, the threshold voltage sensitivity with respect to the activated
impurity concentration
.
Moreover, the threshold voltage sensitivity with respect to the activated
impurity concentration  increases with presence of a positive
increases with presence of a positive  in
in  -gate/
-gate/ -channel devices, as shown in Figure 2.15.
Contrary to
-channel devices, as shown in Figure 2.15.
Contrary to  -gate/
-gate/ -channel devices in conventional
-channel devices in conventional  -gate/
-gate/ -channel
devices the gate enters into accumulation and the influence of lowering
-channel
devices the gate enters into accumulation and the influence of lowering  and positive
and positive  on the threshold voltage
on the threshold voltage  is much weaker.
Note that B-penetration would shift
is much weaker.
Note that B-penetration would shift  to more positive values in
Figure 2.15 as opposed to a roll-off in
to more positive values in
Figure 2.15 as opposed to a roll-off in  due to
gate depletion.
due to
gate depletion.
Figure 2.16 shows the distributions of potential,
electric field strength and carrier concentration in a small
 -gate/
-gate/ -channel device, including gate, oxide and bulk area. A device
with
-channel device, including gate, oxide and bulk area. A device
with  , very thin oxide of
, very thin oxide of  and
and  is designed according to data for the technological processes,
multiple-implanted doping profiles and terminal characteristics in the
literature [512][394][393][351][93][60].
Because of the thin oxide (
is designed according to data for the technological processes,
multiple-implanted doping profiles and terminal characteristics in the
literature [512][394][393][351][93][60].
Because of the thin oxide ( ), the moderate doping in the gate
(
), the moderate doping in the gate
( ) and the high gate bias (
) and the high gate bias ( ) a remarkable potential
drop occurs in the gate. The effective gate bias at the source
channel-end
) a remarkable potential
drop occurs in the gate. The effective gate bias at the source
channel-end  is reduced by
is reduced by  or about
or about  .
.

When  is small, the gate-bias reduction
is small, the gate-bias reduction  is uniform along
the channel. In saturation, the fields
is uniform along
the channel. In saturation, the fields  and
and  reduce when going from
source towards the drain
reduce when going from
source towards the drain

channel-end.  decreases along the
gate/oxide interface. As a consequence, one may expect that the gate-depletion
effect becomes less important in the saturation than in the linear region; for
instance a reduction in
decreases along the
gate/oxide interface. As a consequence, one may expect that the gate-depletion
effect becomes less important in the saturation than in the linear region; for
instance a reduction in  should be smaller in the saturation
region than that in the linear region. However, a careful analysis shows that
different effects take place which tend to cancel each other out. These effects
are discussed in the following, applying the results known from analytical
MOSFET modeling and supporting the conclusions by numerical simulation
necessary for such short-channel devices.
should be smaller in the saturation
region than that in the linear region. However, a careful analysis shows that
different effects take place which tend to cancel each other out. These effects
are discussed in the following, applying the results known from analytical
MOSFET modeling and supporting the conclusions by numerical simulation
necessary for such short-channel devices.
The potential distribution along the channel in an MOSFET is a concave function
of the  -coordinate. Let us denote
-coordinate. Let us denote  the channel potential due to
nonzero
the channel potential due to
nonzero  with respect to potential in the source at the gate edge. In
short-channel MOS transistors the channel potential
with respect to potential in the source at the gate edge. In
short-channel MOS transistors the channel potential  is a slowly varying
function of the
is a slowly varying
function of the  -coordinate in the source channel-part and increases rapidly
when approaching the characteristic pinch-off point (where
-coordinate in the source channel-part and increases rapidly
when approaching the characteristic pinch-off point (where
 increases enormously, [204]). In contrast,
in long-channel MOSFETs
increases enormously, [204]). In contrast,
in long-channel MOSFETs  increases with a moderate slope along the whole
channel. Such a peculiarity of
increases with a moderate slope along the whole
channel. Such a peculiarity of  in short-channel devices is a
direct consequence of the non-linearity and saturation in the
in short-channel devices is a
direct consequence of the non-linearity and saturation in the  relationship [162][161]. Therefore,
relationship [162][161]. Therefore,  decreases weakly
from its maximal value at the source-side when approaching the pinch-off point
near the drain-side, as can be seen on the potential and field distributions in
the gate shown in Figure 2.16. In this example, we employed a
standard drift-diffusion transport model with
decreases weakly
from its maximal value at the source-side when approaching the pinch-off point
near the drain-side, as can be seen on the potential and field distributions in
the gate shown in Figure 2.16. In this example, we employed a
standard drift-diffusion transport model with  for Si and obtain
for Si and obtain
 and
and  in the middle of the channel (
in the middle of the channel ( ).
Simulating the same example, but without accounting for the drift velocity
saturation (constant mobility) is equivalent to assuming a classical
long-channel MOSFET theory. In the latter case we obtain
).
Simulating the same example, but without accounting for the drift velocity
saturation (constant mobility) is equivalent to assuming a classical
long-channel MOSFET theory. In the latter case we obtain  and
and
 at the middle of the channel for the same device.
These numerical results are consistent with our preceding discussion. In both,
the ``long'' and the short-channel device,
at the middle of the channel for the same device.
These numerical results are consistent with our preceding discussion. In both,
the ``long'' and the short-channel device,  and
and  are
approximately the same at the source and drain-end of the channel, but they
differ within the channel due to linear and non-linear
are
approximately the same at the source and drain-end of the channel, but they
differ within the channel due to linear and non-linear  relations.
According to this finding the degradation of
relations.
According to this finding the degradation of  in saturation should be
lower, but close to that in the linear region, since depletion occurs in a
significant part of the gate for transistors biased in saturation.
in saturation should be
lower, but close to that in the linear region, since depletion occurs in a
significant part of the gate for transistors biased in saturation.
Figures 2.17 and 2.18 display the
numerically calculated drain current in linear and saturation region for the
 -gate/
-gate/ -channel device, with activated concentration in the gate as
parameter. The numerical calculation is carried out employing the classical
drift-diffusion model with parameters for the field-dependent mobility as
in [417], being aware of all shortcomings of such an approach to
simulate
-channel device, with activated concentration in the gate as
parameter. The numerical calculation is carried out employing the classical
drift-diffusion model with parameters for the field-dependent mobility as
in [417], being aware of all shortcomings of such an approach to
simulate  -devices biased in saturation. Calculations show that
the reduction of
-devices biased in saturation. Calculations show that
the reduction of  is always larger in the saturation than in the linear
region, contrary to our previous conclusion.
is always larger in the saturation than in the linear
region, contrary to our previous conclusion.
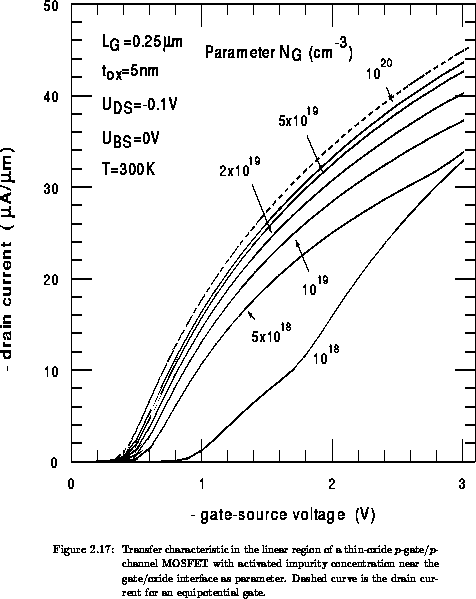
To explain this finding remember that the drain current is given by

with  representing the inversion-layer charge and
representing the inversion-layer charge and  an average
drift velocity across the inversion layer at the coordinate
an average
drift velocity across the inversion layer at the coordinate  . It is known
that
. It is known
that  close to the source channel-end, denoted as
close to the source channel-end, denoted as  , is the main
quantity depending on
, is the main
quantity depending on  which determines the drain current in a
short-channel MOSFET. G.C.A. is best fulfilled at the source channel-end.
On the other hand the drift velocity at the source channel-end
which determines the drain current in a
short-channel MOSFET. G.C.A. is best fulfilled at the source channel-end.
On the other hand the drift velocity at the source channel-end  depends primarily on the drain-source bias
depends primarily on the drain-source bias  . In the linear region,
. In the linear region,
 holds, where
holds, where  is the low-field
surface mobility dependent on the transversal field
is the low-field
surface mobility dependent on the transversal field 
 . The lowering of
. The lowering of  is determined by the
product
is determined by the
product  . Gate depletion reduces
. Gate depletion reduces  , but leads
to an increase in
, but leads
to an increase in  , since the depletion in the gate reduces
, since the depletion in the gate reduces

 . The latter effect cancels the lowering
of
. The latter effect cancels the lowering
of  due to
due to  in a significant amount.
in a significant amount.
This explanation correlates with the numerical calculation carried out assuming
a surface mobility independent of the perpendicular field  . For example in
Figure 2.17 we obtain the relative
. For example in
Figure 2.17 we obtain the relative  reduction of
reduction of
 ,
,  and
and  for
for  ,
,  and
and
 at
at  ,
,  , respectively. In
Figure 2.17, the corresponding reduction was
, respectively. In
Figure 2.17, the corresponding reduction was  ,
,  and
and  , respectively. The differences between these two data sets arise
due to the
, respectively. The differences between these two data sets arise
due to the  effect.
effect.
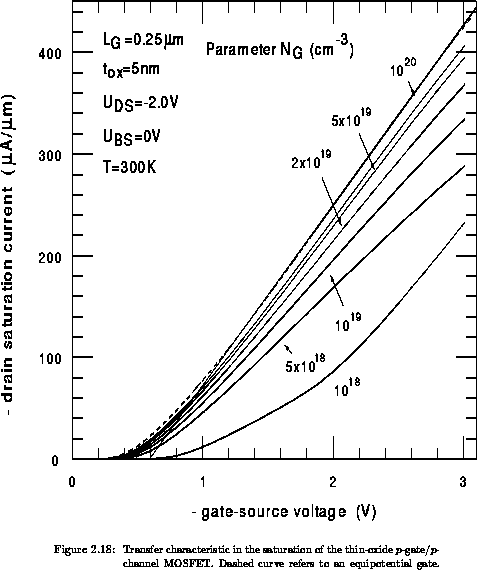
In the saturation region,  approaches the non-linear part of the
approaches the non-linear part of the
 relationship in our device. It is accepted that the saturation
velocity
relationship in our device. It is accepted that the saturation
velocity  does not change with the transversal field, which is also
assumed in the mobility model employed in the numerical simulation. The drift
velocity at the source channel-end
does not change with the transversal field, which is also
assumed in the mobility model employed in the numerical simulation. The drift
velocity at the source channel-end  is slightly affected by
is slightly affected by  through the weak dependence
through the weak dependence  . In short-channel transistors, the
variation of
. In short-channel transistors, the
variation of  with
with  is small in the saturation region due to the
non-linearity and the saturation in the
is small in the saturation region due to the
non-linearity and the saturation in the  relation. Remember that this
effect leads to linearization in the transfer characteristic and the saturation
of transconductance in the saturation region. Moreover,
relation. Remember that this
effect leads to linearization in the transfer characteristic and the saturation
of transconductance in the saturation region. Moreover,  is practically
independent of the gate bias at the source channel-end. As a conclusion, the
lowering of
is practically
independent of the gate bias at the source channel-end. As a conclusion, the
lowering of  in saturation is for the most part determined by the large
reduction in
in saturation is for the most part determined by the large
reduction in  . This is compensated with a slight increase in
. This is compensated with a slight increase in  (
( to
to  in our example) which represents a second order effect.
Employing the analytical model from Section 2.2 to a
MOS capacitor which is equivalent to our
in our example) which represents a second order effect.
Employing the analytical model from Section 2.2 to a
MOS capacitor which is equivalent to our  -gate/
-gate/ -channel device, the
degradation in
-channel device, the
degradation in  is calculated to be
is calculated to be  ,
,  and
and  for
for
 ,
,  and
and  at
at  ,
respectively
,
respectively .
These results should be compared with the lowering of
.
These results should be compared with the lowering of  in Figure 2.18:
in Figure 2.18:  ,
,  and
and  for the same
impurity concentrations in the gate, respectively. In addition, distributions
of the surface electron concentration
for the same
impurity concentrations in the gate, respectively. In addition, distributions
of the surface electron concentration  resulting from the numerical
calculation confirm the above conclusion.
resulting from the numerical
calculation confirm the above conclusion.
In general, the degradation of  is larger than the reduction of
is larger than the reduction of  in
saturation, while the latter effect is larger than lowering of
in
saturation, while the latter effect is larger than lowering of  in linear
region.
in linear
region.
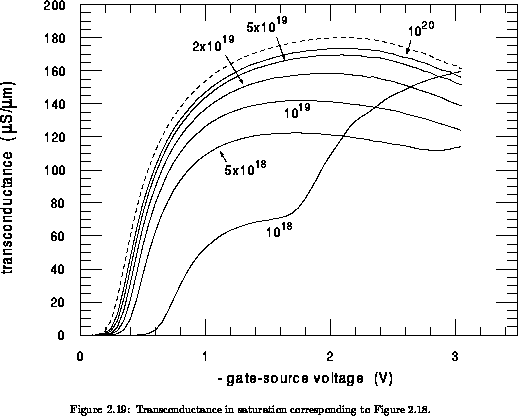
A high concentration of holes in the gate close to the source-sided gate corner
may be observed in the 2D distribution shown in Figure 2.16.
For this device the inversion in the gate takes place at  beginning at the corner. This effect produces a recovery of transconductance
to the value for equipotential-gate device, as shown in
Figure 2.19 and reported in experiments [281][226].
The gate inversion is responsible for the eccentricity in the characteristics
in Figures 2.17 and 2.18, as well.
Note that the maximum transconductance of
beginning at the corner. This effect produces a recovery of transconductance
to the value for equipotential-gate device, as shown in
Figure 2.19 and reported in experiments [281][226].
The gate inversion is responsible for the eccentricity in the characteristics
in Figures 2.17 and 2.18, as well.
Note that the maximum transconductance of  is much lower than
the ideal limit of
is much lower than
the ideal limit of  for the device
in Figure 2.19
for the device
in Figure 2.19  .
.
With regard to the influence of the charge at the gate/oxide interface  on the drain current, the numerical study has provided the result which is
consistent with that obtained for
on the drain current, the numerical study has provided the result which is
consistent with that obtained for  ; see Figure 2.6.
One family of the transfer characteristic is presented in [163].
Here we only repeat that
; see Figure 2.6.
One family of the transfer characteristic is presented in [163].
Here we only repeat that  has a second order influence on
has a second order influence on  and
that
and
that  is the main parameter determining the degradation.
is the main parameter determining the degradation.




Next: 2.4.3 Analytical Estimation of
Up: 2.4 Numerical Modeling and
Previous: 2.4.1 Modeling of MOSFETs
Martin Stiftinger
Sat Oct 15 22:05:10 MET 1994

 -gate/
-gate/ -channel device with very thin oxide
-channel device with very thin oxide
 . The device has an ideal threshold voltage of
. The device has an ideal threshold voltage of  and
is designed for room-temperature operation. Implanted source and drain
profiles are reconstructed from the data in the
literature [512][351][93][60] (see
also [472][301]). We simulated static characteristics in the
linear and the saturation region, transconductance, breakdown voltage and
threshold-voltage variation with channel metallurgical length for this device.
The results correspond to typical values reported for such experimental devices
in literature. Possible B-penetration in
and
is designed for room-temperature operation. Implanted source and drain
profiles are reconstructed from the data in the
literature [512][351][93][60] (see
also [472][301]). We simulated static characteristics in the
linear and the saturation region, transconductance, breakdown voltage and
threshold-voltage variation with channel metallurgical length for this device.
The results correspond to typical values reported for such experimental devices
in literature. Possible B-penetration in  -gate devices is neglected in
this study (Section 2.1.2). The numerically calculated
threshold voltage
-gate devices is neglected in
this study (Section 2.1.2). The numerically calculated
threshold voltage  and the voltage drop in the gate in the middle of
the channel
and the voltage drop in the gate in the middle of
the channel  are presented in Figure 2.15, with the
fixed charge at the gate/oxide interface
are presented in Figure 2.15, with the
fixed charge at the gate/oxide interface  being a parameter. As already
shown in Figure 2.5, a positive
being a parameter. As already
shown in Figure 2.5, a positive  reduces threshold
voltage increasing due to factor
reduces threshold
voltage increasing due to factor  in
in  -gate/
-gate/ -channel devices.
However, in
-channel devices.
However, in  -gate/
-gate/ -channel devices, a positive
-channel devices, a positive  increases
increases  and consequently,
and consequently,  becomes larger because of an increased
becomes larger because of an increased  .
Moreover, the threshold voltage sensitivity with respect to the activated
impurity concentration
.
Moreover, the threshold voltage sensitivity with respect to the activated
impurity concentration  increases with presence of a positive
increases with presence of a positive  in
in  -gate/
-gate/ -channel devices, as shown in Figure 2.15.
Contrary to
-channel devices, as shown in Figure 2.15.
Contrary to  -gate/
-gate/ -channel devices in conventional
-channel devices in conventional  -gate/
-gate/ -channel
devices the gate enters into accumulation and the influence of lowering
-channel
devices the gate enters into accumulation and the influence of lowering  and positive
and positive  on the threshold voltage
on the threshold voltage  is much weaker.
Note that B-penetration would shift
is much weaker.
Note that B-penetration would shift  to more positive values in
Figure 2.15 as opposed to a roll-off in
to more positive values in
Figure 2.15 as opposed to a roll-off in  due to
gate depletion.
due to
gate depletion.




 is designed according to data for the technological processes,
multiple-implanted doping profiles and terminal characteristics in the
literature
is designed according to data for the technological processes,
multiple-implanted doping profiles and terminal characteristics in the
literature  ), the moderate doping in the gate
(
), the moderate doping in the gate
( ) and the high gate bias (
) and the high gate bias ( ) a remarkable potential
drop occurs in the gate. The effective gate bias at the source
channel-end
) a remarkable potential
drop occurs in the gate. The effective gate bias at the source
channel-end  is reduced by
is reduced by  or about
or about  .
.

 is small, the gate-bias reduction
is small, the gate-bias reduction  is uniform along
the channel. In saturation, the fields
is uniform along
the channel. In saturation, the fields  and
and 
 decreases along the
gate/oxide interface. As a consequence, one may expect that the gate-depletion
effect becomes less important in the saturation than in the linear region; for
instance a reduction in
decreases along the
gate/oxide interface. As a consequence, one may expect that the gate-depletion
effect becomes less important in the saturation than in the linear region; for
instance a reduction in  should be smaller in the saturation
region than that in the linear region. However, a careful analysis shows that
different effects take place which tend to cancel each other out. These effects
are discussed in the following, applying the results known from analytical
MOSFET modeling and supporting the conclusions by numerical simulation
necessary for such short-channel devices.
should be smaller in the saturation
region than that in the linear region. However, a careful analysis shows that
different effects take place which tend to cancel each other out. These effects
are discussed in the following, applying the results known from analytical
MOSFET modeling and supporting the conclusions by numerical simulation
necessary for such short-channel devices.
 -coordinate. Let us denote
-coordinate. Let us denote  the channel potential due to
nonzero
the channel potential due to
nonzero  increases enormously,
increases enormously,  relationship
relationship  decreases weakly
from its maximal value at the source-side when approaching the pinch-off point
near the drain-side, as can be seen on the potential and field distributions in
the gate shown in Figure
decreases weakly
from its maximal value at the source-side when approaching the pinch-off point
near the drain-side, as can be seen on the potential and field distributions in
the gate shown in Figure  for Si and obtain
for Si and obtain
 and
and  in the middle of the channel (
in the middle of the channel ( ).
Simulating the same example, but without accounting for the drift velocity
saturation (constant mobility) is equivalent to assuming a classical
long-channel MOSFET theory. In the latter case we obtain
).
Simulating the same example, but without accounting for the drift velocity
saturation (constant mobility) is equivalent to assuming a classical
long-channel MOSFET theory. In the latter case we obtain  and
and
 at the middle of the channel for the same device.
These numerical results are consistent with our preceding discussion. In both,
the ``long'' and the short-channel device,
at the middle of the channel for the same device.
These numerical results are consistent with our preceding discussion. In both,
the ``long'' and the short-channel device,  -devices biased in saturation. Calculations show that
the reduction of
-devices biased in saturation. Calculations show that
the reduction of 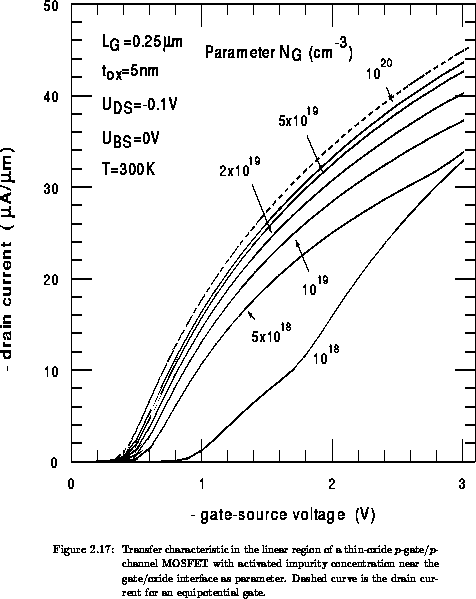

 representing the inversion-layer charge and
representing the inversion-layer charge and  an average
drift velocity across the inversion layer at the coordinate
an average
drift velocity across the inversion layer at the coordinate  close to the source channel-end, denoted as
close to the source channel-end, denoted as  , is the main
quantity depending on
, is the main
quantity depending on  which determines the drain current in a
short-channel MOSFET. G.C.A. is best fulfilled at the source channel-end.
On the other hand the drift velocity at the source channel-end
which determines the drain current in a
short-channel MOSFET. G.C.A. is best fulfilled at the source channel-end.
On the other hand the drift velocity at the source channel-end  depends primarily on the drain-source bias
depends primarily on the drain-source bias  holds, where
holds, where  is the low-field
surface mobility dependent on the transversal field
is the low-field
surface mobility dependent on the transversal field 
 . Gate depletion reduces
. Gate depletion reduces  ,
,  and
and  for
for  ,
,  and
and
 at
at  ,
,  , respectively. In
Figure
, respectively. In
Figure  ,
,  and
and  , respectively. The differences between these two data sets arise
due to the
, respectively. The differences between these two data sets arise
due to the  effect.
effect.
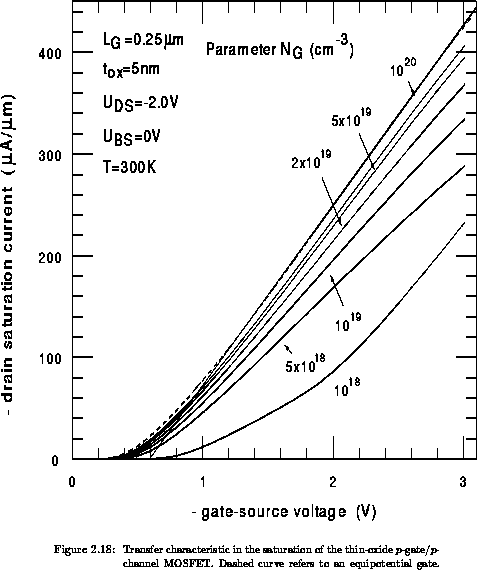
 does not change with the transversal field, which is also
assumed in the mobility model employed in the numerical simulation. The drift
velocity at the source channel-end
does not change with the transversal field, which is also
assumed in the mobility model employed in the numerical simulation. The drift
velocity at the source channel-end  . In short-channel transistors, the
variation of
. In short-channel transistors, the
variation of  is small in the saturation region due to the
non-linearity and the saturation in the
is small in the saturation region due to the
non-linearity and the saturation in the  is practically
independent of the gate bias at the source channel-end. As a conclusion, the
lowering of
is practically
independent of the gate bias at the source channel-end. As a conclusion, the
lowering of  to
to  in our example) which represents a second order effect.
Employing the analytical model from Section
in our example) which represents a second order effect.
Employing the analytical model from Section  ,
,  for
for
 ,
respectively
,
respectively ,
,  and
and  for the same
impurity concentrations in the gate, respectively. In addition, distributions
of the surface electron concentration
for the same
impurity concentrations in the gate, respectively. In addition, distributions
of the surface electron concentration  resulting from the numerical
calculation confirm the above conclusion.
resulting from the numerical
calculation confirm the above conclusion.
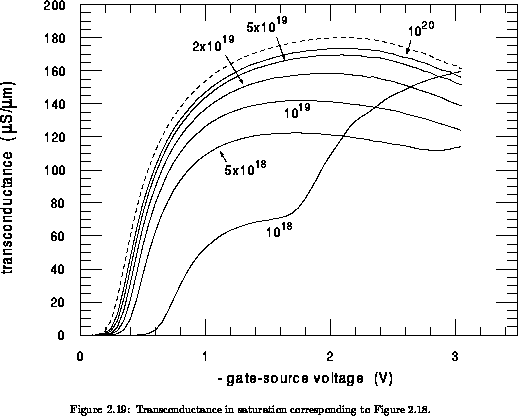
 beginning at the corner. This effect produces a recovery of transconductance
to the value for equipotential-gate device, as shown in
Figure
beginning at the corner. This effect produces a recovery of transconductance
to the value for equipotential-gate device, as shown in
Figure  is much lower than
the ideal limit of
is much lower than
the ideal limit of  for the device
in Figure
for the device
in Figure