Die Anwendbarkeit des Amorphisierungsmodelles aus Kapitel 5 demonstriert ein technologisch relevantes Beispiel. Ein LDD NMOS\ Transistor [Wol95, Wid96] wird entsprechend den folgenden Daten bei Raumtemperatur dotiert:
Abbildung 6.32 zeigt das resultierende as-implanted n-Profil. Man erkennt sehr deutlich die geringere Dotierstoffkonzentration unterhalb des Spacers und den hochdotierten Drain Bereich.
Mit Hilfe des Amorphisierungsmodelles wird nun die entstandene amorphe Schicht berechnet. Abbildung 6.33 veranschaulicht das Simulationsergebnis. Auffallend ist dabei, daß die laterale Ausdehnung der amorphen Zone kleiner ist, als die Breite des Spacers. Das erklärt sich durch die geringe laterale Eindringtiefe der Arsen-Ionen. Der LDD-Implantation reicht nämlich bei dieser Temperatur nicht aus, um das Silizium in einen amorphen Zustand überzuführen.
Wie bereits in Kapitel 2.9 erläutert, läßt sich eine kontinuierliche amorphe Schicht viel leichter durch Festphasenepitaxie in einen defektfreien Zustand überführen [Sei71b], wobei die Rekristallisierung typischerweise an der Grenzschicht zwischen kristallinem und amorphen Silizium startet. Das bedeutet, daß die Punktdefekte, die während des LDD-Implantation entstanden sind, mit höherer Wahrscheinlichkeit den nachfolgenden Ausheilschritt überleben. Bei der anschließenden Strukturierung der Spacers mittels eines CVD\ Prozesses diffundieren die Zwischengitteratome lateral unter das Gate. Da die Diffusivität des Dotierstoffes proportional zur Konzentration der Punktdefekte ist, beeinflussen sie bei der nachfolgenden Aktivierung der Source/Drain Implantationen die Verteilung der Dotierstoffatome im Kanal und sind somit eine mögliche Ursache für den ,,Reverse short channel effect`` (RSCE) [Raf93].
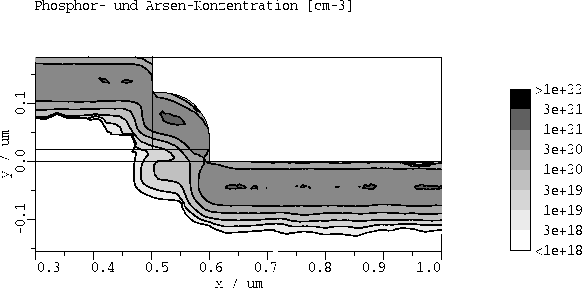
Abbildung 6.32: Resultierendes as-implanted n-Profil
eines typischen zweidimensionalen LDD Transistors nach eimem LDD-
(![]() -Ionen, 30keV,
-Ionen, 30keV, ![]() und
7
und
7![]() Kippwinkel) und Drain-Implantation (
Kippwinkel) und Drain-Implantation (![]() -Ionen, 60keV,
-Ionen, 60keV, ![]() und 7
und 7![]() \
Kippwinkel) bei einer Substrattemperatur von 296
\
Kippwinkel) bei einer Substrattemperatur von 296![]() .
.
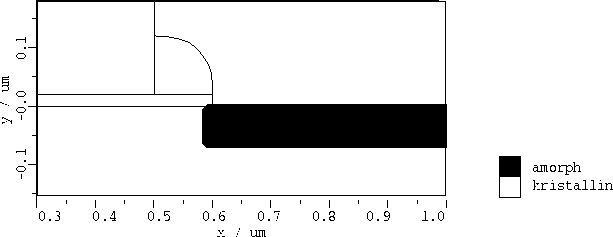
Abbildung 6.33: Resultierende amorphe Schicht (schwarz) die sich nach dem
Drain-Implantation ergibt. Die Substrattemperatur betrug
296K.