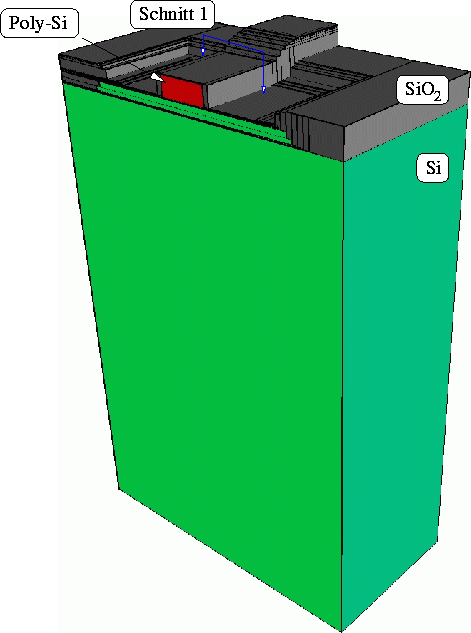
Abbildung 6.34: Dreidimensionale Struktur eines
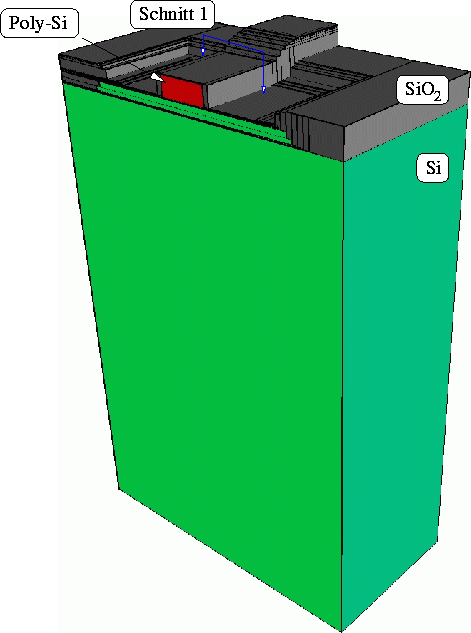
Abbildung 6.34: Dreidimensionale Struktur eines ![]() PMOS\
Transistors aus einem 3.3V CMOS Prozessfluss.
PMOS\
Transistors aus einem 3.3V CMOS Prozessfluss.
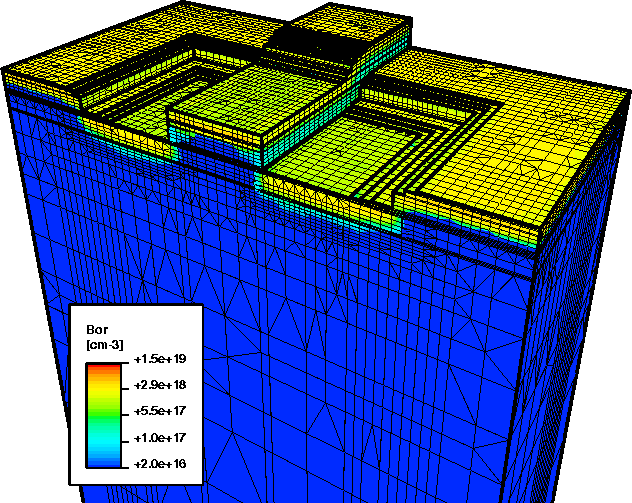
Abbildung 6.35: Bor-Konzentration in ![]() nach einer p-LDD-Implantation des
nach einer p-LDD-Implantation des ![]() PMOS Transistor mit 25keV-Bor-Ionen und einer Dosis von
PMOS Transistor mit 25keV-Bor-Ionen und einer Dosis von ![]() . Der Wafer wurde dabei um 7 Grad
gegenueber der [100]-Richtung gekippt und viermal um 90 Grad
gedreht.
. Der Wafer wurde dabei um 7 Grad
gegenueber der [100]-Richtung gekippt und viermal um 90 Grad
gedreht.
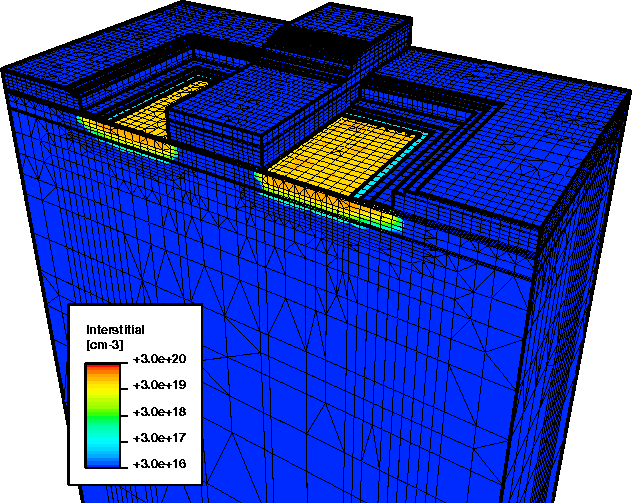
Abbildung 6.36: Silizium-Interstitial-Konzentration in [cm-3]
nach einer p-LDD-Implantation des ![]() PMOS\
Transistors mit 25keV-Bor-Ionen und einer Dosis von
PMOS\
Transistors mit 25keV-Bor-Ionen und einer Dosis von ![]() . Der Wafer wurde dabei um 7
. Der Wafer wurde dabei um 7![]() \
gegenueber der [100]-Richtung gekippt und viermal um 90
\
gegenueber der [100]-Richtung gekippt und viermal um 90![]() \
gedreht.
\
gedreht.
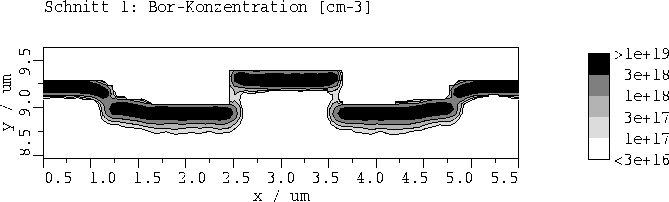
Abbildung 6.37: Bor-Konzentration in [cm-3] in der Schnittebene 1
nach einer p-LDD-Implantation des ![]() PMOS\
Transistors mit 25keV-Bor-Ionen und einer Dosis von
PMOS\
Transistors mit 25keV-Bor-Ionen und einer Dosis von ![]() . Der Wafer wurde dabei um 7
. Der Wafer wurde dabei um 7![]() \
gegenüber der [100]-Richtung gekippt und viermal um 90
\
gegenüber der [100]-Richtung gekippt und viermal um 90![]() \
gedreht.
\
gedreht.
Eine LDD-Implantation plaziert die Dotierstoffe nahe der Oberfläche
zwischen dem Source/Drain Bereich (typische Konzentrationswerte
liegen zwischen ![]() und
und ![]() ) und dem Kanalgebiet
(
) und dem Kanalgebiet
(![]() ). Dadurch wird jener Bereich ausgedehnt,
in dem der Abfall der Source/Drain Spannung stattfindet. Dies
reduziert die maximale Feldstärke. Man erreicht damit eine Steigerung der
Zuverlässigkeit des Bauteils, vgl. [Zie92, Wol95].
). Dadurch wird jener Bereich ausgedehnt,
in dem der Abfall der Source/Drain Spannung stattfindet. Dies
reduziert die maximale Feldstärke. Man erreicht damit eine Steigerung der
Zuverlässigkeit des Bauteils, vgl. [Zie92, Wol95].
In das Simulationsgebiet aus Abbildung 6.34 wurden
25keV-Bor-Ionen unter einem Kippwinkel von 7![]() implantiert. Die Halterung
des Wafers wurde dabei viermal um 90
implantiert. Die Halterung
des Wafers wurde dabei viermal um 90![]() gedreht.
gedreht.
Die Abbildungen 6.35 und 6.36 zeigen die resultierende dreidimensionale Bor- bzw.\ Silizium-Interstitial-Konzentration. Schneidet man die Geometrie mit einer vertikalen Ebene (siehe Abbildung 6.34) und berechnet darin die Verteilung (siehe Abbildung 6.37), so erkennt man deutlich, daß die Dotierstoffkonzentrationen lateral bis in das Kanalgebiet reichen.