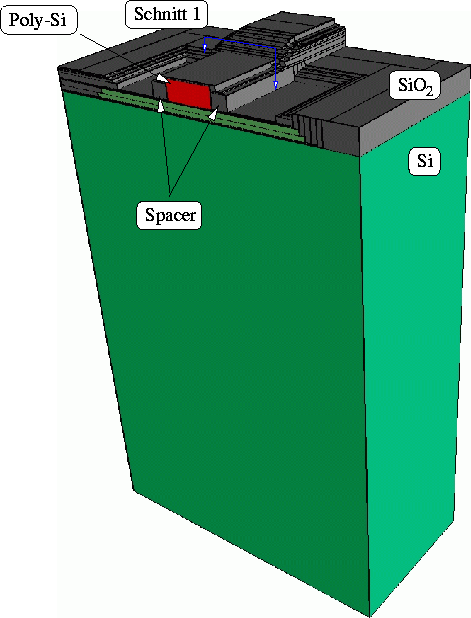
Abbildung 6.38: Dreidimensionale Struktur eines ![]() PMOS\
Transistors aus einem
PMOS\
Transistors aus einem ![]() CMOS Prozessfluss.
CMOS Prozessfluss.
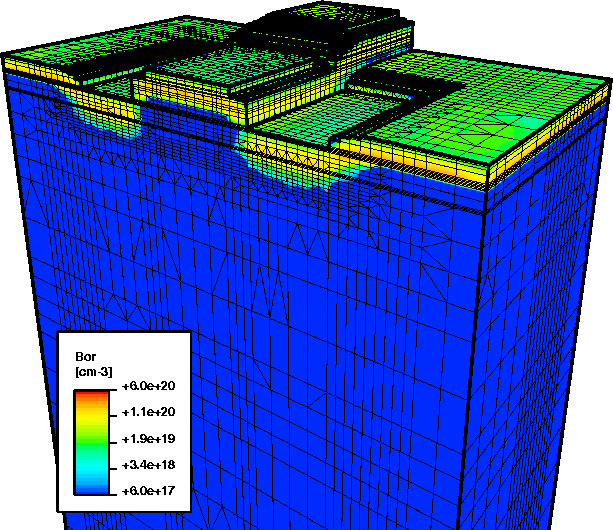
Abbildung 6.39: Bor-Konzentration in ![]() nach einer
nach einer ![]() -Implantation des
-Implantation des ![]() PMOS Transistors mit 45keV-Bor-Ionen und einer Dosis von
PMOS Transistors mit 45keV-Bor-Ionen und einer Dosis von ![]() . Der Wafer wurde dabei um 7
. Der Wafer wurde dabei um 7![]() \
gegenüber der [100]-Richtung gekippt und viermal um 90
\
gegenüber der [100]-Richtung gekippt und viermal um 90![]() \
gedreht.
\
gedreht.
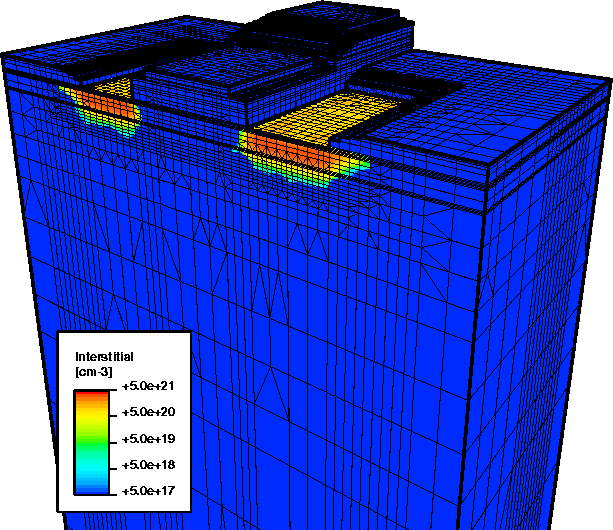
Abbildung 6.40: Silizium-Interstitial-Konzentration in ![]() nach einer
nach einer ![]() -Implantation des
-Implantation des ![]() PMOS Transistor mit 45keV-Bor-Ionen und einer Dosis von
PMOS Transistor mit 45keV-Bor-Ionen und einer Dosis von ![]() . Der Wafer wurde dabei um 7
. Der Wafer wurde dabei um 7![]() \
gegenueber der [100]-Richtung gekippt und viermal um 90
\
gegenueber der [100]-Richtung gekippt und viermal um 90![]() \
gedreht.
\
gedreht.

Abbildung 6.41: Bor-Konzentration in [cm-3] in der Schnittebene 1
nach einer ![]() -Implantation des
-Implantation des ![]() PMOS\
Transistor mit 45keV-Bor-Ionen und einer Dosis von
PMOS\
Transistor mit 45keV-Bor-Ionen und einer Dosis von ![]() . Der Wafer wurde dabei um 7
. Der Wafer wurde dabei um 7![]() \
gegenueber der [100]-Richtung gekippt und viermal um 90
\
gegenueber der [100]-Richtung gekippt und viermal um 90![]() \
gedreht.
\
gedreht.
In das Simulationsgebiet aus Abbildung 6.38 wurden zur
Erzeugung der Source/Drain Bereiche 45keV-Bor-Ionen unter einem
Kippwinkel von 7![]() implantiert. Die Halterung des Wafers wurde
dabei viermal um 90
implantiert. Die Halterung des Wafers wurde
dabei viermal um 90![]() gedreht.
gedreht.
Die Abbildungen 6.39 und 6.40 zeigen die resultierende dreidimensionale Bor- bzw.\ Silizium-Interstitial-Konzentration. Schneidet man die Geometrie mit einer vertikalen Ebene (siehe Abbildung 6.38) und berechnet darin die Verteilung (siehe Abbildung 6.41), erkennt man deutlich die hochdotierten Source/Drain`` Bereiche. Die beiden Spacer schirmen jedoch den unmittelbaren Bereich zwischen Kanalgebiet und Source/Drain ab. Dadurch reicht das Dotierstoffprofil nicht bis unter das Gate.