Zur Ausheilung der Implantationsschäden wird ein 30-minütiger Diffusionschritt bei
875![]() C verwendet. In jedem Material haben die Dopanden jedoch unterschiedliche
Diffusionseigenschaften. Es wird daher zur Simulation des Ausheilschrittes jedem Material
ein eigenes Diffusionsmodell zugewiesen. Während im Siliziumoxyd und im Polysilizium lineare
Diffusion angenommen wurde, kam im Siliziumgebiet das feldgekoppelte Modell zum Einsatz
(Kap. 3.1). Zusätzlich müssen auch die Segregationseffekte an den
Materialgrenzen berücksichtigt werden. Dies wurde unter Verwendung von
Gl. 2.21 durchgeführt. Alle Parameter für die verwendeten Modelle wurden
der Datenbank von TSUPREM4 [TMA95] entnommen.
C verwendet. In jedem Material haben die Dopanden jedoch unterschiedliche
Diffusionseigenschaften. Es wird daher zur Simulation des Ausheilschrittes jedem Material
ein eigenes Diffusionsmodell zugewiesen. Während im Siliziumoxyd und im Polysilizium lineare
Diffusion angenommen wurde, kam im Siliziumgebiet das feldgekoppelte Modell zum Einsatz
(Kap. 3.1). Zusätzlich müssen auch die Segregationseffekte an den
Materialgrenzen berücksichtigt werden. Dies wurde unter Verwendung von
Gl. 2.21 durchgeführt. Alle Parameter für die verwendeten Modelle wurden
der Datenbank von TSUPREM4 [TMA95] entnommen.
Die Simulation des Ausheilschrittes auf einem DIGITAL AlphaStation 600 5/333 Arbeitsplatzrechner benötigte rund 120MB Arbeitsspeicher und erforderte eine Rechenzeit von 67 Minuten.
Die Abbildungen Abb. 8.13-Abb. 8.16 stellen jeweils die dreidimensionalen Ansichten der implantierten und der diffundierten Profile für Arsen (Abb. 8.13 und Abb. 8.14) und Bor (Abb. 8.15 und Abb. 8.16) gegenüber. Während im kristallinen Silizium und im Oxyd nur relativ wenig Diffusion eintritt, ist im Polysilizium aufgrund des deutlich höheren Diffusionskoeffizienten wesentlich mehr Diffusion zu beobachten, sodaß im Polysilizium die Dotierungen beinahe gleichverteilt sind. Des weiteren tritt an den Materialgrenzen die Segregation der Dopanden auf.
Bei der Arsen-Implantation sind die Auswirkungen der Kanäle im Silizumkristall sehr stark (vlg. Abb. 8.13). Dieser Effekt ist bei der HALO-Implantation mit Bor durch die Überlagerung mit der Kanaldotierung und der Channel-Stopper Implantation nur schwach ausgeprägt (Abb. 8.15).
In Abb. 8.15 und Abb. 8.16 ist die dreidimensionale Ansicht der Bor-Verteilung vor und nach dem Ausheilschritt dargestellt. Bei Bor tritt im Gegensatz zu Arsen aufgrund der höheren Beweglichkeit mehr Diffusion ein. Während die Feldkopplung der Arsen- und der Bor-Verteilung, schon allein aufgrund der geringen Beweglichkeit von Arsen, kaum Auswirkungen auf dessen Diffusion hat, ist der Effekt für Bor umso ausgeprägter. Zusätzlich zur höheren Beweglichkeit von Bor besteht durch die steilen Gradienten der Arsenverteilung in diesem Bereich ein starkes Feld, welches zur Verdrängung der Borkonzentration führt. Dieser Effekt ist sowohl unter den Rändern des Source- und des Drain-Gebietes (Abb. 8.16) als auch unter den Kanten des Gates (Abb. 8.24) zu beobachten.
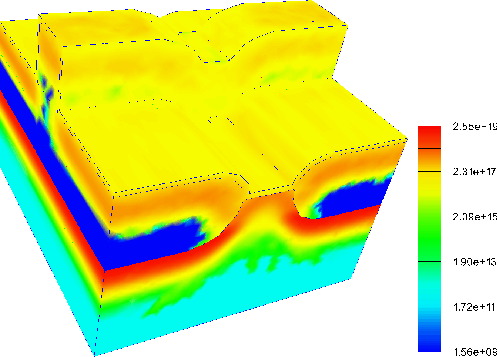 |
Zur Verdeutlichung der Verhältnisse im aktiven Bereich unter dem Gate vermitteln die Abbildungen Abb. 8.17-Abb. 8.24 einen Einblick in das Innere der Struktur. Es werden jeweils die Verteilungen von Arsen vor (Abb. 8.17, Abb. 8.19) und nach (Abb. 8.18, Abb. 8.20) dem Diffusionsschritt und die Verteilung von Bor vor (Abb. 8.21, Abb. 8.23) und nach (Abb. 8.22, Abb. 8.24) dem Implantationschritt gegenübergestellt.
Als Schnittflächen wurde dafür die zur x-z-Ebene parallele Ebene bei y=0.5![]() und die
zur y-z-Ebene parallele Ebene bei x=0.5
und die
zur y-z-Ebene parallele Ebene bei x=0.5![]() verwendet (vgl. Abb. 8.11). Die Schnitte
in Abb. 8.17, Abb. 8.18, Abb. 8.21 und Abb. 8.22 geben daher
die Verteilungen entlang der Gateweite wieder, während die Schnitte in Abb. 8.19,
Abb. 8.20, Abb. 8.23 und Abb. 8.24 die Verteilungen entlang der Gatelänge
wiedergeben.
verwendet (vgl. Abb. 8.11). Die Schnitte
in Abb. 8.17, Abb. 8.18, Abb. 8.21 und Abb. 8.22 geben daher
die Verteilungen entlang der Gateweite wieder, während die Schnitte in Abb. 8.19,
Abb. 8.20, Abb. 8.23 und Abb. 8.24 die Verteilungen entlang der Gatelänge
wiedergeben.
Entlang der Gateweite (x-z-Ebene bei y=0.5![]() ) sollte wegen der Schattierung durch das
Polysilizum-Gate bei den Arsen-Implantationen keine Arsenverteilung vorhanden sein. Dennoch sind
in Abb. 8.17 inselförmige Verteilungen erkennbar, welche aufgrund der Kanäle im
Silizium-Kristall auch unter das Gate gelangen. Die Arsen-Verteilung nach dem Ausheilschritt
zeigt diese Inseln direkt unter dem Gate jedoch nicht mehr, sodaß man schließen kann, daß es
sich bei den Inseln um statistische Schwankungen der mit der Monte-Carlo Methode berechneten
Arsen-Verteilung mit geringer lokaler Dosis handelt. Sehrwohl bleibt aber die markante Insel in
größerer Tiefe vorhanden, welche aufgrund eines Gitterkanals entstanden ist. Durch die
Verbreiterung von Inseln in benachbarten Ebenen im Zuge der Diffusion werden auch Ausläufer der
benachbarten Inseln sichtbar (Abb. 8.18).
) sollte wegen der Schattierung durch das
Polysilizum-Gate bei den Arsen-Implantationen keine Arsenverteilung vorhanden sein. Dennoch sind
in Abb. 8.17 inselförmige Verteilungen erkennbar, welche aufgrund der Kanäle im
Silizium-Kristall auch unter das Gate gelangen. Die Arsen-Verteilung nach dem Ausheilschritt
zeigt diese Inseln direkt unter dem Gate jedoch nicht mehr, sodaß man schließen kann, daß es
sich bei den Inseln um statistische Schwankungen der mit der Monte-Carlo Methode berechneten
Arsen-Verteilung mit geringer lokaler Dosis handelt. Sehrwohl bleibt aber die markante Insel in
größerer Tiefe vorhanden, welche aufgrund eines Gitterkanals entstanden ist. Durch die
Verbreiterung von Inseln in benachbarten Ebenen im Zuge der Diffusion werden auch Ausläufer der
benachbarten Inseln sichtbar (Abb. 8.18).
Während im Polysilizium durch den Ausheilschritt beinahe eine Gleichverteilung von Arsen eintritt, ist das Ausmaß der Diffusion von Arsen im Silizium nur gering. An den Grenzen zwischen Polysilizium und SiO2 ist deutlich die Segregation von Arsen zu erkennen, welche nahe der Grenzfläche zur Verminderung der Arsen-Konzentration im Oxyd führt.
In Abb. 8.19 ist die Überlagerung der HDD- und der Source/Drain-Implantation entlang
der y-z-Ebene bei x=0.5![]() dargestellt. Die niedrigenergetische HDD-Implantation vermag
das Streuoxyd kaum zu durchdringen. Die Source/Drain-Implantation dringt deutlich tiefer ein,
während der hier nicht dargestellte Spacer für den Abstand der Verteilung zur Gate-Kante
verantwortlich zeichnet. Im Zuge des Ausheilschrittes wandert durch die Segregation am der
Silizium/SiO2 Grenzschicht die HDD-Implantation in das Silizium, sodaß es zur Ausbildung
des gewünschten stufenförmigen Verlaufes in der Arsen-Konzentration kommt (Abb. 8.20).
dargestellt. Die niedrigenergetische HDD-Implantation vermag
das Streuoxyd kaum zu durchdringen. Die Source/Drain-Implantation dringt deutlich tiefer ein,
während der hier nicht dargestellte Spacer für den Abstand der Verteilung zur Gate-Kante
verantwortlich zeichnet. Im Zuge des Ausheilschrittes wandert durch die Segregation am der
Silizium/SiO2 Grenzschicht die HDD-Implantation in das Silizium, sodaß es zur Ausbildung
des gewünschten stufenförmigen Verlaufes in der Arsen-Konzentration kommt (Abb. 8.20).
Die Bor-Verteilung im Silizium wird durch die HALO-Implantation aufgrund der Schattierung durch das
Gate entlang der x-z-Ebene bei y=0.5![]() nicht beeinflußt (Abb. 8.21). Dies ist
dies entlang der y-z-Ebene bei x=0.5
nicht beeinflußt (Abb. 8.21). Dies ist
dies entlang der y-z-Ebene bei x=0.5![]() sehrwohl der Fall und in einer leichten Erhöhung
und der größeren Eindringtiefe der Bor-Konzentration in den Source/Drain-Gebieten
erkennbar. Aufgrund der schrägen Implantation unter dem Einfallswinkel von 45
sehrwohl der Fall und in einer leichten Erhöhung
und der größeren Eindringtiefe der Bor-Konzentration in den Source/Drain-Gebieten
erkennbar. Aufgrund der schrägen Implantation unter dem Einfallswinkel von 45![]() werden
auch die Seitenwände des Gates dotiert, lediglich ein kleiner Kernbereich bleibt undotiert
(Abb. 8.23). Wegen der bereits vor der Formation des Feldoxydes, des Gates und des
Streuoxydes eingebrachten Kanaldotierung sowie der Channel-Stopper Implantation ist an der
Grenzfläche zwischen Silizium und dem Streuoxyd ein Sprung der Borkonzentration vorhanden
(Abb. 8.23).
werden
auch die Seitenwände des Gates dotiert, lediglich ein kleiner Kernbereich bleibt undotiert
(Abb. 8.23). Wegen der bereits vor der Formation des Feldoxydes, des Gates und des
Streuoxydes eingebrachten Kanaldotierung sowie der Channel-Stopper Implantation ist an der
Grenzfläche zwischen Silizium und dem Streuoxyd ein Sprung der Borkonzentration vorhanden
(Abb. 8.23).
Nach dem Ausheilschritt ist Bor im Polysilizium praktisch gleichverteilt, und an den Silizum/SiO2-Gernzflächen ist die Segregation von Bor zu beobachten, sodaß die Bor-Konzentration nahe der Grenzfläche im Oxyd ansteigt (Abb. 8.22, Abb. 8.24). Weiters ist in Abb. 8.24 sehr deutlich die Verdrängung von Bor aufgrund der starken Feldkopplung mit Arsen im Bereich der hohen Gradienten der Arsen-Verteilung zu sehen. Die HALO-Implantation macht einen Teil dieser Verdrängung wett und trägt somit zur Vermeidung von Kurzkanaleffekten bei [Hwa96b].