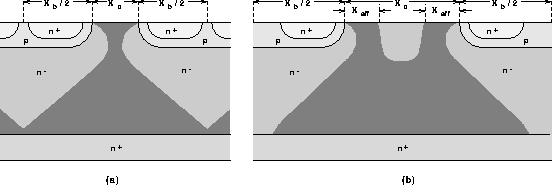
Abbildung 3.9: DMOS-Zellen mit kleinem (a) und großem (b) Zellenabstand. Das Gebiet des Stromflusses in Sättigung des Kanals ist dunkel gekennzeichnet.




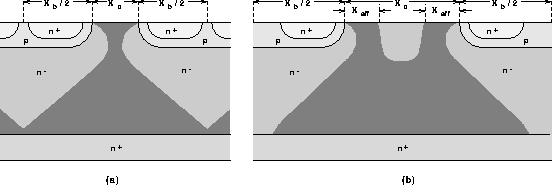
Abbildung 3.9: DMOS-Zellen mit kleinem (a) und großem
(b) Zellenabstand. Das Gebiet des Stromflusses in Sättigung des Kanals ist
dunkel gekennzeichnet.
 ). Beide werden in der Sättigung
des Kanals betrieben. Im ersten Fall mit einem kleinen Zellenabstand haben
aufgrund der hohen Drain-Source-Spannung die sich auch lateral in das
Driftgebiet ausdehnenden Raumladungszonen begonnen, den Strompfad
(dunkel angedeutet) einzuschnüren, bzw. hat die durch die
Driftgeschwindigkeitssättigung in der Epi-Schicht hervorgerufene
Stromsättigung begonnen, wirksam zu werden (siehe Abschnitt 5.3).
Die Grenzfläche Driftgebiet-Gateoxid ist akkumuliert, die
Stromdichte am ,,oberen Ende`` (Source) des JFET-Gebiets (nach dem Austritt
des Stroms aus der Akkumulationsschicht in vertikaler Richtung) ist
aufgrund des geringen Akkumulationswiderstands lateral annähernd
gleichmäßig verteilt.
). Beide werden in der Sättigung
des Kanals betrieben. Im ersten Fall mit einem kleinen Zellenabstand haben
aufgrund der hohen Drain-Source-Spannung die sich auch lateral in das
Driftgebiet ausdehnenden Raumladungszonen begonnen, den Strompfad
(dunkel angedeutet) einzuschnüren, bzw. hat die durch die
Driftgeschwindigkeitssättigung in der Epi-Schicht hervorgerufene
Stromsättigung begonnen, wirksam zu werden (siehe Abschnitt 5.3).
Die Grenzfläche Driftgebiet-Gateoxid ist akkumuliert, die
Stromdichte am ,,oberen Ende`` (Source) des JFET-Gebiets (nach dem Austritt
des Stroms aus der Akkumulationsschicht in vertikaler Richtung) ist
aufgrund des geringen Akkumulationswiderstands lateral annähernd
gleichmäßig verteilt.
Ist der Zellenabstand jedoch groß, so wird der JFET-Effekt nur relativ
schwach wirksam. Allerdings fällt nun aufgrund der Weite der Grenzfläche
Driftgebiet-Gateoxid in der Akkumulationszone eine nicht vernachlässigbare
Spannung ab [48]. Damit steigt das Oberflächenpotential mit
steigender Entfernung vom drainseitigen Kanalende, die über dem Oxid
abfallende Spannung sinkt. Wird die zur Akkumulation notwendige Oxidspannung
(Flachbandspannung der Grenzfläche Driftgebiet-Gateoxid) unterschritten,
bildet sich von der Mitte des Driftgebiets zwischen zwei benachbarten
Zellen ausgehend eine Verarmungszone aus. Diese führt
ebenfalls zu einer Einengung des Strompfads. In [131] werden damit
negative Ausgangsleitwerte  für hohe Stöme zu erklären versucht.
für hohe Stöme zu erklären versucht.
Ein wesentliches Kriterium beim Design von Bauelementen ist die verbrauchte
Fläche. Bei Leistungsbauelementen im speziellen ist es wesentlich,
möglichst viel Halbleitervolumen von Strom durchfließen zu lassen, um den
Widerstand bezogen auf die Fläche (unter den gegebenen Randbedingungen wie
z.B. Durchbruchspannungen) zu minimieren. Die nicht optimale
Ausnutzung des Siliziumvolumens im Fall des großen Zellenabstands wird in
[48] mittels einer einfachen Formel für die Weite des
stromdurchflossenen Teils der Driftzone an der Oxidgrenzfläche (im Fall der
Ausbildung einer Raumladungszone an der Driftzonengrenzfläche in der Mitte
zwischen zwei Zellen) mit  abgeschätzt zu:
abgeschätzt zu:
 ist der spezifische Widerstand der Driftzone,
ist der spezifische Widerstand der Driftzone,  die Tiefe des
die Tiefe des
 -body
-body  -Übergangs und
-Übergangs und  der Widerstand der
Akkumulationsschicht. Diese Formeln sind analog zum Problem des
zweidimensionalen Stromflusses an ohmschen Kontakten hergeleitet
[11].
der Widerstand der
Akkumulationsschicht. Diese Formeln sind analog zum Problem des
zweidimensionalen Stromflusses an ohmschen Kontakten hergeleitet
[11].
Unter Verwendung obiger Formel, eines JFET-Modells für den Fall eines
kleinen  , das Stromsättigungseffekte berücksichtigt (siehe
Abschnitt 6.4.1), und der Annahme eines
, das Stromsättigungseffekte berücksichtigt (siehe
Abschnitt 6.4.1), und der Annahme eines  -Stromflusses im
Draingebiet kann ein Optimum von
-Stromflusses im
Draingebiet kann ein Optimum von  berechnet werden. Als Kriterium dient
das Minimum des tatsächlichen Drainwiderstands im Verhältnis zum durch das
zur Verfügung stehende Volumen theoretisch möglichen ,,idealen
Drainwiderstand`` (
berechnet werden. Als Kriterium dient
das Minimum des tatsächlichen Drainwiderstands im Verhältnis zum durch das
zur Verfügung stehende Volumen theoretisch möglichen ,,idealen
Drainwiderstand`` ( ).
).
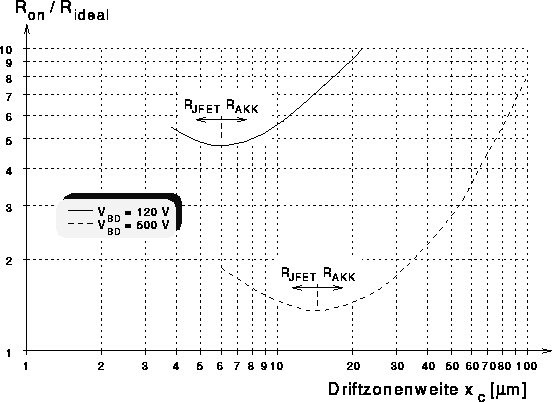
Abbildung 3.10: Normalisierter Drainwiderstand über
dem Abstand zweier  -bodies für zwei Transistoren mit verschiedenen
Durchbruchspannungen nach [48].
-bodies für zwei Transistoren mit verschiedenen
Durchbruchspannungen nach [48].
Man erkennt aus Abb. 3.10, daß das Optimum für Transistoren mit geringeren Durchbruchspannungen zu geringeren Zellweiten führt. Der unterschiedliche erreichbare normalisierte Drainwiderstand für verschiedene Durchbruchspannungen ergibt sich aus unterschiedlichen Kanallängen und -weiten und Dotierungsverhältnissen der Transistoren. Auf ganz ähnliche Ergebnisse führen Untersuchungen in [52] und [107].
 -bodies benachbarter Zellen auf minimalen On-Widerstand kann die
Auswirkung der Weite des Sourcekontakts untersucht werden. Um dies
unabhängig von der Kanallänge tun zu können, wird die Weite der
Gatepolyöffnung optimiert (
-bodies benachbarter Zellen auf minimalen On-Widerstand kann die
Auswirkung der Weite des Sourcekontakts untersucht werden. Um dies
unabhängig von der Kanallänge tun zu können, wird die Weite der
Gatepolyöffnung optimiert ( in Abb. 3.11). In der Literatur wird
oft von einem
in Abb. 3.11). In der Literatur wird
oft von einem  -Stromfluß im Driftgebiet ausgegangen
[52][64][113].
-Stromfluß im Driftgebiet ausgegangen
[52][64][113].
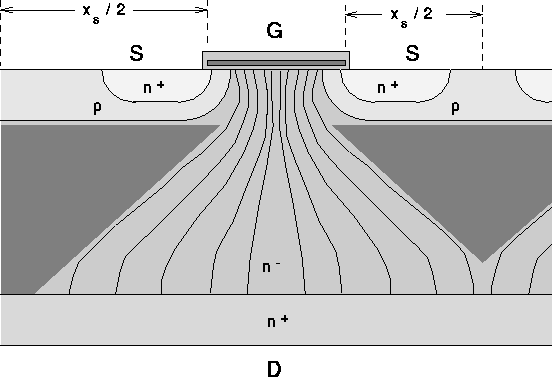
Abbildung 3.11: DMOS-Zelle mit schematisch angedeuteten
Stromflußlinien. Links ist der Fall für nicht mit Stromfluß ausgefülltes
Siliziumvolumen unterhalb des Sourcekontakts eingezeichnet, rechts der Fall
einer leichten Überlappung der Stromflußgebiete zweier Zellen.
Ist nun die Weite des  -bodies so groß,
daß das nicht vom Strom durchflossene Gebiet unter dem
-bodies so groß,
daß das nicht vom Strom durchflossene Gebiet unter dem  -body ein
Trapez bildet (Abb. 3.11 links, in dreidimensionaler Betrachtung
eigentlich eine auf den Kopf gestellte, abgeschnittene Pyramide), dann
befindet sich unterhalb der Mitte des Sourcekontakts ein
Siliziumvolumen, das nicht von Strom durchflossen wird. Dieses erhöht
natürlich den gesamten spezifischen On-Widerstand des DMOS-Transistors.
Eine Verringerung der Breite des
-body ein
Trapez bildet (Abb. 3.11 links, in dreidimensionaler Betrachtung
eigentlich eine auf den Kopf gestellte, abgeschnittene Pyramide), dann
befindet sich unterhalb der Mitte des Sourcekontakts ein
Siliziumvolumen, das nicht von Strom durchflossen wird. Dieses erhöht
natürlich den gesamten spezifischen On-Widerstand des DMOS-Transistors.
Eine Verringerung der Breite des  -bodies, bis aus dem Trapez, das
das nicht von Strom durchflossene Driftgebiet andeutet, ein Dreieck wird,
dessen Spitze sich genau am Übergang Driftzone-buried layer befindet,
verringert den spezifischen On-Widerstand, ohne den Absolutwert des
On-Widerstands zu heben. In [113] wurden zweidimensionale numerische
Simulationen durchgeführt, um die Größe der Sourcekontaktöffnung zu
optimieren. Abb. 3.12 zeigt, daß die auf die Zellfläche bezogene
Summe von Akkumulations-, JFET- und Driftwiderstand kontinuierlich sinkt,
auch für
-bodies, bis aus dem Trapez, das
das nicht von Strom durchflossene Driftgebiet andeutet, ein Dreieck wird,
dessen Spitze sich genau am Übergang Driftzone-buried layer befindet,
verringert den spezifischen On-Widerstand, ohne den Absolutwert des
On-Widerstands zu heben. In [113] wurden zweidimensionale numerische
Simulationen durchgeführt, um die Größe der Sourcekontaktöffnung zu
optimieren. Abb. 3.12 zeigt, daß die auf die Zellfläche bezogene
Summe von Akkumulations-, JFET- und Driftwiderstand kontinuierlich sinkt,
auch für  kleiner als
kleiner als  , jener Weite, bei der der Stromfluß
das Gebiet unterhalb des Sourcekontakts zu füllen beginnt. Dies ist aus
rein geometrischen Überlegungen leicht zu verstehen und wird in
[52] ausführlich gezeigt. Für
, jener Weite, bei der der Stromfluß
das Gebiet unterhalb des Sourcekontakts zu füllen beginnt. Dies ist aus
rein geometrischen Überlegungen leicht zu verstehen und wird in
[52] ausführlich gezeigt. Für  erhöht sich
jedoch der absolute On-Widerstand.
erhöht sich
jedoch der absolute On-Widerstand.
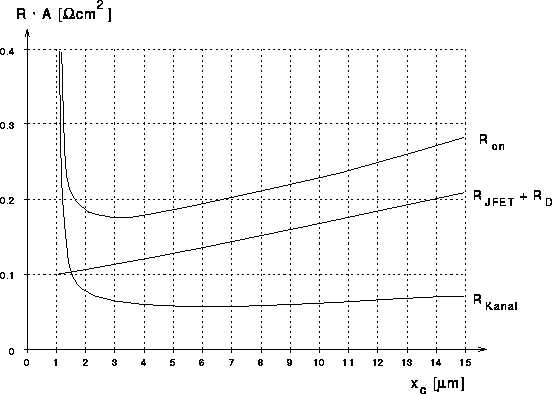
Abbildung 3.12: Spezifischer On-Widerstand über
Sourcekontaktweite.
Der spezifische Kanalwiderstand bleibt bis zu
kleinen Sourcekontaktweiten nahezu konstant. Wird allerdings die Weite der
Poly-Öffnung so gering, daß die Weite des eigentlichen Sourcekontaktlochs
gegen Null geht, denn steigt dieser Anteil am On-Widerstand natürlich sehr
steil an. Es ergibt sich für die untersuchte Geometrie eine optimale
Sourcekontaktweite von  (die Durchbruchspannung der untersuchten
Geometrie liegt bei
(die Durchbruchspannung der untersuchten
Geometrie liegt bei  ).
).



