2.1.3 Das vertikale Konzept




Next: 2.2 Der DMOS-Prozeß
Up: 2.1 DMOS-Grundstrukturen
Previous: 2.1.2 Die Kontaktierung des
Durch den lateralen Stromfluß des LDMOS-Transistors nahe der Oberfläche
wird das zur Verfügung stehende Siliziumvolumen sehr
schlecht genutzt. Das den On-Widerstand bestimmende stromdurchflossene
Volumen ist klein. Die Länge der Driftzone muß so gewählt werden,
daß die Raumladungszone im Vorwärts-Blockierfall den buried layer
nicht erreicht. Das bringt einen hohen Platzbedarf der LDMOS-Transistoren
mit sich.
Diese Nachteile des LDMOS-Transistors führten zur Entwicklung vertikaler
Typen. Zuerst wurde der sog. VMOS-Transistor [40] entwickelt (siehe
Abb. 2.5). Der V-förmige Einschnitt wird nach der Einbringung und
Diffusion des  -bodies und des
-bodies und des  -Sourcegebiets durch anisotropes
Naßätzen geformt. Dieses Ätzverfahren zeigt eine ausgeprägte
Abhängigkeit der Ätzrate von der kristallographischen Richtung. So ist sie
für die
-Sourcegebiets durch anisotropes
Naßätzen geformt. Dieses Ätzverfahren zeigt eine ausgeprägte
Abhängigkeit der Ätzrate von der kristallographischen Richtung. So ist sie
für die  -Richtung wesentlich geringer als
für die
-Richtung wesentlich geringer als
für die  -Richtung. Da als Substrat
-Richtung. Da als Substrat
 -Silizium verwendet wird, muß das
Ätzfenster parallel zur
-Silizium verwendet wird, muß das
Ätzfenster parallel zur  -Richtung
ausgerichtet sein, da sich in dieser Richtung die
-Richtung
ausgerichtet sein, da sich in dieser Richtung die  -Ebenen und die
-Ebenen und die  -Ebenen schneiden. Die Wände
des V-förmigen Grabens schließen mit der Oberfläche einen Winkel von
-Ebenen schneiden. Die Wände
des V-förmigen Grabens schließen mit der Oberfläche einen Winkel von
 ein. Aufgrund der geringen Ätzrate in
ein. Aufgrund der geringen Ätzrate in  -Richtung endet der Ätzvorgang selbständig, nachdem der
V-Graben bis zur Spitze ausgeätzt ist. An den schrägen Wänden wird das
Gateoxid und darüber der Gatekontakt aufgebracht. Der Strom fließt vom
-Richtung endet der Ätzvorgang selbständig, nachdem der
V-Graben bis zur Spitze ausgeätzt ist. An den schrägen Wänden wird das
Gateoxid und darüber der Gatekontakt aufgebracht. Der Strom fließt vom
 -Sourcegebiet entlang der Wände des V-Grabens durch den Kanal und
danach durch das
-Sourcegebiet entlang der Wände des V-Grabens durch den Kanal und
danach durch das  -Driftgebiet zum an der Unterseite des Wafers
liegenden Drainkontakt, der über ein
-Driftgebiet zum an der Unterseite des Wafers
liegenden Drainkontakt, der über ein  -Gebiet das Driftgebiet
kontaktiert. Die Driftzone muß genügend dick ausgeführt sein, sodaß die
sich im stromlosen Fall bei steigender Drainspannung in das Driftgebiet
ausdehnende Raumladungszone das
-Gebiet das Driftgebiet
kontaktiert. Die Driftzone muß genügend dick ausgeführt sein, sodaß die
sich im stromlosen Fall bei steigender Drainspannung in das Driftgebiet
ausdehnende Raumladungszone das  -Draingebiet nicht vor Einsetzen des
Lawinendurchbruchs in der Raumladungszone (oder vor Erreichen der maximalen
Drainspannung) erreicht.
-Draingebiet nicht vor Einsetzen des
Lawinendurchbruchs in der Raumladungszone (oder vor Erreichen der maximalen
Drainspannung) erreicht.
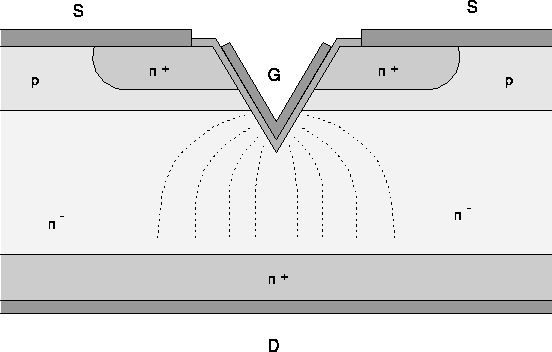
Abbildung 2.5: Struktur des V-groove
DMOS-Transistors mit Stromflußlinien.
An der Spitze des V-Grabens entsteht eine Feldstärkenspitze, die eine
im Vergleich zu planaren Strukturen verringerte Durchbruchspannung
(Lawinendurchbruch) mit sich bringt.
Deshalb wurde der truncated V-groove oder U-groove
DMOS (UMOS)-Transistor [62] entwickelt. Die geätzte Oberfläche
ist größer als beim
gewöhnlichen VMOS-Transistor, die Ätzung wird aber vor dem Fertigätzen
des V-Grabens abgebrochen, sodaß der Graben gleich tief wie beim
VMOS-Transistor ist. Der U-Graben weist somit eine flache Grundfläche auf
(siehe Abb. 2.6). Eine geringere Spitzenwirkung tritt aber dennoch
an den Übergängen zwischen den schrägen Seitenflächen und der
Bodenfläche auf. Im Gegensatz zum V-Graben endet der Ätzvorgang beim
U-Graben nicht selbständig, sondern muß gestoppt werden. Dies
verkompliziert den Herstellungsprozeß und erhöht die Fertigungstoleranzen.
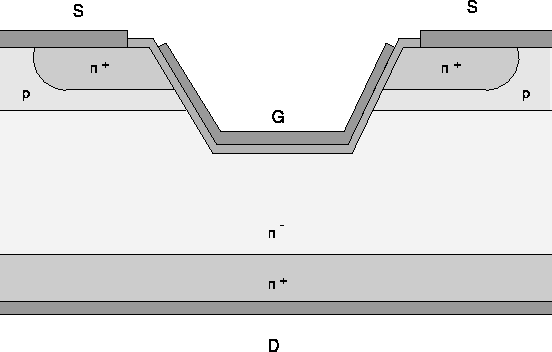
Abbildung 2.6: Struktur des truncated V-groove
DMOS-Transistors.
Beiden VMOS-Typen gemeinsam sind folgende Nachteile:
- Der Kanal bildet sich in
 -Richtung.
Die Beweglichkeit innerhalb einer Inversionsschicht ist in dieser
Kristallebene geringer als in
-Richtung.
Die Beweglichkeit innerhalb einer Inversionsschicht ist in dieser
Kristallebene geringer als in  -Richtung
[34].
-Richtung
[34].
- In
 -Richtung treten mehr Oxidladungen
auf als in
-Richtung treten mehr Oxidladungen
auf als in  -Richtung [8].
-Richtung [8].
- Die aufgrund der Spitzenwirkung verminderte Durchbruchspannung
erfordert eine geringere Dotierung der Driftzone und führt damit zu einem
höheren On-Widerstand.
Es wurde auch eine DMOS-Struktur mit vertikalem Trench als Gatestruktur
vorgestellt [108]. Der Kanal bildet sich in  -Richtung aus. Die oben angeführten Nachteile gelten
zumindest auch prinzipiell für dieses Bauelement.
-Richtung aus. Die oben angeführten Nachteile gelten
zumindest auch prinzipiell für dieses Bauelement.
Allerdings überwiegen die Vorteile des vertikalen Konzeptes gegenüber dem
LDMOS-Transistor:
- Aufgrund des vertikalen Stromflusses wird das Siliziumvolumen viel
besser genützt. Mit derselben Fläche ist ein wesentlich geringerer
On-Widerstand zu realisieren.
- Die Raumladungszone im Vorwärts-Blockierzustand dehnt sich ebenfalls
in vertikaler Richtung aus. Damit kann die DMOS-Zelle für dieselbe
Vorwärts-Blockierdurchbruchspannung wesentlich kleiner gehalten werden.
- Es ist möglich, viele DMOS-Zellen parallel anzuordnen und somit sehr
variabel für sehr unterschiedliche Ströme bzw. On-Widerstände
DMOS-Transistoren aus einer optimierten Grundzelle und optimiertem
Zellenabstand mit demselben Prozeß herzustellen.
Mit der Entwicklung des HEXFET (hexagonaler FET, so genannt aufgrund seines
Zellendesigns, vgl. Abschnitt 3.1.5) und SIPMOS (Siemens
Power MOS)-Transistors [69][82][122][124]
konnten die oben angegeben Nachteile des VMOS-Transistors eliminiert werden.
Technologische Schwierigkeiten (speziell die Reproduzierbarkeit des
Kanalprofils) haben eine frühere Serienreife dieser bereits Mitte der 70er
Jahre [136][137] vorgeschlagenen vertikalen Struktur
verhindert. Ab 1980 hat sie sich allerdings durchgesetzt und wird heute als
Weiterentwicklung von HEXFET und SIPMOS-Transistor i.a. einfach als
DMOS-Transistor bezeichnet. Der Aufbau dieses am weitesten verbreiteten
DMOS-Transistors ist in Abb. 2.7 dargestellt.
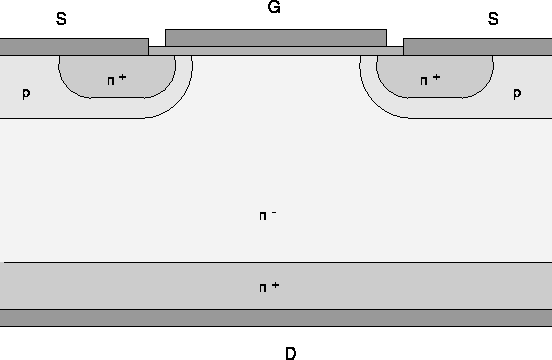
Abbildung 2.7: Struktur des DMOS-Transistors.
Der Kanal bildet sich in  -Richtung, es gibt
keine unstetigen Übergänge, an denen das elektrische Feld Spitzen
aufweisen könnte. Daraus folgt eine höhere Vorwärts-Blockierfähigkeit.
Es kommt allerdings mit zunehmender Drain-Source-Spannung zu einem
Stromsättigungseffekt in der Driftzone zwischen den
-Richtung, es gibt
keine unstetigen Übergänge, an denen das elektrische Feld Spitzen
aufweisen könnte. Daraus folgt eine höhere Vorwärts-Blockierfähigkeit.
Es kommt allerdings mit zunehmender Drain-Source-Spannung zu einem
Stromsättigungseffekt in der Driftzone zwischen den  -bodies
benachbarter DMOS-Zellen, der den Stromfluß zwischen zwei DMOS-Zellen
begrenzt (siehe Abschnitt 5.3 und Abschnitt 6.4).
Dadurch steigt der On-Widerstand des Driftgebiets an, was unter Umständen
den Vorteil der größeren Kanalleitfähigkeit wieder (teilweise)
kompensiert [118].
-bodies
benachbarter DMOS-Zellen, der den Stromfluß zwischen zwei DMOS-Zellen
begrenzt (siehe Abschnitt 5.3 und Abschnitt 6.4).
Dadurch steigt der On-Widerstand des Driftgebiets an, was unter Umständen
den Vorteil der größeren Kanalleitfähigkeit wieder (teilweise)
kompensiert [118].




Next: 2.2 Der DMOS-Prozeß
Up: 2.1 DMOS-Grundstrukturen
Previous: 2.1.2 Die Kontaktierung des
Martin Stiftinger
Wed Oct 5 11:53:06 MET 1994
 -bodies und des
-bodies und des  -Sourcegebiets durch anisotropes
Naßätzen geformt. Dieses Ätzverfahren zeigt eine ausgeprägte
Abhängigkeit der Ätzrate von der kristallographischen Richtung. So ist sie
für die
-Sourcegebiets durch anisotropes
Naßätzen geformt. Dieses Ätzverfahren zeigt eine ausgeprägte
Abhängigkeit der Ätzrate von der kristallographischen Richtung. So ist sie
für die  -Richtung wesentlich geringer als
für die
-Richtung wesentlich geringer als
für die  -Richtung. Da als Substrat
-Richtung. Da als Substrat
 -Silizium verwendet wird, muß das
Ätzfenster parallel zur
-Silizium verwendet wird, muß das
Ätzfenster parallel zur  -Richtung
ausgerichtet sein, da sich in dieser Richtung die
-Richtung
ausgerichtet sein, da sich in dieser Richtung die  -Ebenen und die
-Ebenen und die  -Ebenen schneiden. Die Wände
des V-förmigen Grabens schließen mit der Oberfläche einen Winkel von
-Ebenen schneiden. Die Wände
des V-förmigen Grabens schließen mit der Oberfläche einen Winkel von
 ein. Aufgrund der geringen Ätzrate in
ein. Aufgrund der geringen Ätzrate in  -Richtung endet der Ätzvorgang selbständig, nachdem der
V-Graben bis zur Spitze ausgeätzt ist. An den schrägen Wänden wird das
Gateoxid und darüber der Gatekontakt aufgebracht. Der Strom fließt vom
-Richtung endet der Ätzvorgang selbständig, nachdem der
V-Graben bis zur Spitze ausgeätzt ist. An den schrägen Wänden wird das
Gateoxid und darüber der Gatekontakt aufgebracht. Der Strom fließt vom
 -Sourcegebiet entlang der Wände des V-Grabens durch den Kanal und
danach durch das
-Sourcegebiet entlang der Wände des V-Grabens durch den Kanal und
danach durch das  -Driftgebiet zum an der Unterseite des Wafers
liegenden Drainkontakt, der über ein
-Driftgebiet zum an der Unterseite des Wafers
liegenden Drainkontakt, der über ein  -Gebiet das Driftgebiet
kontaktiert. Die Driftzone muß genügend dick ausgeführt sein, sodaß die
sich im stromlosen Fall bei steigender Drainspannung in das Driftgebiet
ausdehnende Raumladungszone das
-Gebiet das Driftgebiet
kontaktiert. Die Driftzone muß genügend dick ausgeführt sein, sodaß die
sich im stromlosen Fall bei steigender Drainspannung in das Driftgebiet
ausdehnende Raumladungszone das  -Draingebiet nicht vor Einsetzen des
Lawinendurchbruchs in der Raumladungszone (oder vor Erreichen der maximalen
Drainspannung) erreicht.
-Draingebiet nicht vor Einsetzen des
Lawinendurchbruchs in der Raumladungszone (oder vor Erreichen der maximalen
Drainspannung) erreicht.